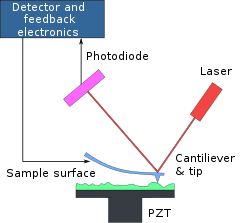
Атомно-силовая микроскопия ( АСМ ) или сканирующая силовая микроскопия ( SFM ) - это тип сканирующей зондовой микроскопии (СЗМ) с очень высоким разрешением , с продемонстрированным разрешением порядка долей нанометра , что более чем в 1000 раз лучше, чем оптическая дифракция. -предел .
Обзор [ править ]
Атомно-силовая микроскопия [1] (АСМ) - это тип сканирующей зондовой микроскопии (СЗМ) с продемонстрированным разрешением порядка долей нанометра , что более чем в 1000 раз лучше, чем предел оптической дифракции . Информация собирается путем «ощупывания» или «прикосновения» к поверхности механическим зондом. Пьезоэлектрические элементы, которые облегчают крошечные, но точные и точные движения по (электронной) команде, обеспечивают точное сканирование.
Способности [ править ]
АСМ обладает тремя основными возможностями: измерение силы, получение топографических изображений и манипулирование.
При измерении силы АСМ можно использовать для измерения сил между зондом и образцом в зависимости от их взаимного разделения. Это может быть применено для выполнения силовой спектроскопии , для измерения механических свойств образца, таких как модуль Юнга образца , мера жесткости.
Для получения изображений реакция зонда на силы, которые на него оказывает образец, может быть использована для формирования изображения трехмерной формы (топографии) поверхности образца с высоким разрешением. Это достигается путем растрового сканирования положения образца относительно наконечника и регистрации высоты зонда, которая соответствует постоянному взаимодействию зонда и образца (более подробную информацию см. В разделе «Топографическое изображение в АСМ»). Топография поверхности обычно отображается в виде псевдоцвета.участок. Хотя первая публикация Биннига, Куэта и Гербера об атомно-силовой микроскопии в 1986 году высказывала предположение о возможности достижения атомного разрешения, необходимо было преодолеть серьезные экспериментальные проблемы, прежде чем атомное разрешение дефектов и краев ступеней в окружающих (жидких) условиях было продемонстрировано в 1993 г. Онезорге и Бинниг. [2] Истинное атомное разрешение поверхности кремния 7x7 - атомные изображения этой поверхности, полученные с помощью СТМ, убедили научное сообщество в впечатляющем пространственном разрешении сканирующей туннельной микроскопии - пришлось подождать немного дольше, прежде чем это было показано Гиссиблом. [3]
При манипуляции силы между зондом и образцом также могут использоваться для контролируемого изменения свойств образца. Примеры этого включают атомные манипуляции, литографию сканирующего зонда и локальную стимуляцию клеток.
Одновременно с получением топографических изображений другие свойства образца могут быть измерены локально и отображены в виде изображения, часто с таким же высоким разрешением. Примерами таких свойств являются механические свойства, такие как жесткость или прочность сцепления, и электрические свойства, такие как проводимость или поверхностный потенциал. Фактически, большинство методов СЗМ являются расширениями АСМ, в которых используется эта модальность. [4]
Другие технологии микроскопии [ править ]
Основное различие между атомно-силовой микроскопией и конкурирующими технологиями, такими как оптическая микроскопия и электронная микроскопия, заключается в том, что АСМ не использует линзы или лучевое облучение. Следовательно, он не страдает ограничением пространственного разрешения из-за дифракции и аберрации, а подготовка пространства для направления луча (путем создания вакуума) и окрашивание образца не требуются.
Существует несколько типов сканирующей микроскопии, включая сканирующую зондовую микроскопию (которая включает АСМ, сканирующую туннельную микроскопию (СТМ) и сканирующий оптический микроскоп ближнего поля (СБОМ / НСОМ), микроскопию СТЭД (СТЭД ), а также сканирующую электронную микроскопию и электрохимическую АСМ , ЭК. -AFM). Хотя SNOM и STED используют видимый , инфракрасный или даже терагерцовый свет для освещения образца, их разрешение не ограничивается дифракционным пределом.
Конфигурация [ править ]
На рис. 3 показан AFM, который обычно состоит из следующих элементов. [5] Цифры в скобках соответствуют пронумерованным объектам на рис. 3. Координатные направления определяются системой координат (0).
(1) : кантилевер, (2) : опора для кантилевера, (3) : пьезоэлектрический элемент (для колебания кантилевера на его собственной частоте), (4) : наконечник (закреплен на открытом конце кантилевера, действует как зонд), (5) : Детектор отклонения и движения кантилевера, (6) : Образец, подлежащий измерению с помощью АСМ, (7) : xyz-привод, (перемещает образец (6) и столик (8) в направлениях x, y и z относительно вершины наконечника (4)) и (8) : стадия.
Небольшая пружинная консоль (1) поддерживается опорой (2). Необязательно, пьезоэлектрический элемент (обычно изготовленный из керамического материала) (3) вызывает колебания кантилевера (1). Острый наконечник (4) закреплен на свободном конце кантилевера (1). Детектор (5) регистрирует отклонение и движение кантилевера (1). Образец (6) установлен на предметном столике (8). Привод xyz (7) позволяет перемещать образец (6) и предметный столик (8) в направлениях x, y и z относительно вершины наконечника (4). Хотя на рис. 3 показан привод, прикрепленный к образцу, привод также может быть прикреплен к наконечнику или к обоим могут быть прикреплены независимые приводы, поскольку необходимо контролировать относительное смещение образца и наконечника. Контроллеры и плоттер на рис.3 не показаны.
Согласно конфигурации, описанной выше, взаимодействие между зондом и образцом, которое может быть явлением атомного масштаба, преобразуется в изменения движения кантилевера, что является явлением макромасштаба. Несколько различных аспектов движения кантилевера могут быть использованы для количественной оценки взаимодействия между зондом и образцом, чаще всего величина отклонения, амплитуда вынужденных колебаний кантилевера или сдвиг резонансной частоты кантилевера (см. Раздел Режимы визуализации).
Детектор [ править ]
Детектор (5) AFM измеряет отклонение (смещение относительно положения равновесия) кантилевера и преобразует его в электрический сигнал. Интенсивность этого сигнала будет пропорциональна перемещению кантилевера.
Могут использоваться различные методы обнаружения, например, интерферометрия, оптические рычаги, пьезоэлектрический метод и детекторы на основе СТМ (см. Раздел «Измерение отклонения кантилевера АСМ»).
Формирование изображения [ править ]
Примечание. В следующих параграфах предполагается, что используется «контактный режим» (см. Раздел «Режимы визуализации»). Для других режимов визуализации процесс аналогичен, за исключением того, что «отклонение» следует заменить соответствующей переменной обратной связи.
При использовании АСМ для изображения образца наконечник приводится в контакт с образцом, и образец сканируется в растровом формате по координатной сетке x – y (рис. 4). Чаще всего используется электронная петля обратной связи для поддержания постоянной силы между зондом и образцом во время сканирования. Этот контур обратной связи имеет в качестве входного сигнала отклонение кантилевера, а его выход управляет расстоянием по оси z между опорой зонда (2 на рис. 3) и опорой для образца (8 на рис. 3). Пока игла остается в контакте с образцом, а образец сканируется в плоскости x – y, изменения высоты образца изменяют отклонение кантилевера. Затем обратная связь регулирует высоту опоры зонда так, что отклонение восстанавливается до заданного пользователем значения (уставки).Правильно отрегулированная петля обратной связи регулирует расстояние между опорой и образцом непрерывно во время движения сканирования, так что отклонение остается примерно постоянным. В этой ситуации выходной сигнал обратной связи с точностью до небольшой ошибки равен топографии поверхности образца.
Исторически использовался другой метод работы, при котором расстояние между опорой образец-зонд поддерживается постоянным и не контролируется обратной связью ( сервомеханизм). В этом режиме, обычно называемом «режимом постоянной высоты», отклонение кантилевера регистрируется как функция от положения образца по оси x – y. Пока игла находится в контакте с образцом, отклонение соответствует топографии поверхности. Основная причина, по которой этот метод больше не пользуется большой популярностью, заключается в том, что силы между зондом и образцом не контролируются, что может привести к возникновению сил, достаточно высоких, чтобы повредить зонд или образец. Однако обычная практика заключается в регистрации отклонения даже при сканировании в «режиме постоянной силы» с обратной связью. Это выявляет небольшую ошибку отслеживания обратной связи и иногда может выявить функции, на которые обратная связь не могла быть скорректирована.
Сигналы АСМ, такие как высота образца или отклонение кантилевера, записываются на компьютер во время сканирования x – y. Они построены на псевдоцветном изображении, в котором каждый пиксель представляет положение x – y на образце, а цвет представляет записанный сигнал.
(1) : вершина наконечника, (2) : поверхность образца, (3) : Z-орбита вершины наконечника, (4) : консоль.
История [ править ]
AFM был изобретен учеными IBM в 1985 году [6] Предшественник АФМ, то сканирующего туннельного микроскопа (СТМ), был разработан Бинниг и Генрих Рорер в начале 1980 - х годов в IBM Research - Zurich , развитие , которое их заработал Нобелевская премия по физике 1986 года . Бинниг изобрел [5] атомно-силовой микроскоп, и первая экспериментальная реализация была сделана Биннигом, Куэтом и Гербером в 1986 году [7].
Первый коммерчески доступный атомно-силовой микроскоп был представлен в 1989 году. АСМ - один из передовых инструментов для получения изображений, измерения и манипулирования материей в наномасштабе .
Приложения [ править ]
АСМ был применен к проблемам в широком спектре дисциплин естественных наук, в том числе физики твердого тела , полупроводниковая науки и технику, молекулярная инженерия , химии полимеров и физика , химия поверхности , молекулярная биология , клеточная биология и медицина .
Приложения в области физики твердого тела включают (а) идентификацию атомов на поверхности, (б) оценку взаимодействий между конкретным атомом и соседними с ним атомами и (в) изучение изменений физических свойств, возникающих в результате изменений. в атомном расположении посредством атомных манипуляций.
В молекулярной биологии AFM можно использовать для изучения структуры и механических свойств белковых комплексов и сборок. Например, AFM использовался для получения изображения микротрубочек и измерения их жесткости.
В клеточной биологии АСМ можно использовать для попытки отличить раковые клетки от нормальных клеток на основе их твердости, а также для оценки взаимодействий между конкретной клеткой и соседними с ней клетками в конкурентной культуральной системе. АСМ также можно использовать для вдавливания клеток, чтобы изучить, как они регулируют жесткость или форму клеточной мембраны или стенки.
В некоторых вариантах электрические потенциалы также можно сканировать с помощью проводящих кантилеверов . В более продвинутых версиях через наконечник можно пропускать токи, чтобы исследовать электрическую проводимость или перенос подстилающей поверхности, но это сложная задача, поскольку несколько исследовательских групп сообщают согласованные данные (по состоянию на 2004 год). [8]
Принципы [ править ]
АСМ состоит из кантилевера с острым наконечником (зондом) на конце, который используется для сканирования поверхности образца. Кантилевер обычно представляет собой кремний или нитрид кремния с радиусом кривизны острия порядка нанометров. Когда игла приближается к поверхности образца, силы между иглой и образцом приводят к отклонению кантилевера в соответствии с законом Гука . [9] В зависимости от ситуации силы, которые измеряются в АСМ, включают механическое контактное усилие, силы Ван-дер-Ваальса , капиллярные силы , химическое связывание , электростатические силы., Магнитные силы (см магнитного силовой микроскопа , MFM), Казимир сила , сольватация сила , и т.д. Наряду с силой, дополнительное количество одновременно может быть измерено путем использования специализированных типов зондов (см сканирований тепловой микроскопии , сканирующая микроскопия джоулевого расширения , фототермический микроскопия и др.).
AFM может работать в нескольких режимах, в зависимости от приложения. В общем, возможные режимы визуализации делятся на статические (также называемые контактными ) режимами и различные динамические (бесконтактные или «постукивающие») режимы, в которых кантилевер колеблется или колеблется с заданной частотой. [7]
Режимы визуализации [ править ]
Работа AFM обычно описывается как один из трех режимов в зависимости от характера движения наконечника: контактный режим, также называемый статическим режимом (в отличие от двух других режимов, которые называются динамическими режимами); режим постукивания, также называемый прерывистым контактом, режимом переменного тока или режимом вибрации, или, после механизма обнаружения, АСМ с амплитудной модуляцией; бесконтактный режим, или, опять же после механизма обнаружения, АСМ с частотной модуляцией.
Несмотря на номенклатуру, отталкивающий контакт может возникнуть или его можно избежать как в АСМ с амплитудной модуляцией, так и в АСМ с частотной модуляцией, в зависимости от настроек. [ необходима цитата ]
Контактный режим [ править ]
В контактном режиме наконечник «протягивается» по поверхности образца, и контуры поверхности измеряются либо с использованием прямого отклонения кантилевера, либо, что более часто, с использованием сигнала обратной связи, необходимого для поддержания кантилевера в постоянном положении. . Поскольку измерение статического сигнала подвержено шуму и дрейфу, используются кантилеверы с низкой жесткостью (т. Е. Кантилеверы с низкой жесткостью пружины, k) для достижения достаточно большого сигнала отклонения при сохранении низкой силы взаимодействия. Вблизи поверхности образца силы притяжения могут быть довольно сильными, заставляя иглу «защелкиваться» на поверхности. Таким образом, АСМ в контактном режиме почти всегда выполняется на глубине, где общая сила является отталкивающей, то есть в плотном «контакте» с твердой поверхностью.
Режим касания [ править ]
В условиях окружающей среды на большинстве образцов образуется жидкий менисковый слой. Из-за этого удерживание наконечника зонда достаточно близко к образцу, чтобы можно было обнаружить силы ближнего действия, при одновременном предотвращении прилипания наконечника к поверхности представляет собой серьезную проблему для контактного режима в условиях окружающей среды. Режим динамического контакта (также называемый прерывистым контактом, режимом переменного тока или режимом постукивания) был разработан, чтобы обойти эту проблему. [11] В настоящее время режим постукивания является наиболее часто используемым режимом AFM при работе в условиях окружающей среды или в жидкостях.
В режиме постукивания кантилевер колеблется вверх и вниз на своей резонансной частоте или около нее. Это колебание обычно достигается с помощью небольшого пьезоэлемента в держателе кантилевера, но другие возможности включают магнитное поле переменного тока (с магнитными кантилеверами), пьезоэлектрические кантилеверы или периодический нагрев модулированным лазерным лучом. Амплитуда этого колебания обычно колеблется от нескольких нм до 200 нм. В режиме постукивания частота и амплитуда управляющего сигнала поддерживаются постоянными, что приводит к постоянной амплитуде колебаний кантилевера до тех пор, пока нет дрейфа или взаимодействия с поверхностью. Взаимодействие сил, действующих на кантилевер при приближении иглы к поверхности, силы Ван-дер-Ваальса , диполь-дипольные взаимодействия, Электростатические силы и т.д. причина амплитуды колебаний кантилевера к изменению (обычно уменьшаются) , как кончик становится ближе к образцу. Эта амплитуда используется как параметр, который поступает в электронный сервопривод, который регулирует высоту кантилевера над образцом. Сервопривод регулирует высоту для поддержания заданной амплитуды колебаний кантилевера при сканировании кантилевера по образцу. Нажав АСМ изображение, таким образом , получают путем визуализации силу прерывистых контактов наконечника с поверхностью образца. [12]
Хотя пиковые силы, прикладываемые во время контактирующей части колебания, могут быть намного выше, чем обычно используются в контактном режиме, режим постукивания обычно уменьшает повреждение, наносимое поверхности и наконечнику, по сравнению с величиной, нанесенной в контактном режиме. Это можно объяснить короткой продолжительностью приложенного усилия, а также тем, что поперечные силы между зондом и образцом значительно ниже в режиме постукивания по сравнению с режимом контакта. Визуализация в режиме постукивания достаточно щадящая даже для визуализации поддерживаемых липидных бислоев или адсорбированных одиночных полимерных молекул (например, цепей синтетических полиэлектролитов толщиной 0,4 нм) в жидкой среде. При правильных параметрах сканирования конформация отдельных молекул может оставаться неизменной в течение нескольких часов [10]. и даже одиночные молекулярные двигатели можно визуализировать во время движения.
При работе в режиме постукивания также может быть записана фаза колебаний кантилевера относительно управляющего сигнала. Этот сигнальный канал содержит информацию об энергии, рассеиваемой кантилевером в каждом колебательном цикле. Образцы, содержащие участки с различной жесткостью или с разными адгезионными свойствами, могут давать контраст в этом канале, который не виден на топографическом изображении. Однако количественное извлечение свойств материала образца из фазовых изображений часто невозможно.
Бесконтактный режим [ править ]
В режиме бесконтактной атомно-силовой микроскопии кончик кантилевера не контактирует с поверхностью образца. Вместо этого кантилевер колеблется либо на своей резонансной частоте (частотная модуляция), либо чуть выше (амплитудная модуляция), где амплитуда колебаний обычно составляет от нескольких нанометров (<10 нм) до нескольких пикометров. [13] Силы Ван-дер-Ваальса, которые являются самыми сильными на расстоянии от 1 нм до 10 нм над поверхностью, или любая другая дальнодействующая сила, которая распространяется над поверхностью, снижает резонансную частоту кантилевера. Это уменьшение резонансной частоты в сочетании с системой обратной связи поддерживает постоянную амплитуду или частоту колебаний за счет регулировки среднего расстояния между зондом и образцом. Измерение расстояния между зондом и образцом в каждой точке данных (x, y) позволяет программному обеспечению сканирования построить топографическое изображение поверхности образца.
АСМ в бесконтактном режиме не страдает эффектами деградации наконечника или образца, которые иногда наблюдаются после выполнения многочисленных сканирований с помощью контактной АСМ. Это делает бесконтактную АСМ предпочтительнее контактной АСМ для измерения мягких образцов, например биологических образцов и органических тонких пленок. В случае жестких образцов контактные и бесконтактные изображения могут выглядеть одинаково. Однако, если несколько монослоев адсорбированной жидкости лежат на поверхности жесткого образца, изображения могут выглядеть совершенно иначе. АСМ, работающий в контактном режиме, проникает в слой жидкости, чтобы отобразить нижележащую поверхность, тогда как в бесконтактном режиме АСМ будет колебаться над слоем адсорбированной жидкости, чтобы отобразить как жидкость, так и поверхность.
Схемы для работы в динамическом режиме включают частотную модуляцию, при которой контур фазовой автоподстройки частоты используется для отслеживания резонансной частоты кантилевера, и более распространенную амплитудную модуляцию с установленным контуром сервопривода, чтобы поддерживать возбуждение кантилевера на определенной амплитуде. При частотной модуляции изменения частоты колебаний предоставляют информацию о взаимодействиях зонд-образец. Частоту можно измерить с очень высокой чувствительностью, поэтому режим частотной модуляции позволяет использовать очень жесткие кантилеверы. Жесткие кантилеверы обеспечивают стабильность очень близко к поверхности, и в результате этот метод был первым методом АСМ, обеспечивающим истинное атомное разрешение в условиях сверхвысокого вакуума .[14]
При амплитудной модуляции изменения амплитуды или фазы колебаний обеспечивают сигнал обратной связи для построения изображения. При амплитудной модуляции изменения фазы колебаний можно использовать для различения различных типов материалов на поверхности. Амплитудная модуляция может работать как в бесконтактном, так и в прерывистом контактном режиме. В режиме динамического контакта кантилевер колеблется таким образом, что расстояние между острием кантилевера и поверхностью образца модулируется.
Амплитудная модуляция также использовалась в бесконтактном режиме для получения изображений с атомарным разрешением за счет использования очень жестких кантилеверов и малых амплитуд в условиях сверхвысокого вакуума.
Топографическое изображение [ править ]
Формирование изображения - это метод построения графика, который создает цветовое отображение путем изменения положения наконечника по осям x – y при сканировании и записи измеряемой переменной, то есть интенсивности управляющего сигнала, для каждой координаты x – y. Цветовая карта показывает измеренное значение, соответствующее каждой координате. Изображение выражает интенсивность значения в виде оттенка. Обычно соответствие между интенсивностью значения и оттенком отображается в виде цветовой шкалы в пояснительных примечаниях, сопровождающих изображение.
Что такое топографическое изображение атомно-силового микроскопа? [ редактировать ]
Рабочие режимы формирования изображения AFM обычно подразделяются на две группы с точки зрения того, использует ли он петлю z-обратной связи (не показана) для поддержания расстояния между зондом и образцом для сохранения интенсивности сигнала, экспортируемого детектором. Первый (с использованием петли z-обратной связи), называемый «постоянным режимом XX » ( XX - это то, что поддерживается петлей z-обратной связи).
Режим формирования топографического изображения основан на вышеупомянутом « режиме постоянного ХХ », контур z-обратной связи контролирует относительное расстояние между зондом и образцом посредством выдачи управляющих сигналов, чтобы поддерживать постоянными одну из частоты, вибрации и фазы, которые обычно соответствуют движению кантилевера. (например, на Z-пьезоэлемент подается напряжение, и он перемещает образец вверх и вниз в направлении Z.
Подробности будут объяснены в случае, особенно "режима постоянной df" (FM-AFM) среди AFM в качестве примера в следующем разделе.
Топографическое изображение FM-AFM [ править ]
Когда расстояние между зондом и образцом доведено до диапазона, в котором может быть обнаружена атомная сила, в то время как кантилевер возбуждается на своей собственной частоте (f 0 ), возникает явление, когда резонансная частота (f) кантилевера смещается от его исходной резонансной частоты (собственной собственной частоты). Другими словами, в диапазоне, в котором может быть обнаружена атомная сила, будет наблюдаться сдвиг частоты (df = ff 0 ). Таким образом, когда расстояние между зондом и образцом находится в бесконтактной области, частотный сдвиг увеличивается в отрицательном направлении по мере того, как расстояние между зондом и образцом становится меньше.
Когда образец имеет вогнутость и выпуклость, расстояние между вершиной наконечника и образцом изменяется в соответствии с вогнутостью и выпуклостью, сопровождаемой сканированием образца в направлении x – y (без регулировки высоты в направлении z). В результате возникает частотный сдвиг. Изображение, на котором значения частоты, полученные при растровом сканировании вдоль направления x – y поверхности образца, нанесены на график в зависимости от координации x – y каждой точки измерения, называется изображением постоянной высоты.
С другой стороны, df может поддерживаться постоянным, перемещая зонд вверх и вниз (см. (3) на фиг.5) в направлении z, используя отрицательную обратную связь (используя петлю z-обратной связи), в то время как растровое сканирование поверхность образца в направлении x – y. Изображение, на котором количество отрицательной обратной связи (расстояние перемещения датчика вверх и вниз в направлении z) нанесено в зависимости от координаты x – y каждой точки измерения, является топографическим изображением. Другими словами, топографическое изображение - это след кончика зонда, отрегулированный так, чтобы df была постоянной, и его также можно рассматривать как график поверхности постоянной высоты df.
Следовательно, топографическое изображение АСМ - это не точная морфология самой поверхности, а фактически изображение, на которое влияет порядок связи между зондом и образцом, однако считается, что топографическое изображение АСМ отражает географическую форму местности. поверхность больше, чем топографическое изображение сканирующего туннельного микроскопа.
Силовая спектроскопия [ править ]
Еще одно важное применение АСМ (помимо визуализации) - это силовая спектроскопия , прямое измерение сил взаимодействия зонд-образец в зависимости от зазора между зондом и образцом (результат этого измерения называется кривой силы-расстояния). Для этого метода наконечник АСМ выдвигается к поверхности и отводится от поверхности, поскольку отклонение кантилевера отслеживается как функция пьезоэлектрического смещения. Эти измерения были использованы для измерения наноразмерных контактов, атомно - склеивание , Ван - дер - Ваальса , и силы Казимира , растворения силы в жидкостях и одной молекулы растяжения и разрыва сил. [15]Кроме того, AFM использовался для измерения в водной среде дисперсионной силы, обусловленной адсорбцией полимера на подложке. [16] Силы порядка нескольких пиконьютонов теперь можно регулярно измерять с разрешением по вертикали лучше 0,1 нанометра. Силовая спектроскопия может выполняться как в статическом, так и в динамическом режимах. В динамических режимах, помимо статического прогиба, отслеживается информация о вибрации кантилевера. [17]
Проблемы с этой техникой включают отсутствие прямого измерения расстояния между зондом и образцом и общую потребность в кантилеверах с низкой жесткостью, которые имеют тенденцию «защелкиваться» на поверхности. Эти проблемы не являются непреодолимыми. Был разработан АСМ, который непосредственно измеряет расстояние между зондом и образцом. [18] Защелкивание можно уменьшить, измеряя в жидкостях или используя более жесткие консоли, но в последнем случае требуется более чувствительный датчик отклонения. Приложив к наконечнику небольшое колебание, можно также измерить жесткость (градиент силы) связки. [19]
Биологические приложения и прочее [ править ]
Силовая спектроскопия используется в биофизике для измерения механических свойств живого материала (например, ткани или клеток) [20] [21] [22] или обнаружения структур различной жесткости, скрытых в объеме образца, с помощью томографии жесткости. [23] Другое приложение заключалось в измерении сил взаимодействия между, с одной стороны, материалом, застрявшим на кончике кантилевера, и, с другой стороны, поверхностью частиц, либо свободной, либо занятой тем же материалом. По кривой распределения силы сцепления было получено среднее значение сил. Это позволило сделать картографию поверхности частиц, покрытых или не покрытых материалом. [24] АСМ также использовались для механического разворачивания белков.[25] В таких экспериментах анализ средних сил разворачивания с помощью соответствующей модели [26] приводит к получению информации о скорости разворачивания и параметрах профиля свободной энергии белка.
Идентификация отдельных поверхностных атомов [ править ]
АСМ можно использовать для получения изображений и манипулирования атомами и структурами на различных поверхностях. Атом на вершине острия «чувствует» отдельные атомы на подстилающей поверхности, когда он образует зарождающиеся химические связи с каждым атомом. Поскольку эти химические взаимодействия незначительно изменяют частоту колебаний наконечника, их можно обнаружить и отобразить. Этот принцип использовался для различения атомов кремния, олова и свинца на поверхности сплава путем сравнения этих «атомных отпечатков пальцев» со значениями, полученными при моделировании крупномасштабной теории функционала плотности (DFT). [27]
Уловка состоит в том, чтобы сначала точно измерить эти силы для каждого типа атомов, ожидаемых в образце, а затем сравнить с силами, полученными при моделировании DFT. Команда обнаружила, что острие наиболее сильно взаимодействует с атомами кремния и на 24% и 41% меньше взаимодействует с атомами олова и свинца соответственно. Таким образом, каждый разный тип атома может быть идентифицирован в матрице по мере того, как острие перемещается по поверхности.
Зонд [ править ]
Зонд АСМ имеет острый наконечник на свободно вращающемся конце кантилевера, который выступает из держателя. [28] Размеры кантилевера указаны в микрометрах. Радиус наконечника обычно составляет от нескольких нанометров до нескольких десятков нанометров. (Существуют специальные зонды с гораздо большими концевыми радиусами, например зонды для вдавливания мягких материалов.) Консольный держатель, также называемый держателем чипа - часто размером 1,6 мм на 3,4 мм - позволяет оператору удерживать узел кантилевера / зонда АСМ с помощью пинцетом и вставьте его в соответствующие зажимы держателя на сканирующей головке атомно-силового микроскопа.
Это устройство чаще всего называют «зондом АСМ», но другие названия включают «наконечник АСМ» и « кантилевер » (с использованием имени отдельной части как имени всего устройства). Зонд АСМ - это особый тип зонда СЗМ ( сканирующая зондовая микроскопия ).
Зонды AFM производятся по технологии MEMS . Большинство используемых зондов AFM изготовлено из кремния (Si), но также используются боросиликатное стекло и нитрид кремния . Зонды AFM считаются расходными материалами, поскольку их часто заменяют, когда вершина наконечника затупляется или загрязняется, или когда кантилевер сломан. Они могут стоить от пары десятков до сотен долларов за кантилевер для наиболее специализированных комбинаций кантилевер / зонд.
Просто наконечник подносится очень близко к поверхности исследуемого объекта, кантилевер отклоняется за счет взаимодействия между наконечником и поверхностью, для измерения чего и предназначен АСМ. Пространственная карта взаимодействия может быть составлена путем измерения отклонения во многих точках на двумерной поверхности.
Можно обнаружить несколько типов взаимодействия. В зависимости от исследуемого взаимодействия поверхность острия зонда АСМ необходимо модифицировать покрытием. Среди используемых покрытий золото - для ковалентного связывания биологических молекул и обнаружения их взаимодействия с поверхностью, [29] алмаз для повышения износостойкости [30] и магнитные покрытия для обнаружения магнитных свойств исследуемой поверхности. [31] Существует еще одно решение для получения магнитных изображений с высоким разрешением: наличие зонда, оснащенного microSQUID.. Наконечники AFM изготавливаются с использованием кремниевой микрообработки, а точное позиционирование петли microSQUID выполняется с помощью электронно-лучевой литографии. [32] Дополнительное прикрепление квантовой точки к вершине наконечника проводящего зонда позволяет получать изображения поверхностного потенциала с высоким латеральным разрешением, используя сканирующую микроскопию квантовых точек . [33]
Поверхность консолей также может быть изменена. Эти покрытия в основном применяются для увеличения отражательной способности кантилевера и улучшения сигнала отклонения.
Силы против геометрии наконечника [ править ]
Силы между иглой и образцом сильно зависят от геометрии иглы. В последние годы были проведены различные исследования для записи сил как функции параметров наконечника.
Среди различных сил между зондом и образцом очень интересны силы водяного мениска как в воздухе, так и в жидкой среде. Необходимо учитывать и другие силы, такие как кулоновская сила , силы Ван-дер-Ваальса , взаимодействия двух слоев , силы сольватации , гидратация и гидрофобные силы.
Водный мениск [ править ]
Силы водяного мениска очень интересны для АСМ-измерений в воздухе. Из-за влажности окружающей среды, при измерениях на воздухе между зондом и образцом образуется тонкий слой воды. Результирующая капиллярная сила порождает сильную силу притяжения, которая притягивает наконечник к поверхности. Фактически, сила адгезии, измеренная между зондом и образцом в окружающем воздухе с конечной влажностью, обычно определяется капиллярными силами. Как следствие, наконечник трудно оторвать от поверхности. Для мягких образцов, включая многие полимеры и, в частности, биологические материалы, сильная адгезионная капиллярная сила приводит к деградации и разрушению образца при визуализации в контактном режиме. Исторически эти проблемы были важной мотивацией для развития динамической визуализации в воздухе (например, «режим постукивания»). Во время визуализации в режиме постукивания в воздухе капиллярные мостики все еще образуются. Тем не менее, для подходящих условий визуализациикапиллярные перемычки образуются и разрушаются в каждом цикле колебаний кантилевера перпендикулярно поверхности, что можно сделать вывод из анализа кривых амплитуды кантилевера и зависимости фазы от расстояния.[34] Как следствие, разрушающие силы сдвига в значительной степени уменьшаются, и можно исследовать мягкие образцы.
Чтобы количественно определить равновесную капиллярную силу, необходимо начать с уравнения Лапласа для давления:
где γ L - поверхностная энергия, а r 0 и r 1 определены на рисунке.
Давление прикладывают к области размером
где d, θ и h определены на рисунке.
Сила, стягивающая две поверхности, равна
Эту же формулу можно рассчитать как функцию относительной влажности.
Гао [35] рассчитал формулы для разной геометрии наконечника. Например, сила уменьшается на 20% для конического наконечника по сравнению со сферическим наконечником.
При расчете этих сил необходимо различать ситуацию «мокрый по сухому» и «мокрый по мокрому».
Для сферического наконечника сила равна:
для сушки по мокрому
для мокрого по мокрому
где θ - угол контакта сухой сферы, а φ - угол погружения, как показано на рисунке. На этом же рисунке показаны R, h и D.
Для конического наконечника формула выглядит следующим образом:
для сушки по мокрому
для мокрого по мокрому
где δ - угол полуконуса, а r 0 и h - параметры профиля мениска.
Измерение отклонения кантилевера АСМ [ править ]
Измерение отклонения луча [ править ]
Наиболее распространенным методом измерения отклонения кантилевера является метод отклонения балки. В этом методе лазерный свет от твердотельного диода отражается от задней части кантилевера и собирается позиционно-чувствительным детектором (PSD), состоящим из двух близко расположенных фотодиодов , выходной сигнал которых собирается дифференциальным усилителем . Угловое смещение кантилевера приводит к тому, что один фотодиод собирает больше света, чем другой фотодиод, создавая выходной сигнал (разность между сигналами фотодиода, нормированную на их сумму), который пропорционален отклонению кантилевера. Чувствительность метода отклонения луча очень высока, минимальный уровень шума порядка 10 фм Гц - 1 ⁄ 2.могут быть получены в обычном порядке в хорошо спроектированной системе. Хотя этот метод иногда называют методом «оптического рычага», сигнал не усиливается, если путь луча удлиняется. Более длинный путь луча увеличивает движение отраженного пятна на фотодиодах, но также расширяет пятно на ту же величину из-за дифракции , так что одно и то же количество оптической мощности передается от одного фотодиода к другому. «Оптический рычаг» (выходной сигнал детектора, деленный на отклонение кантилевера) обратно пропорционален числовой апертуре оптики фокусировки луча, если сфокусированное лазерное пятно достаточно мало, чтобы полностью упасть на кантилевер. Он также обратно пропорционален длине кантилевера.
Относительная популярность метода отклонения луча может быть объяснена его высокой чувствительностью и простой работой, а также тем фактом, что кантилеверы не требуют электрических контактов или другой специальной обработки и, следовательно, могут быть изготовлены относительно дешево с острыми интегрированными наконечниками.
Другие методы измерения прогиба [ править ]
Существует множество других методов измерения отклонения луча.
- Пьезоэлектрическое обнаружение - Консоли, сделанные из кварца [36] (например, конфигурация qPlus ) или других пьезоэлектрических материалов, могут непосредственно обнаруживать отклонение как электрический сигнал. С помощью этого метода были обнаружены колебания кантилевера до 22:00.
- Лазерная доплеровская виброметрия . Лазерный доплеровский виброметр можно использовать для очень точных измерений отклонения колеблющегося кантилевера [37] (таким образом, он используется только в бесконтактном режиме). Этот метод дорогостоящий и используется лишь относительно небольшим количеством групп.
- Сканирующий туннельный микроскоп (СТМ). Первый атомный микроскоп использовал СТМ с собственным механизмом обратной связи для измерения отклонения. [7] Этот метод очень сложно реализовать, и он медленно реагирует на изменения прогиба по сравнению с современными методами.
- Оптическая интерферометрия - оптическая интерферометрия может использоваться для измерения отклонения кантилевера. [38] Из-за отклонений нанометрового масштаба, измеренных в АСМ, интерферометр работает в субполосном режиме, таким образом, любой дрейф мощности или длины волны лазера оказывает сильное влияние на измерения. По этим причинам измерения с помощью оптического интерферометра должны выполняться с большой осторожностью (например, с использованием жидкостей для согласования показателей между переходами оптического волокна) с очень стабильными лазерами. По этим причинам оптическая интерферометрия используется редко.
- Емкостное обнаружение - кантилеверы с металлическим покрытием могут образовывать конденсатор с другим контактом, расположенным за кантилевером. [39] Отклонение изменяет расстояние между контактами и может быть измерено как изменение емкости.
- Пьезорезистивное обнаружение - кантилеверы могут быть изготовлены с пьезорезистивными элементами, которые действуют как тензодатчики . С помощью моста Уитстона можно измерить деформацию кантилевера АСМ из-за отклонения. [40] Это обычно не используется в вакуумных приложениях, поскольку пьезорезистивное обнаружение рассеивает энергию системы, влияя на добротность резонанса.
Пьезоэлектрические сканеры [ править ]
Сканеры AFM изготовлены из пьезоэлектрического материала, который расширяется и сжимается пропорционально приложенному напряжению. Удлиняются они или сжимаются, зависит от полярности приложенного напряжения. Обычно зонд или образец устанавливают на «штатив» из трех пьезокристаллов, каждый из которых отвечает за сканирование в направлениях x , y и z . [7] В 1986 году, в том же году, когда был изобретен АСМ , для использования в СТМ был разработан новый пьезоэлектрический сканер, трубчатый сканер. [41] Позднее трубные сканеры были включены в АСМ. Сканер трубок может перемещать образец по осям x , y и z.направления с использованием однотрубного пьезо с одним внутренним контактом и четырьмя внешними контактами. Преимуществом трубчатого сканера по сравнению с оригинальной конструкцией штатива является лучшая виброизоляция, обусловленная более высокой резонансной частотой одноэлементной конструкции в сочетании с каскадом изоляции низкой резонансной частоты. Недостатком является то, что движение по осям x - y может вызвать нежелательное движение по оси z, приводящее к искажению. Другой популярной конструкцией сканеров AFM является этап изгиба , в котором используются отдельные пьезоэлектрические преобразователи для каждой оси и они соединяются посредством механизма изгиба.
Сканеры характеризуются своей чувствительностью, которая представляет собой отношение пьезодвижения к пьезо напряжению, то есть насколько пьезоматериал расширяется или сжимается на приложенное вольт. Из-за различий в материале или размере чувствительность варьируется от сканера к сканеру. Чувствительность изменяется нелинейно в зависимости от размера сканирования. Пьезосканеры демонстрируют большую чувствительность в конце, чем в начале сканирования. Это заставляет прямое и обратное сканирование вести себя по-разному и отображать гистерезис между двумя направлениями сканирования. [42] Это можно исправить, приложив нелинейное напряжение к пьезоэлектродам, чтобы вызвать линейное движение сканера, и соответствующим образом откалибровав сканер. [42]Одним из недостатков этого подхода является то, что он требует повторной калибровки, поскольку точное нелинейное напряжение, необходимое для исправления нелинейного движения, будет изменяться по мере старения пьезоэлемента (см. Ниже). Эту проблему можно обойти, добавив линейный датчик к столику для образца или пьезоэлементу для определения истинного движения пьезоэлемента. Отклонения от идеального движения могут быть обнаружены датчиком и внесены поправки в сигнал пьезопривода для коррекции нелинейного пьезодвижения. Эта конструкция известна как АСМ с замкнутым контуром. Несенсорные пьезо-АСМ называются АСМ с открытым контуром.
Чувствительность пьезоэлектрических материалов экспоненциально уменьшается со временем. Это приводит к тому, что большая часть изменения чувствительности происходит на начальных этапах эксплуатации сканера. Пьезоэлектрические сканеры работают примерно 48 часов перед отправкой с завода, так что они прошли точку, где могут иметь место большие изменения чувствительности. По мере старения сканера чувствительность со временем будет меняться меньше, и сканеру редко потребуется повторная калибровка [43] [44], хотя различные руководства производителей рекомендуют ежемесячную или полумесячную калибровку АСМ с разомкнутым контуром.
Преимущества и недостатки [ править ]
Преимущества [ править ]
AFM имеет несколько преимуществ перед сканирующим электронным микроскопом (SEM). В отличие от электронного микроскопа, который обеспечивает двумерную проекцию или двухмерное изображение образца, АСМ обеспечивает трехмерный профиль поверхности. Кроме того, образцы, просматриваемые с помощью АСМ, не требуют какой-либо специальной обработки (например, покрытия металлом / углеродом), которая необратимо изменяет или повреждает образец, и обычно не страдает от артефактов заряда на окончательном изображении. А электронному микроскопу нужен дорогой вакуумДля правильной работы в условиях окружающей среды большинство режимов АСМ могут отлично работать в окружающем воздухе или даже в жидкой среде. Это дает возможность изучать биологические макромолекулы и даже живые организмы. В принципе, АСМ может обеспечить более высокое разрешение, чем СЭМ. Было показано, что он дает истинное атомное разрешение в сверхвысоком вакууме (UHV), а в последнее время и в жидких средах. АСМ высокого разрешения сопоставима по разрешению со сканирующей туннельной микроскопией и просвечивающей электронной микроскопией . АСМ также можно комбинировать с различными методами оптической микроскопии и спектроскопии, такими как флуоресцентная микроскопия или инфракрасная спектроскопия, что дает начало сканирующей ближнепольной оптической микроскопии , нано-FTIR.и дальнейшее расширение его применимости. Комбинированные АСМ-оптические приборы применялись в основном в биологических науках, но в последнее время они привлекли большой интерес к фотовольтаике [12] и исследованиям накопления энергии, [45] полимерным наукам, [46] нанотехнологиям [47] [48] и даже медицинским исследованиям . [49]
Недостатки [ править ]
Недостатком АСМ по сравнению со сканирующим электронным микроскопом (СЭМ) является размер одного сканируемого изображения. За один проход SEM может отображать область порядка квадратных миллиметров с глубиной резкости порядка миллиметров, тогда как AFM может отображать только максимальную область сканирования около 150 × 150 микрометров и максимальную высоту порядка 10–20 мкм. Один из методов улучшения размера сканируемой области для АСМ заключается в использовании параллельных зондов аналогично хранению данных многоножек .
Скорость сканирования AFM также является ограничением. Традиционно AFM не может сканировать изображения так же быстро, как SEM, требуя нескольких минут для типичного сканирования, в то время как SEM может сканировать почти в реальном времени, хотя и с относительно низким качеством. Относительно низкая скорость сканирования во время формирования изображения с помощью АСМ часто приводит к тепловому дрейфу изображения [50] [51] [52], что делает АСМ менее подходящим для точного измерения расстояний между топографическими элементами изображения. Однако несколько быстродействующих конструкций [53] [54]были предложены для увеличения производительности сканирования микроскопа, включая то, что называется videoAFM (изображения приемлемого качества получаются с помощью videoAFM со скоростью видео: быстрее, чем в среднем SEM). Для устранения искажений изображения, вызванных тепловым дрейфом, было введено несколько методов. [50] [51] [52]
АСМ изображения также может зависеть от нелинейности, гистерезиса , [42] и ползучести пьезоэлектрического материала и перекрестных помех между х , у , г осей , которые могут потребовать усиление программного обеспечения и фильтрации. Такая фильтрация может «сгладить» реальные топографические особенности. Однако более новые AFM используют программное обеспечение коррекции в реальном времени (например, ориентированное на объекты сканирование [43] [50] ) или сканеры с обратной связью, которые практически устраняют эти проблемы. В некоторых АСМ также используются отдельные ортогональные сканеры (в отличие от одиночной трубки), которые также служат для устранения части проблем перекрестных помех.
Как и в случае любого другого метода визуализации, существует вероятность артефактов изображения , которые могут быть вызваны неподходящим наконечником, плохой операционной средой или даже самим образцом, как показано справа. Эти артефакты изображения неизбежны; однако их возникновение и влияние на результаты можно уменьшить с помощью различных методов. Артефакты, возникающие из-за слишком грубого наконечника, могут быть вызваны, например, неправильным обращением или фактическим столкновением с образцом либо из-за слишком быстрого сканирования, либо из-за неоправданно шероховатой поверхности, что приводит к фактическому износу наконечника.
Из-за природы зондов AFM они обычно не могут измерять крутые стены или выступы. Специально изготовленные кантилеверы и АСМ могут использоваться для модуляции зонда в сторону, а также вверх и вниз (как в динамическом контактном, так и в бесконтактном режимах) для измерения боковых стенок за счет более дорогих кантилеверов, более низкого разрешения по горизонтали и дополнительных артефактов.
Другие приложения в различных областях обучения [ править ]
Последние усилия по интеграции нанотехнологий и биологических исследований оказались успешными и имеют многообещающие перспективы на будущее. Поскольку наночастицы являются потенциальным средством доставки лекарств, биологические реакции клеток на эти наночастицы постоянно исследуются, чтобы оптимизировать их эффективность и способы улучшения их конструкции. [55] Pyrgiotakis et al. смогли изучить взаимодействие между созданными наночастицами CeO 2 и Fe 2 O 3 и клетками, прикрепив созданные наночастицы к наконечнику АСМ. [56]В исследованиях использовалась АСМ для получения дополнительной информации о поведении живых клеток в биологических средах. Спектроскопия атомных сил в реальном времени (или наноскопия) и динамическая спектроскопия атомных сил использовались для изучения живых клеток и белков мембран и их динамического поведения с высоким разрешением на наноуровне. Визуализация и получение информации о топографии и свойствах клеток также дало понимание химических процессов и механизмов, которые происходят через межклеточные взаимодействия и взаимодействия с другими сигнальными молекулами (например, лигандами). Эванс и Калдервуд использовали силовую микроскопию отдельных клеток для изучения сил клеточной адгезии , кинетики связи / динамической прочности связи и ее роли в химических процессах, таких как передача сигналов клетками. [57] Шеринг, Леви и Риго рассмотрели исследования, в которых АСМ используется для изучения кристаллической структуры мембранных белков фотосинтезирующих бактерий. [58] Alsteen et al. использовали наноскопию на основе АСМ для выполнения в реальном времени анализа взаимодействия между живыми микобактериями и антимикобактериальными препаратами (в частности, изониазидом , этионамидом , этамбутолом и стрептомицином ) [59], что служит примером более глубокого анализа патоген-лекарственные взаимодействия, которые могут быть выполнены с помощью АСМ.
См. Также [ править ]
Научный портал
- Инфракрасная спектроскопия на основе АСМ (AFM-IR)
- Электрохимический АСМ
- Картирование силы трения
- Фотопроводящая атомно-силовая микроскопия
- Сканирующая зондовая микроскопия
- Сканирующая микроскопия напряжения
- Наноразмерная спектроскопия на основе СЗМ (нано-FTIR)
- Аппарат поверхностной силы
Ссылки [ править ]
- ^ "Измерение и анализ кривых сила-расстояние с помощью атомно-силовой микроскопии" (PDF) . afmworkshop.com.
- ^ Ohnesorge, Frank (1 января 1993). «Истинное атомное разрешение с помощью атомно-силовой микроскопии с помощью сил отталкивания и притяжения». Наука . 260 (5113): 1451–6. Bibcode : 1993Sci ... 260.1451O . DOI : 10.1126 / science.260.5113.1451 . PMID 17739801 . S2CID 27528518 .
- ^ Giessibl, Franz (1 января 1996). "Атомное разрешение поверхности кремния (111) - (7x7) методом атомно-силовой микроскопии". Наука . 267 (5194): 68–71. DOI : 10.1126 / science.267.5194.68 . PMID 17840059 . S2CID 20978364 .
- ^ "Исследование атомно-силовой микроскопии, включающее изучение забытых тропических болезней" . www.afmworkshop.com .
- ^ a b Патент US4724318 - Атомно-силовой микроскоп и метод визуализации поверхностей с атомным разрешением
- ^ Binnig, G .; Quate, CF; Гербер, гл. (1986). «Атомно-силовой микроскоп» . Письма с физическим обзором . 56 (9): 930–933. Bibcode : 1986PhRvL..56..930B . DOI : 10.1103 / PhysRevLett.56.930 . PMID 10033323 .
- ^ a b c d Binnig, G .; Quate, CF; Гербер, гл. (1986). «Атомно-силовой микроскоп» . Письма с физическим обзором . 56 (9): 930–933. Bibcode : 1986PhRvL..56..930B . DOI : 10.1103 / PhysRevLett.56.930 . ISSN 0031-9007 . PMID 10033323 .
- ^ Ланг, км; DA Hite; Р. У. Симмондс; Р. Макдермотт; DP Pappas; Джон М. Мартинис (2004). «Проведение атомно-силовой микроскопии для определения характеристик туннельного барьера в наномасштабе» . Обзор научных инструментов . 75 (8): 2726–2731. Bibcode : 2004RScI ... 75.2726L . DOI : 10.1063 / 1.1777388 . Архивировано из оригинала на 2013-02-23.
- ^ Cappella, B; Дитлер, G (1999). «Кривые сила-расстояние с помощью атомно-силовой микроскопии» (PDF) . Отчеты по науке о поверхности . 34 (1–3): 1–104. Bibcode : 1999SurSR..34 .... 1C . DOI : 10.1016 / S0167-5729 (99) 00003-5 . Архивировано из оригинального (PDF) на 2012-12-03.
- ^ a b Ройтер, Y; Минко, С (ноябрь 2005 г.). "Одномолекулярные эксперименты AFM на границе твердое тело-жидкость: in situ конформация адсорбированных гибких полиэлектролитных цепей". Журнал Американского химического общества . 127 (45): 15688–9. DOI : 10.1021 / ja0558239 . ISSN 0002-7863 . PMID 16277495 .
- ^ Чжун, Q; Inniss, D; Kjoller, K; Элингс, V (1993). «Поверхность изломанного полимера / кремнеземного волокна исследована методом атомно-силовой микроскопии в режиме постукивания». Письма о науке о поверхности . 290 (1): L688. Bibcode : 1993SurSL.290L.688Z . DOI : 10.1016 / 0167-2584 (93) 90906-Y .
- ^ a b Geisse, Николас А. (июль – август 2009 г.). «АСМ и комбинированные оптические методы» . Материалы сегодня . 12 (7–8): 40–45. DOI : 10.1016 / S1369-7021 (09) 70201-9 .
- ^ Gross, L .; Mohn, F .; Moll, N .; Liljeroth, P .; Мейер, Г. (27 августа 2009 г.). «Химическая структура молекулы, разрешенная с помощью атомно-силовой микроскопии». Наука . 325 (5944): 1110–1114. Bibcode : 2009Sci ... 325.1110G . DOI : 10.1126 / science.1176210 . PMID 19713523 . S2CID 9346745 .
- ^ Giessibl, Franz J. (2003). «Успехи атомно-силовой микроскопии». Обзоры современной физики . 75 (3): 949–983. arXiv : cond-mat / 0305119 . Bibcode : 2003RvMP ... 75..949G . DOI : 10.1103 / RevModPhys.75.949 . S2CID 18924292 .
- ^ Hinterdorfer, P; Дюфрен, Юф (май 2006 г.). «Обнаружение и локализация одиночных событий молекулярного распознавания с помощью атомно-силовой микроскопии». Методы природы . 3 (5): 347–55. DOI : 10.1038 / nmeth871 . ISSN 1548-7091 . PMID 16628204 . S2CID 8912697 .
- ^ Ferrari, L .; Kaufmann, J .; Winnefeld, F .; Планк, Дж. (Июль 2010 г.). «Взаимодействие модельных систем цемента с суперпластификаторами исследовано с помощью атомно-силовой микроскопии, дзета-потенциала и измерений адсорбции». J Colloid Interface Sci . 347 (1): 15–24. Bibcode : 2010JCIS..347 ... 15F . DOI : 10.1016 / j.jcis.2010.03.005 . PMID 20356605 .
- ^ Butt, H; Cappella, B; Каппл, М. (2005). «Силовые измерения с помощью атомно-силового микроскопа: методика, интерпретация и приложения». Отчеты по науке о поверхности . 59 (1): 1–152. Bibcode : 2005SurSR..59 .... 1B . CiteSeerX 10.1.1.459.3771 . DOI : 10.1016 / j.surfrep.2005.08.003 .
- ^ Гэвин М. Кинг; Эшли Р. Картер; Эллисон Б. Чернсайд; Луиза С. Эберле и Томас Т. Перкинс (2009). "Сверхстабильная атомно-силовая микроскопия: стабильность и регистрация в атомных масштабах в условиях окружающей среды" . Нано-буквы . 9 (4): 1451–1456. Bibcode : 2009NanoL ... 9.1451K . DOI : 10.1021 / nl803298q . PMC 2953871 . PMID 19351191 .
- ^ Питер М. Хоффманн; Ахмет Орал; Ральф А. Гримбл (2001). «Прямое измерение градиентов межатомных сил с помощью атомно-силового микроскопа сверхнизкой амплитуды». Труды Королевского общества А . 457 (2009): 1161–1174. Bibcode : 2001RSPSA.457.1161M . CiteSeerX 10.1.1.487.4270 . DOI : 10.1098 / RSPA.2000.0713 . S2CID 96542419 .
- ^ Radmacher, М. (1997). «Измерение упругих свойств биологических образцов с помощью АСМ». IEEE Eng Med Biol Mag . 16 (2): 47–57. DOI : 10.1109 / 51.582176 . PMID 9086372 .
- ^ Перкинс, Томас. «Атомно-силовая микроскопия измеряет свойства белков и их укладку» . Отдел новостей SPIE . Проверено 4 марта 2016 года .
- ^ Гальванетто, Никола (2018). «Одноклеточное снятие кровли: исследование топологии и наномеханики нативных мембран». Biochimica et Biophysica Acta (BBA) - Биомембраны . 1860 (12): 2532–2538. arXiv : 1810.01643 . DOI : 10.1016 / j.bbamem.2018.09.019 . PMID 30273580 . S2CID 52897823 .
- ^ Roduit, Чарльз; Секацкий, Сергей; Дитлер, Джованни; Катсикас, Стефан; Лафон, Франк; Касас, Сандор (2009). «Томография жесткости методом атомно-силовой микроскопии» . Биофизический журнал . 97 (2): 674–677. Bibcode : 2009BpJ .... 97..674R . DOI : 10.1016 / j.bpj.2009.05.010 . PMC 2711326 . PMID 19619482 .
- ^ Thomas, G .; Ю. Уаббас; П. Гроссо; М. Барон; А. Чамаю; Л. Гале (2009). «Моделирование средних сил взаимодействия между силовыми частицами. Применение к смесям силикагеля и стеарата магния». Прикладная наука о поверхности . 255 (17): 7500–7507. Bibcode : 2009ApSS..255.7500T . CiteSeerX 10.1.1.591.1899 . DOI : 10.1016 / j.apsusc.2009.03.099 .
- ^ Риф, М; Gautel, M; Oesterhelt, F; Фернандес, Дж. М.; Гауб, HE (1997). «Обратимое разворачивание индивидуальных иммуноглобулиновых доменов титина с помощью АСМ». Наука . 276 (5315): 1109–1112. DOI : 10.1126 / science.276.5315.1109 . PMID 9148804 .
- ^ Петросян, Р. (2020). «Определение разворачивающей силы и единая модель зависимости средней разворачивающей силы от скорости нагружения» . J. Stat. Мех . +2020 (33201): 033201. DOI : 10,1088 / 1742-5468 / ab6a05 .
- ^ Сугимото, Y; Pou, P; Абэ, М; Елинек, П; Pérez, R; Морита, S; Custance, O (март 2007 г.). «Химическая идентификация отдельных поверхностных атомов с помощью атомно-силовой микроскопии». Природа . 446 (7131): 64–7. Bibcode : 2007Natur.446 ... 64S . CiteSeerX 10.1.1.552.6764 . DOI : 10,1038 / природа05530 . ISSN 0028-0836 . PMID 17330040 . S2CID 1331390 .
- ^ Брайант, П.Дж.; Миллер, Р.Г.; Yang, R .; «Совмещение сканирующей туннельной и атомно-силовой микроскопии». Applied Physics Letters , июнь 1988 г., том: 52, выпуск: 26, с. 2233–2235, ISSN 0003-6951 .
- ^ Оскар Х. Willemsen, Margot ME Snel, Алессандра Cambi, Ян Греве, Барт Г. Де Грота и Карл Г. Figdor «Биомолекулярная Взаимодействие Измеряется методом атомносиловой микроскопии» биофизической журнал , том 79, выпуск 6, декабрь 2000, Pages 3267- 3281.
- ↑ Ку-Хюн Чунг и Дэ-Ын Ким, «Износостойкость зонда атомно-силового микроскопа с алмазным покрытием». Ультрамикроскопия , том 108, выпуск 1, декабрь 2007 г., страницы 1–10
- ^ Сюй, Синь; Раман, Арвинд (2007). «Сравнительная динамика микрокантилеверов, приводимых в движение магнитным, акустическим и броуновским движением, в жидкостях». J. Appl. Phys. 102 (1): 014303–014303–7. Bibcode : 2007JAP ... 102a4303Y . DOI : 10.1063 / 1.2751415 .
- ^ Hasselbach, K .; Ладам, К. (2008). «Магнитная визуализация высокого разрешения: силовая микроскопия MicroSQUID». Журнал физики: Серия конференций . 97 (1): 012330. Bibcode : 2008JPhCS..97a2330H . DOI : 10.1088 / 1742-6596 / 97/1/012330 .
- ^ Вагнер, Кристиан; Грин, Мэтью Ф. Б.; Лейнен, Филипп; Дейлманн, Торстен; Крюгер, Питер; Рольфинг, Майкл; Темиров, Руслан; Тауц, Ф. Стефан (06.07.2015). «Сканирующая квантово-точечная микроскопия». Письма с физическим обзором . 115 (2): 026101. arXiv : 1503.07738 . Bibcode : 2015PhRvL.115b6101W . DOI : 10.1103 / PhysRevLett.115.026101 . ISSN 0031-9007 . PMID 26207484 .
- ^ Цицлер, Лотар; Гермингхаус, Стефан; Мугеле, Фридер (2002). «Капиллярные силы в режиме атомно-силовой микроскопии» . Phys. Rev. B . 66 (15): 155436. Bibcode : 2002PhRvB..66o5436Z . DOI : 10.1103 / PhysRevB.66.155436 .
- ↑ Чао Гао (1997). «Теория менисков и ее приложения». Письма по прикладной физике . 71 (13): 1801. Bibcode : 1997ApPhL..71.1801G . DOI : 10.1063 / 1.119403 .
- ^ Giessibl, Franz J. (1 января 1998). «Высокоскоростной датчик силы для силовой микроскопии и профилометрии с кварцевым камертоном» (PDF) . Письма по прикладной физике . 73 (26): 3956. Bibcode : 1998ApPhL..73.3956G . DOI : 10.1063 / 1.122948 .
- ^ Нисида, Шухей; Кобаяси, Дай; Сакурада, Такео; Накадзава, Томонори; Хоши, Ясуо; Кавакацу, Хидеки (1 января 2008 г.). «Фототермическое возбуждение и лазерная доплеровская велосиметрия высших мод колебаний кантилевера для динамической атомно-силовой микроскопии в жидкости». Обзор научных инструментов . 79 (12): 123703–123703–4. Bibcode : 2008RScI ... 79l3703N . DOI : 10.1063 / 1.3040500 . PMID 19123565 .
- ^ Rugar, D .; Mamin, HJ; Гетнер, П. (1 января 1989 г.). «Усовершенствованный волоконно-оптический интерферометр для атомно-силовой микроскопии». Письма по прикладной физике . 55 (25): 2588. Bibcode : 1989ApPhL..55.2588R . DOI : 10.1063 / 1.101987 .
- ^ Göddenhenrich, Т. (1990). «Силовой микроскоп с емкостным обнаружением смещения». Журнал вакуумной науки и техники А . 8 (1): 383. Bibcode : 1990JVSTA ... 8..383G . DOI : 10.1116 / 1.576401 .
- ^ Giessibl, FJ; Трафас, BM (1 января 1994 г.). «Пьезорезистивные кантилеверы для сканирующих туннельных и сканирующих силовых микроскопов в сверхвысоком вакууме» (PDF) . Обзор научных инструментов . 65 (6): 1923. Bibcode : 1994RScI ... 65.1923G . DOI : 10.1063 / 1.1145232 .
- ^ Binnig, G .; Смит, DPE (1986). «Однотрубный трехмерный сканер для сканирующей туннельной микроскопии». Обзор научных инструментов . 57 (8): 1688. Bibcode : 1986RScI ... 57.1688B . DOI : 10.1063 / 1.1139196 . ISSN 0034-6748 .
- ^ a b c Р. В. Лапшин (1995). «Аналитическая модель для аппроксимации петли гистерезиса и ее применение в сканирующем туннельном микроскопе» (PDF) . Обзор научных инструментов . 66 (9): 4718–4730. arXiv : 2006.02784 . Bibcode : 1995RScI ... 66.4718L . DOI : 10.1063 / 1.1145314 . ISSN 0034-6748 . S2CID 121671951 . ( Есть русский перевод ).
- ^ а б Лапшин Р.В. (2011). «Функциональная сканирующая зондовая микроскопия». В HS Nalwa (ред.). Энциклопедия нанонауки и нанотехнологий (PDF) . 14 . США: Американские научные издательства. С. 105–115. ISBN 978-1-58883-163-7.
- ↑ RV Lapshin (1998). «Автоматическая боковая калибровка сканеров туннельных микроскопов» (PDF) . Обзор научных инструментов . 69 (9): 3268–3276. Bibcode : 1998RScI ... 69.3268L . DOI : 10.1063 / 1.1149091 . ISSN 0034-6748 .
- ^ Ayache, Maurice; Люкс, Саймон Франц; Костецкий, Роберт (2015-04-02). "ИК-исследование границы раздела фаз твердого электролита на оловянном электроде в ближнем поле". Журнал писем по физической химии . 6 (7): 1126–1129. DOI : 10.1021 / acs.jpclett.5b00263 . ISSN 1948-7185 . PMID 26262960 .
- ^ Поллард, Бенджамин; Рашке, Маркус Б. (22 апреля 2016 г.). «Корреляционное инфракрасное наноспектроскопическое и наномеханическое отображение микродоменов блок-сополимера» . Бейльштейнский журнал нанотехнологий . 7 (1): 605–612. DOI : 10.3762 / bjnano.7.53 . ISSN 2190-4286 . PMC 4901903 . PMID 27335750 .
- ^ Huth, F .; Schnell, M .; Wittborn, J .; Ocelic, N .; Хилленбранд, Р. (2011). «Инфракрасно-спектроскопическое наноизображение с использованием источника тепла». Материалы природы . 10 (5): 352–356. Bibcode : 2011NatMa..10..352H . DOI : 10.1038 / nmat3006 . PMID 21499314 .
- ^ Bechtel, Hans A .; Мюллер, Эрик А.; Олмон, Роберт Л .; Мартин, Майкл С .; Рашке, Маркус Б. (20 мая 2014 г.). «Сверхширокополосная инфракрасная наноспектроскопическая визуализация» . Труды Национальной академии наук . 111 (20): 7191–7196. Bibcode : 2014PNAS..111.7191B . DOI : 10.1073 / pnas.1400502111 . ISSN 0027-8424 . PMC 4034206 . PMID 24803431 .
- ^ Paluszkiewicz, C .; Piergies, N .; Chaniecki, P .; Ренкас, М .; Miszczyk, J .; Квятек, ВМ (30 мая 2017 г.). «Дифференциация вторичной структуры белков в прозрачных и непрозрачных линзах человека: исследования AFM - IR». Журнал фармацевтического и биомедицинского анализа . 139 : 125–132. DOI : 10.1016 / j.jpba.2017.03.001 . PMID 28279927 . S2CID 21232169 .
- ^ a b c Р. В. Лапшин (2004). «Методология ориентированного на признаки сканирования для зондовой микроскопии и нанотехнологий» (PDF) . Нанотехнологии . 15 (9): 1135–1151. Bibcode : 2004Nanot..15.1135L . DOI : 10.1088 / 0957-4484 / 15/9/006 . ISSN 0957-4484 .
- ^ а б Лапшин Р.В. (2007). «Автоматическое устранение дрейфа в изображениях зондового микроскопа на основе методов встречного сканирования и распознавания элементов топографии» (PDF) . Измерительная наука и технология . 18 (3): 907–927. Bibcode : 2007MeScT..18..907L . DOI : 10.1088 / 0957-0233 / 18/3/046 . ISSN 0957-0233 .
- ^ а б Юров В.Ю.; Климов (1994). «Калибровка сканирующего туннельного микроскопа и восстановление реального изображения: устранение дрейфа и наклона» . Обзор научных инструментов . 65 (5): 1551–1557. Bibcode : 1994RScI ... 65.1551Y . DOI : 10.1063 / 1.1144890 . ISSN 0034-6748 . Архивировано из оригинального (PDF) 13 июля 2012 года.
- ^ Г. Шиттер; MJ Рост (2008). «Сканирующая зондовая микроскопия в видеоформате» . Материалы сегодня . 11 (специальный выпуск): 40–48. DOI : 10.1016 / S1369-7021 (09) 70006-9 . ISSN 1369-7021 .
- ^ Р. В. Лапшин; О.В. Объедков (1993). «Быстродействующий пьезоактюатор и цифровая обратная связь для сканирующих туннельных микроскопов» (PDF) . Обзор научных инструментов . 64 (10): 2883–2887. Bibcode : 1993RScI ... 64.2883L . DOI : 10.1063 / 1.1144377 . ISSN 0034-6748 .
- ^ Jong, Wim H De; Борм, Пол Дж. А. (июнь 2008 г.). «Доставка лекарств и наночастицы: применение и опасности» . Международный журнал наномедицины . 3 (2): 133–149. DOI : 10.2147 / ijn.s596 . PMC 2527668 . PMID 18686775 .
- ^ Pyrgiotakis Георгиос; Blattmann, Christoph O .; Демокриту, Филипп (10 июня 2014 г.). "Взаимодействие наночастиц и клеток в физиологических средах в реальном времени с помощью атомно-силовой микроскопии" . ACS Устойчивая химия и инженерия . 2 (Устойчивая нанотехнология, 2013 г.): 1681–1690. DOI : 10.1021 / sc500152g . PMC 4105194 . PMID 25068097 .
- ^ Эванс, Эван А .; Колдервуд, Дэвид А. (25 мая 2007 г.). «Силы и динамика связей в клеточной адгезии». Наука . 316 (5828): 1148–1153. Bibcode : 2007Sci ... 316.1148E . DOI : 10.1126 / science.1137592 . PMID 17525329 . S2CID 15109093 .
- ^ Шеуринг, Саймон; Леви, Даниэль; Риго, Жан-Луи (1 июля 2005 г.). «Наблюдая за компонентами». Biochimica et Biophysica Acta (BBA) - Биомембраны . 1712 (2): 109–127. DOI : 10.1016 / j.bbamem.2005.04.005 . PMID 15919049 .
- ^ Alsteens, Дэвид; Вербелен, Клэр; Даг, Этьен; Никак, Доминик; Baulard, Alain R .; Дюфрен, Ив Ф. (апрель 2008 г.). «Организация микобактериальной клеточной стенки: наноразмерный взгляд» . Pflügers Archiv: Европейский журнал физиологии . 456 (1): 117–125. DOI : 10.1007 / s00424-007-0386-0 . PMID 18043940 .
Дальнейшее чтение [ править ]
- Войтлендер, Берт (2019). Атомно-силовая микроскопия . Нанонаука и технологии. Springer. DOI : 10.1007 / 978-3-030-13654-3 . ISBN 978-3-030-13653-6. S2CID 199490753 .
- Карпик, Роберт В .; Салмерон, Микель (1997). «Царапая поверхность: фундаментальные исследования трибологии с помощью атомно-силовой микроскопии». Химические обзоры . 97 (4): 1163–1194. DOI : 10.1021 / cr960068q . ISSN 0009-2665 . PMID 11851446 .
- Гиссибль, Франц Дж. (2003). «Успехи атомно-силовой микроскопии». Обзоры современной физики . 75 (3): 949–983. arXiv : cond-mat / 0305119 . Bibcode : 2003RvMP ... 75..949G . DOI : 10.1103 / RevModPhys.75.949 . ISSN 0034-6861 . S2CID 18924292 .
- Гарсия, Рикардо; Knoll, Армин; Риедо, Элиза (2014). "Продвинутая сканирующая зондовая литография". Природа Нанотехнологии . 9 (8): 577–87. arXiv : 1505.01260 . Bibcode : 2014NatNa ... 9..577G . DOI : 10.1038 / NNANO.2014.157 . PMID 25091447 . S2CID 205450948 .
- Гарсия, Рикардо; Перес, Рубен (2002). «Методы динамической атомно-силовой микроскопии». Отчеты по науке о поверхности . 47 (6–8): 197–301. Bibcode : 2002SurSR..47..197G . DOI : 10.1016 / S0167-5729 (02) 00077-8 .
Внешние ссылки [ править ]
- Внутреннее устройство AFM - анимированное объяснение WeCanFigureThisOut.org
| Викискладе есть медиафайлы, связанные с атомно-силовой микроскопией . |
| В Викиучебнике есть книга на тему: Справочник по нанонауке и нанотехнологиям с открытым исходным кодом. |


![{\ displaystyle A \ simeq 2 \ pi R \ simeq [r_ {eff} (1+ \ cos \ theta) + h]}](https://wikimedia.org/api/rest_v1/media/math/render/svg/bdaec618f9921eea6a1fd6236e73ab4a6760bf83)




