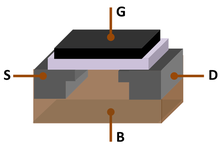 МОП-транзистор, показывающий клеммы затвора (G), корпуса (B), истока (S) и стока (D). Ворота отделены от корпуса изоляционным слоем (розового цвета). | |
| Принцип работы | Полупроводник |
|---|---|
| Изобретенный | 1959 г. |
| Первая продукция | 1960 г. |
| Конфигурация контактов | затвор (G), корпус (B), исток (S) и сток (D) |
Металл-оксид-полупроводник полевой транзистор ( МОП - транзистор , МОП - транзистор , или МОП - полевой транзистор ), также известный как металл-оксид-кремниевый транзистор ( МОП - транзистор или МОП ), [1] представляет собой тип с изолированным затвором полевой транзистор , который изготавливают с помощью контролируемого окисления в виде полупроводника , обычно кремния . Напряжение закрытого затвора определяет электропроводность устройства; эта способность изменять проводимость в зависимости от приложенного напряжения может быть использована дляусиление или переключение электронных сигналов .
МОП-транзистор был изобретен Мохамедом М. Аталлой и Давоном Кангом в Bell Labs в 1959 году и впервые представлен в 1960 году. Это основной строительный блок современной электроники и наиболее часто производимое устройство в истории, общая стоимость которого оценивается в 13 секстиллионов. (1,3 × 10 22 ) полевых МОП-транзисторов, изготовленных в период с 1960 по 2018 гг. [2] Это доминирующее полупроводниковое устройство в цифровых и аналоговых интегральных схемах (ИС) [3] и наиболее распространенное устройство питания . [4] Это компактный транзистор , который был миниатюризирован и серийно производился для широкого спектра применений , революционизировал электронную промышленность и мировую экономику и стал центральным элементом цифровой революции , эпохи кремния и информационного века.. Масштабирование и миниатюризация полевых МОП-транзисторов стимулировали быстрый экспоненциальный рост электронных полупроводниковых технологий с 1960-х годов и позволяют создавать ИС высокой плотности, такие как микросхемы памяти и микропроцессоры . MOSFET считается «рабочей лошадкой» электронной промышленности.
Ключевым преимуществом полевого МОП-транзистора является то, что он почти не требует входного тока для управления током нагрузки по сравнению с транзисторами с биполярным переходом (BJT). В полевом МОП-транзисторе в режиме улучшения напряжение, приложенное к выводу затвора, может увеличить проводимость из состояния «нормально выключено». В режиме истощения MOSFET напряжение, приложенное к затвору, может снизить проводимость от «нормально включенного» состояния. [5] MOSFET-транзисторы также обладают высокой масштабируемостью с увеличением миниатюризации и могут быть легко уменьшены до меньших размеров. Они также имеют более высокую скорость переключения (идеально для цифровых сигналов.), гораздо меньшего размера, потребляют значительно меньше энергии и обеспечивают гораздо более высокую плотность (идеально для крупномасштабной интеграции ) по сравнению с BJT. MOSFET-транзисторы также дешевле и имеют относительно простые этапы обработки, что приводит к высокому выходу продукции .
МОП-транзисторы могут быть изготовлены как часть интегральных схем МОП-транзисторов или как дискретные МОП-транзисторы (например, силовые МОП-транзисторы ) и могут иметь форму транзисторов с одним или несколькими затворами . Поскольку полевые МОП-транзисторы могут быть изготовлены из полупроводников p-типа или n-типа ( логика PMOS или NMOS соответственно), дополнительные пары полевых МОП-транзисторов могут использоваться для создания схем переключения с очень низким энергопотреблением : логика CMOS (дополнительная МОП).
Название «металл – оксид – полупроводник» (МОП) обычно относится к металлическому затвору , оксидной изоляции и полупроводнику (обычно кремнию). [1] Однако «металл» в названии MOSFET иногда используется неправильно, потому что материал затвора также может быть слоем поликремния (поликристаллического кремния). Наряду с оксидом можно использовать различные диэлектрические материалы с целью получения прочных каналов с меньшими приложенными напряжениями. МОП - конденсатор также является частью структуры МОП - транзистор.
Ранняя история [ править ]
Фон [ править ]
Основной принцип полевого транзистора (FET) был впервые предложен австрийским физиком Юлиусом Эдгаром Лилиенфельдом в 1926 году, когда он подал первый патент на полевой транзистор с изолированным затвором. [6] В течение следующих двух лет он описал различные структуры полевых транзисторов. В его конфигурации алюминий образовывал металл, а оксид алюминия - оксид, а сульфид меди использовался в качестве полупроводника . Однако построить практичный рабочий прибор ему так и не удалось. [7] Концепция полевого транзистора позже была выдвинута в теории немецким инженером Оскаром Хейлем в 1930-х годах и американским физиком Уильямом Шокли в 1940-х годах.[8] В то время не существовало работающего практического полевого транзистора, и ни одно из этих ранних предложений полевого транзистора не касалось термически окисленного кремния. [7]
Полупроводниковые компании первоначально сосредоточились на транзисторах с биполярным переходом (BJT) в первые годы полупроводниковой промышленности . Однако переходной транзистор был относительно громоздким устройством, которое было трудно производить в серийном производстве , что ограничивало его ряд специализированных применений. Полевые транзисторы теоретизировались как потенциальная альтернатива переходным транзисторам, но исследователи не смогли создать практические полевые транзисторы, в основном из-за проблемного барьера поверхностного состояния, который не позволял внешнему электрическому полю проникать в материал. [9] В 1950-х годах исследователи в значительной степени отказались от концепции полевого транзистора и вместо этого сосредоточились на технологии BJT. [10]
В 1955 году Карл Фрош и Линкольн Деррик случайно покрыли поверхность кремниевой пластины слоем диоксида кремния . При последующей экспериментальной характеристике этого оксидного слоя они обнаружили, что он блокирует проникновение определенных примесей в кремниевую пластину (несмотря на то, что разрешены другие), и тем самым обнаружили пассивирующий эффект поверхностного окисления.слой на этом полупроводнике. Их дальнейшая работа продемонстрировала вытравливание небольших отверстий в оксидном слое для диффузии легирующих добавок в точно контролируемые области кремниевой пластины. В 1957 году они опубликовали исследовательскую работу и запатентовали свою методику, обобщающую их работу. Разработанный ими метод известен как маскирование диффузии оксидов, которое позже будет использоваться при производстве полевых МОП-транзисторов. В Bell Labs сразу же осознали важность техники Фроша, поскольку оксиды кремния намного более стабильны, чем оксиды германия, имеют лучшие диэлектрические свойства и в то же время могут использоваться в качестве диффузионной маски. Результаты их работы распространились по Bell Labs в форме записок BTL до того, как были опубликованы в 1957 году. В Shockley Semiconductor.В декабре 1956 года Шокли разослал препринт своей статьи всем своим руководящим сотрудникам, включая Джин Хорни . [9] [11] [12]
Изобретение [ править ]
Мохамед М. Аталла из Bell Labs в конце 1950-х годов занимался проблемой поверхностных состояний. Он поднял работу Фроша на окисление, пытаясь пассивации поверхности из кремния через формирование оксидного слоя над ним. Он думал , что растет очень тонкий высокое качество термически выращенного Si O 2 на верхней части чистой кремниевой пластины нейтрализует поверхностные состояния достаточно , чтобы сделать практическое рабочее полевой транзистор. Он написал свои открытия в своих записках BTL в 1957 году, прежде чем представить свою работу на собрании Электрохимического общества в 1958 году. [13] [14] [15] [16] [8]Это было важным событием, которое позволило использовать технологию MOS и кремниевые интегральные схемы (IC). [17] В следующем году Джон Л. Молл описал МОП-конденсатор в Стэнфордском университете . [18] Сотрудникам Аталлы, Дж. Р. Лигенце и В. Г. Спитцеру, которые изучили механизм термически выращенных оксидов, удалось изготовить высококачественный пакет Si / SiO 2 , [7] с Аталлой и Кангом, использовавшими их результаты. [19] [20]
МОП - транзистор был изобретен , когда Мохамед Atalla и Давон Канг [14] [13] успешно изготовлен первое устройство рабочего полевого МОП - транзистора в ноябре 1959 г. [21] устройство покрыто двумя патентами, каждый из которых поданы отдельно от Atalla и Kahng в марте 1960 г. [ 22] [23] [24] [25] Они опубликовали свои результаты в июне 1960 года [26] на конференции по твердотельным устройствам, состоявшейся в Университете Карнеги-Меллона . [27] В том же году Аталла предложила использовать МОП-транзисторы для создания микросхем МОП-интегральных схем (МОП-ИС), отметив простоту изготовления МОП-транзисторов. [9]
Коммерциализация [ править ]
Преимущество полевого МОП-транзистора состояло в том, что он был относительно компактен и прост в массовом производстве по сравнению с конкурирующим транзистором с плоским переходом [28], но полевой МОП-транзистор представлял собой радикально новую технологию, внедрение которой потребовало бы отказа от прогресса, достигнутого Беллом. выполнен на биполярном переходном транзисторе (BJT). MOSFET также изначально был медленнее и менее надежен, чем BJT. [29]
В начале 1960-х годов программы исследования технологии МОП были созданы Fairchild Semiconductor , RCA Laboratories , General Microelectronics (во главе с бывшим инженером Fairchild Фрэнком Ванлассом ) и IBM . [30] В 1962 году Стив Р. Хофштейн и Фред П. Хейман из RCA создали первый чип интегральной схемы МОП . В следующем году они собрали все предыдущие работы по полевым транзисторам и представили теорию работы полевых транзисторов. [31] CMOS была разработана Chih-Tang Sah и Frank Wanlass в Fairchild в 1963 году. [32] Первая интегральная схема CMOS была позже построена в 1968 году.Альберт Медвин . [33]
Первое официальное публичное объявление о существовании MOSFET в качестве потенциальной технологии было сделано в 1963 году. Впервые он был коммерциализирован General Microelectronics в мае 1964 года, а затем Fairchild в октябре 1964 года. Первый контракт GMe на MOS был заключен с NASA , которое использовало MOSFET для космических кораблей и спутники в программе платформы межпланетного мониторинга (IMP) и программе Explorers . [30] Первые полевые МОП-транзисторы, продаваемые General Microelectronics и Fairchild, были устройствами с p-каналом ( PMOS ) для приложений логики и переключения. [8] К середине 1960-х RCAиспользовали полевые МОП-транзисторы в своих потребительских товарах, включая FM-радио , телевидение и усилители . [34] В 1967 году исследователи Bell Labs Роберт Кервин, Дональд Кляйн и Джон Сарас разработали МОП-транзистор с самовыравнивающимся затвором (кремниевым затвором), который исследователи Fairchild Федерико Фаггин и Том Кляйн адаптировали для интегральных схем в 1968 году [35].
MOS Revolution [ править ]
Разработка полевых МОП-транзисторов привела к революции в электронных технологиях, названной «революцией МОП-транзисторов» [36] или революцией «МОП-транзисторы» [37], которая способствовала технологическому и экономическому росту ранней полупроводниковой промышленности .
Влияние MOSFET стало коммерчески значимым с конца 1960-х годов. [38] Это привело к революции в электронной промышленности , которая с тех пор практически во всех отношениях повлияла на повседневную жизнь. [39] Изобретение полевого МОП-транзистора было названо рождением современной электроники [40] и сыграло центральную роль в революции микрокомпьютеров. [41]
Важность [ править ]
MOSFET составляет основу современной электроники [42] и является основным элементом большинства современного электронного оборудования . [43] Это самый распространенный транзистор в электронике, [13] и наиболее широко используемый полупроводниковый прибор в мире. [44] Он был описан как «рабочая лошадка электронной промышленности» [45] и «базовая технология» конца 20-го - начала 21-го веков. [10] Масштабирование и миниатюризация MOSFET (см. Список примеров шкалы полупроводников ) были основными факторами быстрого экспоненциального роста электронных полупроводников.Технология с 1960 года , [46] , как быстрое миниатюризация МОП - транзисторов был в значительной степени ответственен за увеличением плотности транзистора , повышение производительности и снижение потребляемой мощности от интегральной схемы чипов и электронных устройств , начиная с 1960 - х годов. [47]
МОП - транзисторы способны высокой масштабируемости ( закон Мура и Dennard масштабирования ), [48] с ростом миниатюризации , [49] и может быть легко уменьшено до меньших размеров. [50] Они потребляют значительно меньше энергии и имеют гораздо более высокую плотность, чем биполярные транзисторы. [51] Таким образом, полевые МОП-транзисторы имеют гораздо меньший размер, чем БЮТ [52] , [52] примерно в двадцатую часть размера к началу 1990-х годов. [52] МОП-транзисторы также имеют более высокую скорость переключения [4] с быстрым электронным переключением, что делает их идеальными для генерации последовательностей импульсов., [53] основа для цифровых сигналов . [54] [55] в отличие от BJT, которые более медленно генерируют аналоговые сигналы, напоминающие синусоидальные волны . [53] МОП-транзисторы также дешевле [56] и имеют относительно простые этапы обработки, что приводит к высокому выходу продукции . [50] МОП - транзисторы , таким образом , позволяют крупномасштабной интеграции (LSI), и идеально подходят для цифровых схем , [57] , а также линейные аналоговые схемы . [53]
МОП - транзистор по - разному описывается как наиболее важным транзистор , [3] , наиболее важное устройство в электронной промышленности, [58] , возможно, самые важное устройство в компьютерной индустрии , [59] один из самых важных событий в полупроводниковой технологии, [60] и, возможно, самое важное изобретение в электронике. [61] MOSFET - транзистор был основным строительным блоком современных цифровой электроники , [10] во время цифровой революции , [62] информационная революция , информационный век ,[63] и кремниевый возраст . [64] [65] МОП-транзисторы были движущей силой компьютерной революции и технологий, которые она сделала. [66] [67] [68] Быстрый прогресс электронной промышленности в конце 20-го - начале 21-го веков был достигнут за счет быстрого масштабирования полевых МОП-транзисторов ( масштабирование Деннарда и закон Мура ) до уровня наноэлектроники в начале 21-го века. [69] MOSFET произвел революцию в мире в век информации, благодаря своей высокой плотности, позволяющей компьютерусуществовать на нескольких небольших микросхемах IC, а не заполнять комнату [70], а позже сделать возможными цифровые коммуникационные технологии, такие как смартфоны . [66]
MOSFET - это наиболее широко производимое устройство в истории. [71] [72] Годовой объем продаж МОП-транзисторов на 2015 год составил 295 миллиардов долларов . [73] В период с 1960 по 2018 год было произведено 13 секстиллионов МОП-транзисторов, что составляет не менее 99,9% всех транзисторов. [71] Цифровые интегральные схемы, такие как микропроцессоры и устройства памяти, содержат от тысяч до миллиардов интегрированных полевых МОП-транзисторов на каждом устройстве, обеспечивая основные функции переключения, необходимые для реализации логических вентилей. и хранение данных. Существуют также устройства памяти , которые содержат , по меньшей мере триллион МОП - транзисторов, например, 256 Гб MicroSD карты памяти , большие , чем число звезд в Млечном Пути галактики . [45] По состоянию на 2010 г. принципы работы современных полевых МОП-транзисторов остались в основном такими же, как и у оригинальных полевых МОП-транзисторов, впервые продемонстрированных Мохамедом Аталлой и Давоном Кангом в 1960 г. [74] [75]
Управление по патентам и товарным знакам США называет MOSFET «революционным изобретением, которое изменило жизнь и культуру во всем мире» [66], а Музей компьютерной истории считает его «безвозвратным изменением человеческого опыта». [10] MOSFET также послужил основой для достижений, получивших Нобелевскую премию, таких как квантовый эффект Холла [76] и устройство с зарядовой связью (CCD), [77], хотя сам MOSFET никогда не присуждался Нобелевской премии. [78] В 2018 году записку о Джек Килби «s Нобелевской премии по физикеЧто касается его участия в изобретении интегральной схемы, Шведская королевская академия наук особо упомянула полевой МОП-транзистор и микропроцессор как другие важные изобретения в развитии микроэлектроники . [79] MOSFET также включен в список основных этапов развития электроники IEEE [80], а его изобретатели Мохамед Аталла и Давон Канг вошли в Национальный зал славы изобретателей в 2009 году. [13] [14]
Состав [ править ]
Обычно предпочтительным полупроводником является кремний . В последнее время некоторые производители микросхем, в первую очередь IBM и Intel , начали использовать химическое соединение кремния и германия ( SiGe ) в каналах MOSFET. К сожалению, многие полупроводники с лучшими электрическими свойствами, чем кремний, такие как арсенид галлия , не образуют хороших границ раздела полупроводник-изолятор и поэтому не подходят для полевых МОП-транзисторов. Исследования продолжаются [ когда? ] по созданию изоляторов с приемлемыми электрическими характеристиками на других полупроводниковых материалах.
Чтобы преодолеть увеличение потребления энергии из-за утечки тока затвора, вместо диоксида кремния в качестве изолятора затвора используется диэлектрик с высоким κ , а поликремний заменяется металлическими затворами (например, Intel , 2009 [81] ).
Затвор отделен от канала тонким изолирующим слоем, обычно из диоксида кремния, а затем из оксинитрида кремния . Некоторые компании начали внедрять комбинацию диэлектрика с высоким κ и металлического затвора в 45-нанометровом узле.
Когда между выводом затвора и корпуса прикладывается напряжение, генерируемое электрическое поле проникает через оксид и создает инверсионный слой или канал на границе полупроводник-изолятор, из-за чего эта часть становится менее p-типа и открывает путь для проводимости. тока, что приводит к увеличению напряжения между затвором и корпусом, которое отталкивает отверстия и создает слой неподвижных носителей, заряженных отрицательно. Инверсионный слой обеспечивает канал, по которому ток может проходить между выводами истока и стока. Изменение напряжения между затвором и корпусом модулирует проводимость этого слоя и, таким образом, регулирует ток между стоком и истоком. Это называется режимом улучшения.
Операция [ править ]
Структура металл – оксид – полупроводник [ править ]
Традиционная структура металл – оксид – полупроводник (МОП) получается путем выращивания слоя диоксида кремния ( SiO
2) поверх кремниевой подложки, обычно путем термического окисления и нанесения слоя металла или поликристаллического кремния (обычно используется последний). Поскольку диоксид кремния является диэлектрическим материалом, его структура эквивалентна плоскому конденсатору , в котором один из электродов заменен полупроводником .
Когда напряжение подается на МОП-структуру, оно изменяет распределение зарядов в полупроводнике. Если мы рассмотрим полупроводник p-типа (с плотностью акцепторов , p плотность дырок; p = N A в нейтральном объеме), положительное напряжение`` от затвора к телу (см. Рисунок) создает слой обеднения , заставляя положительно заряженные дырки от границы затвор-изолятор / полупроводник, оставляя открытой свободную от носителей область неподвижных отрицательно заряженных ионов-акцепторов (см. легирование (полупроводник) ). Если он достаточно высок, в инверсионном слое образуется высокая концентрация отрицательных носителей заряда. расположен в тонком слое рядом с границей раздела между полупроводником и диэлектриком.
Обычно напряжение затвора, при котором объемная плотность электронов в инверсионном слое совпадает с объемной плотностью дырок в теле, называется пороговым напряжением . Когда напряжение между затвором транзистора и истоком ( V GS ) превышает пороговое напряжение ( V th ), разница известна как напряжение перегрузки .
Эта структура с корпусом p-типа является основой полевого МОП-транзистора n-типа, который требует добавления областей истока и стока n-типа.
МОП-конденсаторы и диаграммы полос [ править ]
В этом разделе не процитировать любые источники . ( Январь 2019 г. ) ( Узнайте, как и когда удалить этот шаблон сообщения ) |
Конструкция МОП-конденсатора является сердцем МОП-транзистора. Рассмотрим МОП-конденсатор с кремниевой базой p-типа. Если на затвор приложено положительное напряжение, отверстия, которые находятся на поверхности подложки p-типа, будут отталкиваться электрическим полем, создаваемым приложенным напряжением. Сначала дырки будут просто отталкиваться, и то, что останется на поверхности, будет неподвижными (отрицательными) атомами акцепторного типа, что создаст на поверхности область обеднения. Помните, что дырка создается акцепторным атомом, например бором, у которого на один электрон меньше, чем у кремния. Можно спросить, как можно отразить дыры, если они на самом деле не являются сущностями? Ответ заключается в том, что на самом деле происходит не то, что дырка отталкивается, а электроны притягиваются положительным полем и заполняют эти дырки,создание обедненной области, где нет носителей заряда, потому что электрон теперь закреплен на атоме и неподвижен.
По мере увеличения напряжения на затворе будет точка, в которой поверхность над обедненной областью будет преобразована из p-типа в n-тип, поскольку электроны из основной области начнут притягиваться большим электрическим полем. Это известно как инверсия . Пороговое напряжение, при котором происходит это преобразование, является одним из наиболее важных параметров полевого МОП-транзистора.
В случае объема p-типа инверсия происходит, когда собственный уровень энергии на поверхности становится меньше уровня Фермина поверхности. Это видно из ленточной диаграммы. Помните, что уровень Ферми определяет тип обсуждаемого полупроводника. Если уровень Ферми равен внутреннему уровню, полупроводник является внутренним или чистым типом. Если уровень Ферми расположен ближе к зоне проводимости (валентной зоне), то полупроводник будет иметь n-тип (p-тип). Следовательно, когда напряжение затвора увеличивается в положительном смысле (для данного примера), это «искривляет» полосу собственных энергетических уровней, так что она будет изгибаться вниз по направлению к валентной зоне. Если уровень Ферми находится ближе к валентной зоне (для p-типа), наступит момент, когда собственный уровень начнет пересекать уровень Ферми, и когда напряжение достигнет порогового напряжения, собственный уровень действительно пересечет уровень Ферми. , и это то, что называется инверсией.В этот момент поверхность полупроводника превращается из p-типа в n-тип. Помните, что, как сказано выше, если уровень Ферми лежит выше собственного уровня, полупроводник относится к n-типу, поэтому при инверсии, когда собственный уровень достигает и пересекает уровень Ферми (который находится ближе к валентной зоне), полупроводник Тип меняется на поверхности, что диктуется относительным положением уровней Ферми и собственной энергии.Тип полупроводника изменяется на поверхности в зависимости от относительного положения уровней Ферми и собственной энергии.Тип полупроводника изменяется на поверхности в зависимости от относительного положения уровней Ферми и собственной энергии.
Структура и формирование каналов [ править ]
МОП-транзистор основан на модуляции концентрации заряда за счет МОП-емкости между основным электродом и электродом затвора, расположенным над корпусом и изолированным от всех других областей устройства диэлектрическим слоем затвора . Если используются диэлектрики, отличные от оксида, устройство может называться полевым транзистором металл-диэлектрик-полупроводник (MISFET). По сравнению с МОП-конденсатором, МОП-транзистор включает в себя два дополнительных вывода ( исток и сток).), каждая из которых связана с отдельными высоколегированными областями, которые разделены областью тела. Эти области могут быть как p-, так и n-типа, но обе должны быть одного и того же типа и противоположного типа по отношению к области тела. Исток и сток (в отличие от корпуса) сильно легированы, что обозначено знаком «+» после типа легирования.
Если МОП-транзистор является n-канальным или n-МОП-транзистором, то исток и сток являются n + областями, а тело - областью p . Если полевой МОП-транзистор является p-каналом или полевым МОП-транзистором, то исток и сток являются p + областями, а тело - n областью. Источник назван так потому, что он является источником носителей заряда (электроны для n-канала, дырки для p-канала), которые текут через канал; аналогично сток - это место, где носители заряда покидают канал.
Заселенность энергетических зон в полупроводнике определяется положением уровня Ферми относительно краев энергетических зон полупроводника.
При достаточном напряжении на затворе край валентной зоны отодвигается от уровня Ферми, а дырки от тела отводятся от затвора.
При еще большем смещении затвора вблизи поверхности полупроводника край зоны проводимости приближается к уровню Ферми, заполняя поверхность электронами в инверсионном слое или n-канале на границе раздела между p-областью и оксидом. Этот проводящий канал проходит между истоком и стоком, и ток проходит через него, когда между двумя электродами прикладывается напряжение. Увеличение напряжения на затворе приводит к более высокой плотности электронов в инверсионном слое и, следовательно, увеличивает ток между истоком и стоком. Для напряжений на затворе ниже порогового значения канал заполняется слабо, и между истоком и стоком может протекать только очень небольшой подпороговый ток утечки.
Когда прикладывается отрицательное напряжение затвор-исток, он создает p-канал на поверхности n-области, аналогично случаю n-канала, но с противоположными полярностями зарядов и напряжений. Когда напряжение менее отрицательное, чем пороговое значение (отрицательное напряжение для p-канала) применяется между затвором и истоком, канал исчезает, и только очень небольшой подпороговый ток может течь между истоком и стоком. Устройство может содержать кремний на изоляторе.устройство, в котором скрытый оксид образуется под тонким слоем полупроводника. Если область канала между диэлектриком затвора и скрытой оксидной областью очень тонкая, канал упоминается как сверхтонкая область канала с областями истока и стока, сформированными с обеих сторон в тонком полупроводниковом слое или над ним. Могут использоваться другие полупроводниковые материалы. Когда области истока и стока сформированы над каналом полностью или частично, они называются приподнятыми областями истока / стока.
| Параметр | nMOSFET | pMOSFET | |
|---|---|---|---|
| Тип источника / стока | n-тип | р-тип | |
| Тип канала (МОП-конденсатор) | n-тип | р-тип | |
Тип ворот | Поликремний | п + | р + |
| Металл | φ m ~ Si зона проводимости | φ m ~ Si валентная зона | |
| Тип колодца | р-тип | n-тип | |
| Пороговое напряжение, В th |
|
| |
| Гибка ленты | Вниз | Снизу вверх | |
| Носители инверсионного слоя | Электроны | Отверстия | |
| Тип субстрата | р-тип | n-тип | |
Режимы работы [ править ]
вверху слева: подпороговый, вверху справа: омический режим, внизу слева: активный режим в начале защемления, внизу справа: активный режим в самом начале защемления - модуляция длины канала очевидна
Работа полевого МОП-транзистора может быть разделена на три различных режима в зависимости от напряжений на клеммах. В следующем обсуждении используется упрощенная алгебраическая модель. [84] Характеристики современных полевых МОП-транзисторов сложнее, чем представленная здесь алгебраическая модель. [85]
Для n-канального полевого МОП-транзистора в режиме улучшения доступны три рабочих режима:
- Отсечка, подпороговый режим и режим слабой инверсии
Когда V GS < V th :
где - смещение затвор-исток, а - пороговое напряжение устройства.
Согласно базовой пороговой модели транзистор выключен, и между стоком и истоком нет проводимости. Более точная модель учитывает влияние тепловой энергии на распределение Ферми – Дирака по энергиям электронов, что позволяет некоторым из более энергичных электронов в источнике входить в канал и течь в сток. Это приводит к подпороговому току, который является экспоненциальной функцией напряжения затвор-исток. В то время как ток между стоком и истоком в идеале должен быть равен нулю, когда транзистор используется в качестве выключателя, существует слабый ток инверсии, иногда называемый подпороговой утечкой.
В слабой инверсии, когда источник привязан к объему, ток изменяется экспоненциально, как приблизительно определяется следующим образом: [86] [87]
где = ток при , тепловое напряжение и коэффициент наклона n определяются по формуле:
с = емкость обедненного слоя и = емкость оксидного слоя. Обычно используется это уравнение, но оно является лишь адекватным приближением для источника, привязанного к балке. Для источника, не привязанного к объему, подпороговое уравнение для тока стока при насыщении имеет вид [88] [89]
где - делитель канала, который определяется по формуле:
с = емкость обедненного слоя и = емкость оксидного слоя. В устройстве с длинным каналом отсутствует однократная зависимость тока от напряжения стока , но по мере уменьшения длины канала уменьшение барьера, вызванного стоком, приводит к зависимости напряжения стока, которая сложным образом зависит от геометрии устройства (например, легирование канала , легирование перехода и т. д.). Часто пороговое напряжение V th для этого режима определяется как напряжение затвора, при котором возникает выбранное значение тока I D0 , например, I D0 = 1 мкА, которое может отличаться от V th. -значение, используемое в уравнениях для следующих режимов.
Некоторые аналоговые схемы микромощностей предназначены для использования преимущества подпороговой проводимости. [90] [91] [92] Работая в области слабой инверсии, полевые МОП-транзисторы в этих схемах обеспечивают максимально возможное отношение крутизны к току, а именно: почти такое же, как у биполярного транзистора. [93]
Подпороговая ВАХ экспоненциально зависит от порогового напряжения, внося сильную зависимость от любых производственных изменений, которые влияют на пороговое напряжение; например: изменения толщины оксида, глубины перехода или легирования тела, которые изменяют степень снижения барьера, вызванного стоком. Возникающая в результате чувствительность к производственным изменениям усложняет оптимизацию утечек и производительности. [94] [95]
- Триодный режим или линейная область (также известный как омический режим [96] [97] )
Когда V GS > V th и V DS < V GS - V th :
Транзистор включается, и создается канал, пропускающий ток между стоком и истоком. МОП-транзистор работает как резистор, управляемый напряжением затвора относительно напряжений истока и стока. Ток от стока к истоку моделируется следующим образом:
где это носители заряда эффективной подвижность, ширина ворот, длина затвора и является ворота оксида емкости на единицу площади. Переход от экспоненциальной подпороговой области к триодной области не такой резкий, как предполагают уравнения.
- Насыщенность или активный режим [98] [99]
Когда V GS > V th и V DS ≥ (V GS - V th ):
Переключатель включен, и был создан канал, который пропускает ток между стоком и истоком. Поскольку напряжение стока выше, чем напряжение истока, электроны распространяются, и проводимость осуществляется не через узкий канал, а через более широкое, двумерное или трехмерное распределение тока, простирающееся от границы раздела и глубже в подложку. Начало этой области также известно как отсечение, чтобы указать на отсутствие области канала около стока. Хотя канал не распространяется на всю длину устройства, электрическое поле между стоком и каналом очень велико, и проводимость сохраняется. Ток стока теперь слабо зависит от напряжения стока и регулируется в основном напряжением затвор-исток и моделируется примерно как:
Дополнительный фактор, включающий λ, параметр модуляции длины канала, моделирует зависимость тока от напряжения стока из-за модуляции длины канала , что фактически аналогично эффекту Раннего, наблюдаемому в биполярных устройствах. Согласно этому уравнению, ключевым параметром конструкции крутизна полевого МОП-транзистора является:
где комбинация V ov = V GS - V th называется напряжением перегрузки , [100] и где V DSsat = V GS - V th учитывает небольшую неоднородность, которая в противном случае возникла бы при переходе между триодом и областью насыщения.
Другим ключевым параметром конструкции является выходное сопротивление полевого МОП-транзистора, определяемое как
- .
r out - это величина, обратная g DS, где . I D - это выражение в области насыщения.
Если принять λ равным нулю, результирующее бесконечное выходное сопротивление может упростить анализ схемы, однако это может привести к нереалистичным прогнозам схемы, особенно в аналоговых схемах.
Поскольку длина канала становится очень короткой, эти уравнения становятся неточными. Возникают новые физические эффекты. Например, перенос носителей в активном режиме может быть ограничен насыщением скорости . Когда преобладает насыщение по скорости, ток стока насыщения более близок к линейному, чем к квадратичному по V GS . На еще меньших длинах носители транспортируются с почти нулевым рассеянием, известным как квазибаллистический транспорт . В баллистическом режиме носители движутся со скоростью инжекции, которая может превышать скорость насыщения и приближается к скорости Ферми.при высокой плотности инверсионного заряда. Кроме того, снижение барьера, вызванного стоком, увеличивает ток отключения (отсечки) и требует увеличения порогового напряжения для компенсации, что, в свою очередь, снижает ток насыщения.
Эффект тела [ править ]
Заселенность энергетических зон в полупроводнике определяется положением уровня Ферми относительно краев энергетических зон полупроводника. Применение обратного смещения источник-подложка pn-перехода источник-тело вводит расщепление между уровнями Ферми для электронов и дырок, сдвигая уровень Ферми для канала дальше от края зоны, уменьшая заполненность канала. Эффект заключается в увеличении напряжения затвора, необходимого для установления канала, как показано на рисунке. Это изменение силы канала за счет применения обратного смещения называется «эффектом тела».
Проще говоря, используя пример nMOS, смещение затвор-тело V GB позиционирует энергетические уровни зоны проводимости, в то время как смещение источник-тело V SB размещает уровень Ферми электронов вблизи границы раздела, определяя занятость этих уровней вблизи интерфейс и, следовательно, сила инверсионного слоя или канала.
Влияние тела на канал можно описать с помощью модификации порогового напряжения, аппроксимируемого следующим уравнением:
- VTB = VT0, если VSB = 0, т. Е. Пороговое напряжение для замыкания клемм затвора и корпуса.
где V TB - это пороговое напряжение при наличии смещения подложки, V T0 - нулевое значение V SB порогового напряжения, - параметр эффекта тела, а 2 φ B - приблизительное падение потенциала между поверхностью и объемом на обедненном слое, когда V SB = 0 и смещения затвора достаточно, чтобы гарантировать наличие канала. [101] Как показывает это уравнение, обратное смещение V SB > 0 вызывает увеличение порогового напряжения V TB и, следовательно, требует большего напряжения затвора перед заполнением канала.
Тело может использоваться как вторые ворота, и иногда их называют «задними воротами»; Эффект тела иногда называют «эффектом заднего прохода». [102]
Обозначения схем [ править ]
Для полевого МОП-транзистора используются различные символы. Базовая конструкция обычно представляет собой линию для канала с истоком и стоком, оставляя его под прямым углом, а затем изгибаясь под прямым углом в том же направлении, что и канал. Иногда три линейных сегмента используются для режима улучшения и сплошная линия для режима истощения (см. Режимы истощения и улучшения ). Еще одна линия проводится параллельно каналу для ворот.
Основная часть или тело соединение, если показана, показано соединенный с задней стороной канала со стрелкой , указывающей PMOS или NMOS. Стрелки всегда указывают от P к N, поэтому NMOS (N-канал в P-лунке или P-субстрате) имеет стрелку, указывающую внутрь (от объема к каналу). Если основная часть подключена к источнику (как это обычно бывает с дискретными устройствами), она иногда наклоняется, чтобы встретиться с источником, выходящим из транзистора. Если основная часть не показана (как это часто бывает в конструкции ИС, поскольку они обычно являются общей массой), иногда используется символ инверсии для обозначения PMOS, в качестве альтернативы стрелка на источнике может использоваться таким же образом, как для биполярных транзисторов ( выход для nMOS, вход для pMOS).
Сравнение символов MOSFET режима улучшения и режима истощения, а также символов JFET . Ориентация символов (наиболее важно положение истока относительно стока) такова, что более положительные напряжения появляются выше на странице, чем менее положительные напряжения, подразумевая, что ток течет «вниз» по странице: [103] [104] [105 ]
| P-канал | |||||
|---|---|---|---|---|---|
| N-канал | |||||
| JFET | MOSFET enh. | MOSFET enh. (без пачки) | MOSFET Зав. | ||
На схемах, где G, S, D не обозначены, подробные характеристики символа указывают, какой терминал является истоком, а какой сток. Для символов MOSFET режима улучшения и режима истощения (во втором и пятом столбцах) терминал источника - это тот, который соединен со стрелкой. Кроме того, на этой диаграмме ворота показаны в форме буквы «L», входная ветвь которой ближе к S, чем к D, что также указывает на то, что есть что. Однако эти символы часто рисуются с Т-образным затвором (как и везде на этой странице), поэтому для обозначения терминала источника следует полагаться именно на наконечник стрелки.
Для символов, на которых изображен стержень или корпус, клемма, здесь показана внутренняя связь с источником (т. Е. Черная стрелка на диаграммах в столбцах 2 и 5). Это типичная конфигурация, но отнюдь не единственная важная конфигурация. В общем, полевой МОП-транзистор представляет собой четырехполюсное устройство, и в интегральных схемах многие из полевых МОП-транзисторов имеют общее соединение корпуса, не обязательно подключенное к клеммам истока всех транзисторов.
Типы полевых МОП-транзисторов [ править ]
Логика PMOS и NMOS [ править ]
Логика P-канала MOS (PMOS) использует полевые МОП - транзисторы с p-каналом для реализации логических вентилей и других цифровых схем . Логика N-канального MOS (NMOS) использует n-канальные MOSFET для реализации логических вентилей и других цифровых схем.
Для устройств с равным током возбуждения полевые МОП-транзисторы с n-каналом могут быть меньше, чем полевые МОП-транзисторы с p-каналом, поскольку носители заряда ( дырки ) с p-каналом имеют меньшую подвижность, чем носители заряда с n-каналом ( электроны ), и производят только один Тип MOSFET на кремниевой подложке дешевле и технически проще. Это были руководящие принципы при разработке логики NMOS, в которой используются исключительно n-канальные полевые МОП-транзисторы. Однако, в отличие от логики CMOS (без учета тока утечки ), логика NMOS потребляет энергию, даже если переключение не происходит.
Мохамед Аталла и Давон Канг первоначально продемонстрировали устройства pMOS и nMOS с длиной затвора 20 мкм, а затем 10 мкм в 1960 году. [15] [106] Их оригинальные устройства MOSFET также имели толщину оксида затвора 100 нм . [107] Однако устройства nMOS были непрактичными, и только устройства типа pMOS были практическими рабочими устройствами. [15] Несколько лет спустя был разработан более практичный процесс NMOS. Первоначально NMOS была быстрее, чем CMOS , поэтому в 1970-х годах NMOS более широко использовалась в компьютерах. [108] С развитием технологий логика CMOS вытеснила логику NMOS в середине 1980-х годов и стала предпочтительным процессом для цифровых микросхем.
Дополнительная МОП (CMOS) [ править ]
MOSFET используется в цифровой комплементарной логике металл-оксид-полупроводник ( CMOS ) [109], которая использует p- и n-канальные MOSFET в качестве строительных блоков. Перегрев является серьезной проблемой в интегральных схемах, поскольку все больше транзисторов упаковывается во все более мелкие микросхемы. Логика CMOS снижает энергопотребление, поскольку ток не течет (в идеале) и, следовательно, не потребляется никакая мощность , за исключением случаев, когда входы на логические элементыпереключаются. CMOS выполняет это снижение тока, дополняя каждый nMOSFET полевым pMOSFET и соединяя оба затвора и оба стока вместе. Высокое напряжение на затворах заставит nMOSFET проводить, а pMOSFET - не проводить, а низкое напряжение на затворах вызывает обратное. Во время переключения, когда напряжение переходит из одного состояния в другое, оба полевых МОП-транзистора будут работать на короткое время. Такое расположение значительно снижает потребление энергии и тепловыделение.
CMOS была разработана Chih-Tang Sah и Frank Wanlass в Fairchild Semiconductor в 1963 году. [32] CMOS потребляла меньше энергии, но изначально была медленнее, чем NMOS, которая более широко использовалась для компьютеров в 1970-х годах. В 1978 году Hitachi представила технологию CMOS с двумя лунками, которая позволила CMOS достичь производительности NMOS с меньшим энергопотреблением. Процесс двухъямной CMOS в конечном итоге обогнал NMOS как наиболее распространенный процесс производства полупроводников для компьютеров в 1980-х годах. [108] К 1970-1980-м годам логика CMOS потребляла в 7 раз меньше энергии, чем логика NMOS, [108]и примерно в 100000 раз меньше мощности, чем биполярная транзисторно-транзисторная логика (TTL). [110]
Режим истощения [ править ]
Существуют полевые МОП - транзисторы с режимом истощения , которые используются реже, чем уже описанные стандартные устройства с расширенным режимом . Это полевые МОП-транзисторы, которые легированы таким образом, что канал существует даже при нулевом напряжении от затвора до истока. Для управления каналом к затвору прикладывается отрицательное напряжение (для n-канального устройства), истощая канал, что уменьшает ток, протекающий через устройство. По сути, устройство режима истощения эквивалентно нормально замкнутому (включенному) переключателю, в то время как устройство расширенного режима эквивалентно нормально разомкнутому (выключенному) переключателю. [111]
Из-за низкого коэффициента шума в РЧ- диапазоне и лучшего усиления эти устройства часто предпочитают биполярным входам в РЧ-интерфейсах, например, в телевизорах .
Истощение режима MOSFET семейства включают BF960 по Siemens и Telefunken , и BF980 в 1980 году Philips (впоследствии NXP полупроводники ), производные которых все еще используются в АРУ и РЧ смесителя передних-концов.
Полевой транзистор металл – изолятор – полупроводник (MISFET) [ править ]
Полевой транзистор металл – изолятор – полупроводник [112] [113] [114] или MISFET - это более общий термин, чем MOSFET, и синоним полевого транзистора с изолированным затвором (IGFET). Все МОП-транзисторы являются МОП-транзисторами, но не все МОП-транзисторы являются МОП-транзисторами.
Диэлектрическим изолятором затвора в MISFET является диоксид кремния в MOSFET, но можно использовать и другие материалы. Диэлектрика затвора находится непосредственно ниже электрода затвора и над каналом на МДП - транзистора. Термин « металл» исторически используется для материала затвора, хотя сейчас это обычно высоколегированный поликремний или какой-либо другой неметалл .
Типы изоляторов могут быть:
- Диоксид кремния в полевых МОП-транзисторах
- Органические изоляторы (например, нелегированный транс- полиацетилен ; цианоэтил пуллулан , CEP [115] ) для полевых транзисторов на органической основе. [114]
МОП-транзистор с плавающим затвором (FGMOS) [ править ]
С плавающей затвора МОП - транзистора (FGMOS) представляет собой тип полевого МОП - транзистора , где затвор электрически изолированы, создавая плавающий узел в DC и ряд вторичных ворот или входов осаждаются над плавающим затвором (FG) и электрически изолированы от него. Первый отчет о MOSFET с плавающим затвором (FGMOS) был сделан Давоном Кангом (соавтором оригинального MOSFET) и Саймоном Мин Сзе в 1967 году. [116]
FGMOS обычно используется в качестве ячейки памяти с плавающим затвором , цифрового запоминающего элемента в EPROM , EEPROM и флэш-памяти . Другие применения FGMOS включают нейронный вычислительный элемент в нейронных сетях , аналоговый запоминающий элемент, цифровые потенциометры и однотранзисторные ЦАП .
Power MOSFET [ править ]
Силовые полевые МОП-транзисторы имеют другую структуру. [117] Как и у большинства силовых устройств, конструкция вертикальная, а не плоская. Используя вертикальную структуру, транзистор может выдерживать как высокое напряжение блокировки, так и большой ток. Номинальное напряжение транзистора является функцией легирования и толщины N- эпитаксиального слоя.слой (см. поперечное сечение), в то время как текущий рейтинг является функцией ширины канала (чем шире канал, тем выше ток). В планарной структуре номинальный ток и напряжение пробоя являются функцией размеров канала (соответственно ширины и длины канала), что приводит к неэффективному использованию «кремниевого комплекса». При вертикальной структуре площадь компонента примерно пропорциональна току, который он может выдерживать, а толщина компонента (фактически толщина N-эпитаксиального слоя) пропорциональна напряжению пробоя. [118]
Полевые МОП-транзисторы с боковой структурой в основном используются в высококачественных аудиоусилителях и мощных акустических системах. Их преимущество - лучшее поведение в насыщенной области (соответствующей линейной области биполярного транзистора ), чем у вертикальных полевых МОП-транзисторов. Вертикальные полевые МОП-транзисторы предназначены для коммутации приложений. [119]
Силовой полевой МОП-транзистор, который обычно используется в силовой электронике , был разработан в начале 1970-х годов. [120] Мощный полевой МОП-транзистор обеспечивает низкую мощность привода затвора, высокую скорость переключения и расширенные возможности параллельного подключения. [4]
Двойной диффузионный металл – оксид – полупроводник (DMOS) [ править ]
Существуют VDMOS (вертикальный металлооксидный полупроводник с двойной диффузией ) и LDMOS (боковой металлооксидный полупроводник с двойной диффузией ). Большинство мощных полевых МОП-транзисторов изготавливаются с использованием этой технологии.
МОП-конденсатор [ править ]
Конденсатор MOS является частью структуры MOSFET, где конденсатор MOS окружен двумя pn переходами . [121] МОП-конденсатор широко используется в качестве накопительного конденсатора в микросхемах памяти и в качестве основного строительного блока устройства с зарядовой связью (ПЗС) в технологии датчиков изображения . [122] В DRAM (динамической памяти с произвольным доступом ) каждая ячейка памяти обычно состоит из полевого МОП-транзистора и МОП-конденсатора. [123]
Тонкопленочный транзистор (TFT) [ править ]
Тонкопленочный транзистор (TFT) , представляет собой тип полевого МОП - транзистора отличается от стандартного объемного МОП - транзистора. [124] Первый TFT был изобретен Полом К. Веймером в RCA в 1962 году, основываясь на более ранней работе Аталлы и Канга по полевым МОП-транзисторам. [125]
Идея жидкокристаллического дисплея (LCD) на основе TFT была придумана Бернардом Лехнером из RCA Laboratories в 1968 году. [126] Лехнер, Ф. Дж. Марлоу, Э. О. Нестер и Дж. Талтс продемонстрировали концепцию в 1968 году с помощью матричного динамического рассеяния 18x2. ЖК-дисплей, в котором использовались стандартные дискретные полевые МОП-транзисторы, поскольку в то время производительность TFT была недостаточной. [127]
Биполярно-МОП транзисторы [ править ]
BiCMOS - это интегральная схема , объединяющая транзисторы BJT и CMOS на одном кристалле. [128]
Биполярный транзистор с изолированным затвором (IGBT) представляет собой мощный транзистор с характеристиками как на МОП - транзистора и биполярный плоскостной транзистор (BJT). [129]
Датчики MOS [ править ]
Был разработан ряд датчиков MOSFET для измерения физических , химических , биологических параметров и параметров окружающей среды . [130] Наиболее ранние датчики MOSFET включают открытый затвор полевого транзистора (OGFET) , введенный Johannessen в 1970 году, [130] ион-чувствительный полевой транзистор (ИСПТ) , изобретенный Пита Bergveld в 1970 году, [131] на адсорбционную FET ( ADFET), запатентованный PF Cox в 1974 году, и чувствительный к водороду MOSFET, продемонстрированный И. Лундстромом, М.С. Шивараманом, С.С. Свенсоном и Л. Лундквистом в 1975 году.[130] ISFET - это особый тип полевого МОП-транзистора с затвором на определенном расстоянии [130], в котором металлический затвор заменен ионно- чувствительной мембраной ,раствором электролита и электродом сравнения . [132]
К середине 1980-х годов было разработано множество других датчиков MOSFET, включая полевой транзистор газового датчика (GASFET), полевой транзистор с поверхностным доступом (SAFET), транзистор потока заряда (CFT), датчик давления FET (PRESSFET), химический полевой транзистор ( ChemFET), эталонный ISFET (REFET), биосенсорный полевой транзистор (BioFET), ферментно-модифицированный полевой транзистор (ENFET) и иммунологически модифицированный полевой транзистор (IMFET). [130] В начале 2000 - х лет, типы BioFET , такие как ДНК - полевой транзистор (DNAFET), ген-модифицированный полевые транзисторы (GenFET) и клеточный потенциал были разработаны BioFET (CPFET). [132]
В технологии цифровых изображений используются два основных типа датчиков изображения : устройство с зарядовой связью (ПЗС) и датчик с активными пикселями (датчик КМОП). И ПЗС, и КМОП-сенсоры основаны на технологии МОП, при этом ПЗС-матрица основана на МОП-конденсаторах, а КМОП-сенсор - на МОП-транзисторах. [77]
Полевой транзистор с несколькими затворами (MuGFET) [ править ]
Двойной затвор МОП - транзистор ( два правительства) имеет Тетрод конфигурацию, в которой оба воротах контролировать ток в устройстве. Он обычно используется для малосигнальных устройств в радиочастотных приложениях, где смещение затвора на стороне стока при постоянном потенциале снижает потери усиления, вызванные эффектом Миллера , заменяя два отдельных транзистора в каскодной конфигурации. Другие распространенные применения в радиочастотных схемах включают регулировку усиления и смешение (преобразование частоты). Описание тетрода , хотя и точное, не повторяет тетрод на электронных лампах. Тетроды на электронных лампах, в которых используется экранная сетка, демонстрируют гораздо более низкую емкость сетки и гораздо более высокие выходное сопротивление и коэффициент усиления по напряжению, чем триодные вакуумные лампы.. Эти улучшения обычно на порядок (в 10 раз) или значительно больше. Тетродные транзисторы (будь то биполярные переходные или полевые) не демонстрируют таких значительных улучшений.
FinFET является двойным затвором кремния на изоляторе устройство, один из множества геометрических форм вводятся для уменьшения влияния коротких каналов и уменьшить сток-индуцированный барьер опускания. Плавника относится к узкому каналу между истоком и стоком. Тонкий изолирующий оксидный слой с обеих сторон ребра отделяет его от затвора. КНИТЕ FinFETs с толстым оксидом на верхней части ребер называется двойным затвором , и те , с тонким оксидом на вершине, а также по бокам называются тройным затвор FinFETs. [133] [134]
С двойным затвором полевой МОП - транзистор был впервые продемонстрирован в 1984 году электротехнической лаборатории исследователей Тосихиро Sekigawa и Yutaka Hayashi. [135] [136] GAAFET (затвор-все вокруг полевого МОП - транзистора), тип мульти-затвора неплоской 3D транзистора , была впервые продемонстрирована в 1988 году Toshiba исследовательской группы , включая Фьюджио Масуока , Х. Takato и К. Sunouchi . [137] [138] FinFET (плавник полевой транзистор), тип 3D неплоской двойным затвором полевого МОП - транзистора, возникла из исследования DIGH Hisamoto и его командой в Центральной научно - исследовательской лаборатории Hitachiв 1989 году. [139] [140] Разработка многозатворных полевых МОП-транзисторов на основе нанопроволок с тех пор стала фундаментальной для наноэлектроники . [141]
Квантовый полевой транзистор (QFET) [ править ]
Квантовой полевой транзистор (QFET) или квантовой ямы полевой транзистор (QWFET) представляет собой тип полевого МОП - транзистора [142] [143] [144] , что имеет преимущество квантового туннелирования , чтобы значительно увеличить скорость работы транзистора. [145]
Радиационно-стойкая-конструктивная (RHBD) [ править ]
Полупроводниковые электронные схемы субмикрометрового и нанометрового размеров являются первоочередной задачей для работы в пределах нормальных допусков в суровых радиационных средах, таких как космическое пространство . Один из конструктивных подходов к изготовлению радиационно-стойких конструкций.(RHBD) устройство на закрытых транзисторах (ELT). Обычно затвор полевого МОП-транзистора окружает сток, расположенный в центре ELT. Источник полевого МОП-транзистора окружает затвор. Другой RHBD MOSFET называется H-Gate. Оба этих транзистора имеют очень низкий ток утечки по отношению к излучению. Однако они имеют большие размеры и занимают больше места на кремнии, чем стандартный полевой МОП-транзистор. В более старых конструкциях STI (изоляция из неглубоких канавок) радиационные удары вблизи области оксида кремния вызывают инверсию каналов в углах стандартного полевого МОП-транзистора из-за накопления радиационно-индуцированных захваченных зарядов. Если заряды достаточно велики, накопленные заряды воздействуют на края поверхности STI вдоль канала около интерфейса канала (затвора) стандартного полевого МОП-транзистора.Таким образом, инверсия канала устройства происходит по краям канала, и устройство создает путь утечки в закрытом состоянии, вызывая включение устройства. Таким образом, надежность цепей сильно ухудшается. ELT предлагает множество преимуществ. Эти преимущества включают улучшениенадежность за счет уменьшения нежелательной инверсии поверхности на краях затвора, которая возникает в стандартном полевом МОП-транзисторе. Поскольку края затвора заключены в ELT, нет края оксида затвора (STI на интерфейсе затвора), и, таким образом, утечка в закрытом состоянии транзистора значительно снижается. Микроэлектронные схемы малой мощности, включая компьютеры, устройства связи и системы мониторинга в космических челноках и спутниках, сильно отличаются от того, что используется на Земле. Они требуют излучения (высокоскоростные атомные частицы, такие как протон и нейтрон , рассеивание магнитной энергии солнечной вспышки в космическом пространстве Земли, энергетические космические лучи, такие как рентгеновские лучи , гамма-лучи.и т. д.) толерантные схемы. Эта специальная электроника разработана с применением различных методов с использованием полевых МОП-транзисторов с RHBD для обеспечения более безопасных путешествий и выходов в открытый космос для космонавтов.
Приложения [ править ]
МОП - транзистор обычно образует основу современной электроники , [42] в качестве доминирующего транзистора в цифровых схемах , а также аналоговых интегральных схем . [3] Это основа для множества современных технологий, [146] и обычно используется для широкого круга приложений. [47] Согласно Жан-Пьеру Колинджу, многие современные технологии не существовали бы без MOSFET, например, современная компьютерная промышленность , цифровые телекоммуникационные системы, видеоигры , карманные калькуляторы и цифровые наручные часы . [146]
Дискретные полевые МОП-транзисторы широко используются в таких приложениях, как импульсные источники питания , частотно-регулируемые приводы и другие приложения силовой электроники, где каждое устройство может переключать тысячи ватт. Радиочастотные усилители вплоть до диапазона УВЧ используют полевые МОП-транзисторы в качестве аналоговых сигналов и усилителей мощности. Радиосистемы также используют полевые МОП-транзисторы в качестве генераторов или смесителей для преобразования частот. Устройства MOSFET также применяются в усилителях мощности звуковой частоты для систем оповещения, звукоусиления, домашних и автомобильных звуковых систем. [ необходима цитата ]
МОП-транзисторы в интегральных схемах являются основными элементами компьютерных процессоров , полупроводниковой памяти , датчиков изображения и большинства других типов интегральных схем.
MOS интегральная схема (MOS IC) [ править ]
MOSFET - это наиболее широко используемый тип транзистора и наиболее важный компонент устройства в микросхемах (ИС). [147] монолитной интегральной схемы чип был включен по пассивации поверхности процесса, который электрически стабилизированной кремниевых поверхностей с помощью термического окисления , что делает возможным изготовить монолитные интегральные микросхемы схемы с использованием кремния. Процесс поверхностной пассивации был разработан Мохамедом М. Аталлой в Bell Labs в 1957 году. Это было основой для планарного процесса , разработанного Джин Хорни вFairchild Semiconductor в начале 1959 года, что сыграло решающую роль в изобретении монолитной интегральной схемы Робертом Нойсом позже в 1959 году. [148] [149] [17] В том же году [8] Аталла использовал свой процесс пассивации поверхности для изобретения MOSFET с Давоном Кангом в Bell Labs. [14] [13] За этим последовало развитие чистых помещений для снижения загрязнения до уровней, которые ранее никогда не считались необходимыми, и совпало с развитием фотолитографии [150], которая, наряду с пассивацией поверхности и планарным процессом, позволила схемам быть сделано в несколько шагов.
Мохамед Аталла впервые предложил концепцию микросхемы МОП-интегральной схемы (МОП-ИС) в 1960 году, отметив, что простота изготовления МОП-транзистора сделала его полезным для интегральных схем. [9] В отличие от биполярных транзисторов, которые требовали ряда шагов для изоляции p – n перехода транзисторов на кристалле, полевые МОП-транзисторы не требовали таких шагов, но их можно было легко изолировать друг от друга. [29] Его преимущество для интегральных схем было повторно итерация по Давону Канга в 1961 г. [21] Si - SiO 2Система обладала техническими достоинствами: низкой стоимостью производства (в расчете на схему) и простотой интеграции. Эти два фактора, наряду с его быстро масштабируемой миниатюризацией и низким потреблением энергии , привели к тому, что MOSFET стал наиболее широко используемым типом транзисторов в микросхемах IC.
Самой ранней экспериментальной МОП ИС, которая была продемонстрирована, была микросхема с 16 транзисторами, построенная Фредом Хейманом и Стивеном Хофштейном на RCA в 1962 году. [56] General Microelectronics позже представила первые коммерческие МОП интегральные схемы в 1964 году, состоящие из 120 p-канальных транзисторов. [151] Это был 20-битный регистр сдвига , разработанный Робертом Норманом [56] и Фрэнком Ванлассом . [152] В 1968 году исследователи Fairchild Semiconductor Федерико Фаггин и Том Кляйн разработали первую МОП-микросхему с кремниевым затвором . [35]
MOS крупномасштабная интеграция (MOS LSI) [ править ]
Благодаря высокой масштабируемостью , [48] и гораздо более низкое энергопотреблением и более высокой плотностью , чем биполярные транзисторы, [51] МОП - транзистор сделал возможное создание высокой плотности интегральных микросхем. [1] К 1964 году MOS-чипы достигли более высокой плотности транзисторов и более низких производственных затрат, чем биполярные чипы. Микросхемы МОП усложнялись со скоростью, предсказываемой законом Мура , что привело к крупномасштабной интеграции (БИС) с сотнями полевых МОП-транзисторов на кристалле к концу 1960-х годов. [153] Технология MOS позволила к началу 1970-х годов интегрировать более 10 000 транзисторов на одном кристалле LSI.[154] перед тем, как позже разрешить очень крупномасштабную интеграцию (СБИС). [50] [155]
Микропроцессоры [ править ]
МОП - транзистор является основой каждого микропроцессора , [45] и был ответственен за изобретение микропроцессора. [156] Истоки как микропроцессора, так и микроконтроллера можно проследить до изобретения и развития технологии МОП. Применение микросхем MOS LSI в вычислениях послужило основой для первых микропроцессоров, поскольку инженеры начали осознавать, что полный компьютерный процессор может содержаться в одном кристалле MOS LSI. [153]
Самые ранние микропроцессоры были полностью MOS-микросхемами, построенными на схемах MOS LSI. Первые многочиповые микропроцессоры, Four-Phase Systems AL1 в 1969 году и Garrett AiResearch MP944 в 1970 году, были разработаны с использованием нескольких микросхем MOS LSI. Первый коммерческий однокристальный микропроцессор, Intel 4004 , был разработан Федерико Фаггин с использованием его технологии МОП-микросхемы с кремниевым затвором, совместно с инженерами Intel Марцианом Хоффом и Стэном Мазором , а также инженером Busicom Масатоши Шима . [157] С появлением CMOSМикропроцессоры В 1975 году термин «микропроцессоры MOS» стал обозначать микросхемы, полностью изготовленные из логики PMOS или полностью изготовленные из логики NMOS , в отличие от «микропроцессоров CMOS» и «биполярных процессоров с срезами бит ». [158]
Схемы CMOS [ править ]
Цифровой [ править ]
Развитие цифровых технологий, таких как микропроцессоры , послужило стимулом для развития технологии MOSFET быстрее, чем любой другой тип кремниевых транзисторов. [159] Большим преимуществом полевых МОП-транзисторов для цифровой коммутации является то, что оксидный слой между затвором и каналом предотвращает протекание постоянного тока через затвор, дополнительно снижая потребляемую мощность и обеспечивая очень большой входной импеданс. Изолирующий оксид между затвором и каналом эффективно изолирует MOSFET в одном логическом каскаде от более ранних и более поздних каскадов, что позволяет одному выходу MOSFET управлять значительным количеством входов MOSFET. Логика на основе биполярных транзисторов (например, TTL) не имеет такой большой емкости разветвления. Эта изоляция также позволяет разработчикам в некоторой степени независимо игнорировать эффекты нагрузки между этапами логики. Эта степень определяется рабочей частотой: по мере увеличения частоты входное сопротивление полевых МОП-транзисторов уменьшается.
Аналог [ править ]
Преимущества полевого МОП-транзистора в цифровых схемах не выражаются в превосходстве во всех аналоговых схемах . Эти два типа схем основаны на различных особенностях поведения транзисторов. Цифровые схемы переключаются, проводя большую часть своего времени либо полностью включенными, либо полностью выключенными. Переход от одного к другому касается только скорости и требуемой зарядки. Аналоговые схемы зависят от работы в переходной области, где небольшие изменения V gs могут модулировать выходной (сток) ток. JFET и биполярный переходной транзистор (BJT) предпочтительны для точного согласования (соседних устройств в интегральных схемах), более высокой крутизныи определенные температурные характеристики, которые упрощают сохранение прогнозируемой производительности при изменении температуры контура.
Тем не менее, полевые МОП-транзисторы широко используются во многих типах аналоговых схем из-за их собственных преимуществ (нулевой ток затвора, высокий и регулируемый выходной импеданс и повышенная надежность по сравнению с биполярными транзисторами, которые могут быть необратимо ухудшены даже при небольшом разрушении базы эмиттера). [ расплывчато ] Характеристики и производительность многих аналоговых схем можно увеличивать или уменьшать, изменяя размеры (длину и ширину) используемых полевых МОП-транзисторов. Для сравнения, в биполярных транзисторах размер устройства существенно не влияет на его производительность. [ необходима цитата ] Идеальные характеристики полевых МОП-транзисторов относительно тока затвора (ноль) и напряжения смещения сток-исток (ноль) также делают их почти идеальными переключающими элементами, а также делаюткоммутируемые конденсаторные аналоговые схемы практичны. В своей линейной области полевые МОП-транзисторы могут использоваться в качестве прецизионных резисторов, которые могут иметь гораздо более высокое контролируемое сопротивление, чем биполярные транзисторы. В схемах большой мощности MOSFET иногда имеют то преимущество, что не страдают от теплового разгона, как BJT. [ сомнительно ] Кроме того, полевые МОП-транзисторы могут быть сконфигурированы для работы в качестве конденсаторов и цепей гиратора.которые позволяют операционным усилителям, сделанным из них, выступать в качестве катушек индуктивности, тем самым позволяя полностью построить все обычные аналоговые устройства на кристалле (за исключением диодов, которые в любом случае могут быть меньше, чем MOSFET). Это означает, что полные аналоговые схемы могут быть изготовлены на кремниевом кристалле в гораздо меньшем пространстве и с использованием более простых технологий изготовления. МОП-транзисторы идеально подходят для переключения индуктивных нагрузок из-за устойчивости к индуктивной отдаче.
Некоторые ИС объединяют аналоговую и цифровую схемы полевых МОП-транзисторов в одной интегральной схеме со смешанными сигналами , что делает необходимое пространство на плате еще меньше. Это создает необходимость изолировать аналоговые схемы от цифровых на уровне микросхемы, что приводит к использованию изоляционных колец и кремния на изоляторе (SOI). Поскольку MOSFET требует больше места для обработки заданного количества энергии, чем BJT, процессы изготовления могут включать BJT и MOSFET в одно устройство. Устройства со смешанными транзисторами называются bi-FET (биполярными полевыми транзисторами), если они содержат только один BJT-FET, и BiCMOS (биполярно-CMOS), если они содержат дополнительные BJT-FET. Такие устройства имеют преимущества как изолированных вентилей, так и более высокой плотности тока.
В конце 1980-х Асад Абиди первым изобрел технологию RF CMOS , которая использует схемы MOS VLSI , работая в UCLA . Это изменило способ проектирования ВЧ-схем , от дискретных биполярных транзисторов к интегральным схемам КМОП. С 2008 года радиоприемопередатчики во всех беспроводных сетевых устройствах и современных мобильных телефонах массово производятся как устройства RF CMOS. RF CMOS также используется почти во всех современных устройствах Bluetooth и беспроводной локальной сети (WLAN). [160]
MOS-память [ править ]
Появление полевого МОП-транзистора позволило на практике использовать МОП-транзисторы в качестве элементов хранения ячеек памяти - функцию, ранее выполняемую магнитными сердечниками в компьютерной памяти . [161] Первая современная компьютерная память была представлена в 1965 году, когда Джон Шмидт из Fairchild Semiconductor разработал первую полупроводниковую МОП- память , 64-битную МОП- память (статическая память с произвольным доступом ). [162] SRAM стала альтернативой памяти с магнитным сердечником , но для каждого бита данных требовалось шесть МОП-транзисторов . [163]
Технология MOS является основой DRAM (динамической памяти с произвольным доступом ). В 1966 году доктор Роберт Х. Деннард из исследовательского центра IBM Thomas J. Watson работал над MOS-памятью . Изучая характеристики технологии МОП, он обнаружил, что она способна создавать конденсаторы , и что сохранение заряда или отсутствие заряда на МОП-конденсаторе может представлять 1 и 0 бита, в то время как МОП-транзистор может управлять записью заряда в конденсатор. Это привело к его разработке ячейки памяти DRAM с одним транзистором. [163]В 1967 году Деннард подал в IBM патент на ячейку памяти DRAM с одним транзистором (динамическая память с произвольным доступом), основанная на технологии MOS. [164] MOS-память обеспечивала более высокую производительность, была дешевле и потребляла меньше энергии, чем память с магнитным сердечником , что привело к тому, что MOS-память обогнала память с магнитным сердечником в качестве доминирующей технологии компьютерной памяти к началу 1970-х годов. [165]
Фрэнк Ванласс , изучая структуры MOSFET в 1963 году, заметил движение заряда через оксид на затвор . Хотя он этого и не добился, эта идея позже стала основой для технологии EPROM (стираемая программируемая постоянная память ). [166] В 1967 году Давон Кан и Саймон Мин Сзе предложили использовать ячейки памяти с плавающим затвором , состоящие из полевых МОП-транзисторов с плавающим затвором (FGMOS), для создания перепрограммируемого ПЗУ ( постоянное запоминающее устройство ). [167] Ячейки памяти с плавающей запятой позже стали основой дляТехнологии энергонезависимой памяти (NVM), включая EPROM, EEPROM (электрически стираемое программируемое ПЗУ) и флэш-память . [168]
Бытовая электроника [ править ]
МОП-транзисторы широко используются в бытовой электронике . Один из самых ранних влиятельных потребительских электронных продуктов с поддержкой схемами MOS БИС был электронный карманный калькулятор , [154] , как технология MOS LSI позволила большое количество вычислительных возможностей в небольших упаковках. [169] В 1965 году настольный калькулятор Victor 3900 был первым МОП- калькулятором с 29 МОП-микросхемами. [170] В 1967 году Texas Instruments Cal-Tech был первым прототипом портативного электронного калькулятора с тремя микросхемами MOS LSI, а позже был выпущен как Canon.Pocketronic в 1970 году [171] Sharp QT-8D настольный калькулятор был первым массового производства БИС МОП - калькулятор в 1969 году, [172] и Sharp EL-8 , которые используются четыре МОП LSI чипов был первым коммерческим электронным ручной калькулятор в 1970 году . [171] Первым настоящим карманным калькулятором был Busicom LE-120A HANDY LE, в котором использовался единственный калькулятор MOS LSI на кристалле от Mostek , и он был выпущен в 1971 году. [171] К 1972 году схемы MOS LSI были коммерциализированы для множества других приложений. [173]
MOSFETs имеет основополагающее значение для информационных и коммуникационных технологий (ИКТ), [66] [79] в том числе современных компьютеров , [174] [146] [155] современные вычисления , [175] телекоммуникация , то инфраструктура связи , [174] [176] в Интернет , [174] [72] [177] цифровая телефония , [178] беспроводная связь, [179] [180] и мобильные сети . [180]По словам Колинджа, современная компьютерная промышленность и цифровые телекоммуникационные системы не существовали бы без полевого МОП-транзистора. [146] Достижения в технологии MOS явились наиболее важным фактором быстрого роста пропускной способности сети в телекоммуникационных сетях , при этом пропускная способность удваивается каждые 18 месяцев, с бит в секунду до терабит в секунду ( закон Эдхольма ). [181]
Датчики MOS [ править ]
Датчики MOS , также известные как датчики MOSFET, широко используются для измерения физических , химических , биологических параметров и параметров окружающей среды . [130] ион-чувствительный полевой транзистор (ИСПТ), например, широко используется в биомедицинских применений. [132] МОП- хеморезисторы и полевые МОП-транзисторы также были широко продемонстрированы как многообещающие области применения для измерения газа либо в качестве отдельных сенсорных устройств, либо в качестве компонентов в массивах химических сенсоров . [182]
МОП-транзисторы также широко используются в микроэлектромеханических системах (МЭМС), поскольку кремниевые МОП-транзисторы могут взаимодействовать и взаимодействовать с окружающей средой и обрабатывать такие вещи, как химические вещества , движения и свет . [183] Ранним примером устройства MEMS является транзистор с резонансным затвором, адаптация полевого МОП-транзистора, разработанный Харви К. Натансоном в 1965 году. [184]
Технология MOS является основой для современных датчиков изображения , включая устройство с зарядовой связью (CCD) и датчик CMOS с активными пикселями (CMOS-датчик), используемых в цифровых изображениях и цифровых камерах . [77] Уиллард Бойл и Джордж Э. Смит разработали ПЗС-матрицу в 1969 году. Изучая процесс МОП, они поняли, что электрический заряд аналогичен магнитному пузырю и что он может храниться на крошечном МОП-конденсаторе. Поскольку было довольно просто изготовить серию МОП-конденсаторов в ряд, они подключали к ним подходящее напряжение, чтобы заряд мог переходить от одного к другому. [77]ПЗС - это полупроводниковая схема, которая позже использовалась в первых цифровых видеокамерах для телевещания . [185]
MOS датчик активного пикселя (APS) был разработан Цутому Накамура на Олимпе в 1985 году [186] CMOS датчик активный пиксель был впоследствии разработан Эриком Фоссум и его команда в НАСА «s Лаборатории реактивного движения в начале 1990 - х годов. [187]
Датчики изображения MOS широко используются в технологии оптических мышей . В первой оптической мыши, изобретенной Ричардом Ф. Лайоном в Xerox в 1980 году, использовался сенсорный чип NMOS 5 мкм . [188] [189] С момента появления первой коммерческой оптической мыши IntelliMouse, представленной в 1999 году, в большинстве оптических мышей используются датчики CMOS. [190]
Силовые МОП-транзисторы [ править ]
MOSFET власти является наиболее широко используемым устройством питания в мире. [4] Преимущества перед транзисторами с биполярным переходом в силовой электронике включают полевые МОП-транзисторы, не требующие непрерывного потока управляющего тока, чтобы оставаться во включенном состоянии, предлагающие более высокие скорости переключения, более низкие потери мощности переключения, более низкое сопротивление в открытом состоянии и пониженную подверженность тепловому разгоне. [191] Силовой полевой МОП-транзистор повлиял на источники питания , позволив повысить рабочие частоты, уменьшить размер и вес, а также увеличить объемы производства. [192]
Импульсные источники питания - наиболее распространенное применение для силовых полевых МОП-транзисторов. [53] Они также широко используются для MOS усилителей мощности RF , которые позволили осуществить переход мобильных сетей с аналоговых на цифровые в 1990-х годах. Это привело к широкому распространению беспроводных мобильных сетей, которые произвели революцию в системах электросвязи . [179] LDMOS , в частности , является наиболее широко используется усилитель мощности в мобильных сетях, таких как 2G , 3G , [179] 4G и 5G . [180] Более 50 миллиардов полевых МОП-транзисторов с дискретной мощностью отгружается ежегодно, по состоянию на 2018 год. Они широко используются , в частности, в автомобильных , промышленных и коммуникационных системах . [193] Силовые МОП-транзисторы обычно используются в автомобильной электронике , в частности, в качестве переключающих устройств в электронных блоках управления , [194] и в качестве преобразователей энергии в современных электромобилях . [195] биполярный транзистор с изолированным затвором (IGBT), гибрид МОП-биполярный транзистор, также используется для самых разнообразных применений. [196]
Строительство [ править ]
Материал ворот [ править ]
Основным критерием выбора материала затвора является его хорошая проводимость . Сильнолегированный поликристаллический кремний является приемлемым, но определенно не идеальным проводником, а также страдает некоторыми дополнительными техническими недостатками в своей роли стандартного материала затвора. Тем не менее, есть несколько причин в пользу использования поликремния:
- Пороговое напряжение (и , следовательно , утечка к источнику тока на) модифицируются функция работы разницы между затвором материалом и материалом канала. Поскольку поликремний является полупроводником, его работу выхода можно модулировать, регулируя тип и уровень легирования. Кроме того, поскольку поликремний имеет ту же запрещенную зону, что и нижележащий кремниевый канал, довольно просто настроить работу выхода для достижения низких пороговых напряжений как для устройств NMOS, так и для устройств PMOS. Напротив, работу выхода металлов нелегко модулировать, поэтому настройка работы выхода для получения низких пороговых напряжений(LVT) становится серьезной проблемой. Кроме того, получение низкопороговых устройств на устройствах PMOS и NMOS иногда требует использования разных металлов для каждого типа устройства. Хотя биметаллические интегральные схемы (т. Е. Один тип металла для электродов затвора NFETS и второй тип металла для электродов затвора PFETS) не распространены, они известны в патентной литературе и обеспечивают некоторые преимущества с точки зрения настройки электрических схем в целом. электрические характеристики.
- Граница раздела кремний-SiO 2 хорошо изучена и, как известно, имеет относительно небольшое количество дефектов. Напротив, многие интерфейсы металл-изолятор содержат значительные уровни дефектов, которые могут привести к закреплению уровня Ферми , зарядке или другим явлениям, которые в конечном итоге ухудшают характеристики устройства.
- В процессе изготовления ИС полевого МОП-транзистора предпочтительно наносить материал затвора перед определенными высокотемпературными этапами, чтобы сделать транзисторы с лучшими характеристиками. Такие высокотемпературные этапы плавили бы некоторые металлы, ограничивая типы металлов, которые могут использоваться в процессе на основе металлических затворов.
Хотя ворота из поликремния были стандартом де-факто в течение последних двадцати лет, у них действительно есть некоторые недостатки, которые привели к их вероятной замене в будущем металлическими воротами. К этим недостаткам можно отнести:
- Поликремний не является хорошим проводником (примерно в 1000 раз более резистивным, чем металлы), что снижает скорость распространения сигнала через материал. Удельное сопротивление можно снизить, увеличив уровень легирования, но даже сильно легированный поликремний не так проводит, как большинство металлов. Для дальнейшего улучшения проводимости иногда высокотемпературный металл, такой как вольфрам , титан , кобальт , а в последнее время никель , легируют верхними слоями поликремния. Такой смешанный материал называется силицид.. Комбинация силицида и поликремния имеет лучшие электрические свойства, чем один поликремний, и все же не плавится при последующей обработке. Кроме того, пороговое напряжение не намного выше, чем у одного поликремния, потому что силицидный материал не находится рядом с каналом. Процесс, в котором силицид образуется как на электроде затвора, так и в областях истока и стока, иногда называют салицидом , самовыравнивающимся силицидом.
- Когда транзисторы сильно уменьшены в масштабе, необходимо сделать диэлектрический слой затвора очень тонким, около 1 нм в современных технологиях. Наблюдаемое здесь явление представляет собой так называемое поликристаллическое обеднение , когда обедненный слой образуется в слое поликремния затвора рядом с диэлектриком затвора, когда транзистор находится в инверсии. Чтобы избежать этой проблемы, желательна металлическая калитка. Разнообразные металлические ворота , такие как тантал , вольфрам, нитрид тантала и нитрида титана используют, как правило , в сочетании с высокой каппа диэлектриков . Альтернативой является использование затворов из полностью кремниевого поликремния, процесс, известный как FUSI.
Современные высокопроизводительные процессоры используют технологию металлического затвора вместе с диэлектриками с высоким κ , комбинация, известная как высокий κ, металлический затвор (HKMG). Недостатки металлических ворот преодолеваются несколькими приемами: [197]
- Пороговое напряжение регулируется путем включения тонкого слоя «металла с работой выхода» между диэлектриком с высоким κ и основным металлом. Этот слой достаточно тонкий, чтобы на полную работу выхода затвора влиять как работа выхода основного металла, так и работа выхода тонкого металла (либо из-за легирования во время отжига, либо просто из-за неполного экранирования тонким металлом). Таким образом, пороговое напряжение можно регулировать толщиной тонкого металлического слоя.
- Диэлектрики с высоким κ в настоящее время хорошо изучены, и их дефекты понятны.
- Существуют процессы HKMG, которые не требуют от металлов высокотемпературных отжигов; другие процессы отбирают металлы, которые могут пережить стадию отжига.
Изолятор [ править ]
По мере того, как устройства становятся меньше, изолирующие слои становятся тоньше, часто за счет стадий термического окисления или локального окисления кремния ( LOCOS ). Для наноразмерных устройств в какой-то момент происходит туннелирование носителей через изолятор от канала до электрода затвора. Чтобы уменьшить результирующий ток утечки , изолятор можно сделать тоньше, выбрав материал с более высокой диэлектрической проницаемостью. Чтобы увидеть, как связаны толщина и диэлектрическая проницаемость, обратите внимание, что закон Гаусса связывает поле и заряд следующим образом:
где Q = плотность заряда, κ = диэлектрическая проницаемость, ε 0 = диэлектрическая проницаемость пустого пространства и E = электрическое поле. Из этого закона следует, что такой же заряд может поддерживаться в канале при более низком поле при увеличении κ. Напряжение на затворе определяется по формуле:
где V G = напряжение затвора, V ch = напряжение на стороне канала изолятора и t ins = толщина изолятора. Это уравнение показывает, что напряжение затвора не будет увеличиваться при увеличении толщины изолятора, при условии, что κ увеличивается, чтобы поддерживать t ins / κ = постоянным (более подробную информацию см. В статье о диэлектриках с высоким κ и в разделе этой статьи об утечке оксида затвора ).
Изолятор в полевом МОП-транзисторе представляет собой диэлектрик, который в любом случае может быть оксидом кремния, образованным LOCOS, но используются многие другие диэлектрические материалы. Общий термин для диэлектрика - диэлектрик затвора, поскольку диэлектрик находится непосредственно под электродом затвора и над каналом полевого МОП-транзистора.
Конструкция развязки [ править ]
Источник к кузову и сток к кузову перекрестки являются объектом пристального внимания из трех основных факторов: их конструкция влияет на вольт-амперной ( I-V ) характеристика устройства, снижая выходное сопротивление, а также скорость устройства из-за эффекта нагрузки емкостей перехода и, наконец, составляющей рассеиваемой мощности в режиме ожидания из-за утечки через переход.
Сливной индуцированный барьер снижения порогового напряжения и длиной канала модуляция эффектов на IV кривых уменьшаются с помощью неглубокого расширения перехода. Кроме того, можно использовать легирование гало , то есть добавление очень тонких сильно легированных областей того же типа легирования, что и тело, плотно прилегающее к стенкам перехода, чтобы ограничить протяженность областей обеднения . [198]
Емкостные эффекты ограничиваются за счет использования выпуклой геометрии истока и стока, которая делает большую часть границы контактной области толстым диэлектриком вместо кремния. [199]
Эти различные особенности конструкции соединений показаны (с художественной лицензией ) на рисунке.
Масштабирование [ править ]
Этот раздел написан как личное размышление, личное эссе или аргументированное эссе , в котором излагаются личные чувства редактора Википедии или представлены оригинальные аргументы по теме. ( Сентябрь 2016 г. ) ( Узнайте, как и когда удалить этот шаблон сообщения ) |
| Изготовление полупроводниковых приборов |
|---|
| Масштабирование MOSFET ( технологические узлы ) |
|
Будущее
|
|
За последние десятилетия размер MOSFET (используемый для цифровой логики) постоянно уменьшался; типичная длина канала полевого МОП-транзистора когда-то составляла несколько микрометров , но современные интегральные схемы включают полевые МОП-транзисторы с длиной канала в десятки нанометров. Работа Роберта Деннарда по теории масштабирования сыграла решающую роль в признании возможности этого продолжающегося сокращения. Полупроводниковая промышленность поддерживает «дорожную карту», ITRS , [200]что задает темп развития MOSFET. Исторически сложилось так, что трудности с уменьшением размера полевого МОП-транзистора были связаны с процессом изготовления полупроводниковых устройств, с необходимостью использования очень низких напряжений и с более низкими электрическими характеристиками, что требовало перепроектирования схемы и инноваций (малые МОП-транзисторы демонстрируют более высокие токи утечки и более низкое выходное сопротивление. ). По состоянию на 2019 год самыми маленькими MOSFET-транзисторами являются полупроводниковые узлы FinFET с длиной волны 5 нм , производимые Samsung Electronics и TSMC . [201] [202]
Полевые МОП-транзисторы меньшего размера желательны по нескольким причинам. Основная причина уменьшить размер транзисторов - это разместить все больше и больше устройств в определенной области кристалла. В результате получается чип с той же функциональностью на меньшей площади или чипы с большей функциональностью на той же площади. Поскольку затраты на изготовление полупроводниковой пластины относительно фиксированы, стоимость интегральных схем в основном связана с количеством микросхем, которые могут быть произведены на пластине. Следовательно, меньшие ИС позволяют использовать больше микросхем на пластину, что снижает цену за кристалл. Фактически, за последние 30 лет количество транзисторов на микросхему удваивалось каждые 2–3 года после внедрения нового технологического узла. Например, количество полевых МОП-транзисторов в микропроцессоре, изготовленном по 45-нм технологии, может быть вдвое больше, чем в микропроцессоре.Чип 65 нм . Это удвоение плотности транзисторов впервые наблюдал Гордон Мур в 1965 году и обычно называют законом Мура . [203] Также ожидается, что транзисторы меньшего размера переключаются быстрее. Например, одним из подходов к уменьшению размера является масштабирование полевого МОП-транзистора, которое требует пропорционального уменьшения всех размеров устройства. Основными размерами устройства являются длина канала, ширина канала и толщина оксида. Когда они уменьшаются в равном масштабе, сопротивление канала транзистора не изменяется, а емкость затвора уменьшается на этот коэффициент. Следовательно, задержка RCтранзистора масштабируется с аналогичным коэффициентом. В то время как это традиционно имело место для более старых технологий, для современных полевых МОП-транзисторов уменьшение размеров транзистора не обязательно приводит к более высокой скорости микросхемы, поскольку задержка из-за межсоединений более значительна.
Производство полевых МОП-транзисторов с длиной канала намного меньше микрометра является сложной задачей, а трудности изготовления полупроводниковых устройств всегда являются ограничивающим фактором в развитии технологии интегральных схем. Хотя такие процессы, как осаждение атомных слоев ( ALD ), улучшили производство небольших компонентов, небольшой размер полевого МОП-транзистора (менее нескольких десятков нанометров) создал эксплуатационные проблемы:
- Высшая подпороговая проводимость
- Поскольку геометрия полевого МОП-транзистора сужается, напряжение, которое может быть приложено к затвору, должно быть уменьшено для сохранения надежности. Для сохранения производительности необходимо также снизить пороговое напряжение полевого МОП-транзистора. Поскольку пороговое напряжение снижается, транзистор не может быть переключен с полного выключения на полное включение с ограниченным размахом напряжения; конструкция схемы представляет собой компромисс между сильным током во включенном корпусе и низким током в выключенном , и приложение определяет, следует ли отдавать предпочтение одному перед другим. Допороговая утечка (включая подпороговую проводимость, утечку через оксид затвора и утечку из обратного смещения перехода), которая игнорировалась в прошлом, теперь может потреблять более половины общей потребляемой мощности современных высокопроизводительных микросхем СБИС. [204][205]
- Повышенная утечка оксида затвора
- Оксид затвора, который служит изолятором между затвором и каналом, должен быть как можно более тонким, чтобы увеличить проводимость канала и производительность, когда транзистор включен, и уменьшить подпороговую утечку, когда транзистор выключен. Однако с оксидами затвора тока толщиной около 1,2 нм (что в кремнии составляет ~ 5 атомов толщиной) возникает квантово-механическое явление туннелирования электронов между затвором и каналом, что приводит к увеличению энергопотребления. Диоксид кремниятрадиционно использовался в качестве изолятора затвора. Однако диоксид кремния имеет умеренную диэлектрическую проницаемость. Увеличение диэлектрической проницаемости диэлектрика затвора позволяет получить более толстый слой при сохранении высокой емкости (емкость пропорциональна диэлектрической проницаемости и обратно пропорциональна толщине диэлектрика). При прочих равных, большая толщина диэлектрика уменьшает квантовый туннельный ток через диэлектрик между затвором и каналом. Изоляторы с большей диэлектрической проницаемостью, чем диоксид кремния (называемые диэлектриками с высоким κ ), такие как силикаты металлов группы IVb, например гафний и цирконий.силикаты и оксиды используются для уменьшения утечки затвора, начиная с технологического узла 45 нанометров и далее. С другой стороны, важным фактором является высота барьера нового изолятора ворот; разница в энергии зоны проводимости между полупроводником и диэлектриком (и соответствующая разница в энергии валентной зоны ) также влияет на уровень тока утечки. Для традиционного оксида затвора, диоксида кремния, первый барьер составляет примерно 8 эВ.. Для многих альтернативных диэлектриков значение значительно ниже, что приводит к увеличению туннельного тока, что несколько сводит на нет преимущество более высокой диэлектрической проницаемости. Максимальное напряжение затвор-исток определяется силой электрического поля, которое может выдерживать диэлектрик затвора до того, как произойдет значительная утечка. По мере того, как изолирующий диэлектрик становится тоньше, напряженность электрического поля внутри него увеличивается до фиксированного напряжения. Это требует использования более низких напряжений с более тонким диэлектриком.
- Повышенная утечка в переходах
- Чтобы уменьшить размеры устройств, конструкция переходов стала более сложной, что привело к более высоким уровням легирования , более мелким переходам, легированию «гало» и т. Д. [206] [207], все для уменьшения вызванного стоком снижения барьера (см. Раздел о конструкции переходов). ). Чтобы удержать эти сложные переходы на месте, необходимо сократить количество этапов отжига, ранее использовавшихся для удаления повреждений и электрически активных дефектов [208], увеличивая утечку через переходы. Более сильное легирование также связано с более тонкими обедненными слоями и большим количеством центров рекомбинации, что приводит к увеличению тока утечки даже без повреждения решетки.
- Слив-индуцированного барьера опускания (DIBL) и V T скатываются
- Из-за эффекта короткого канала формирование канала не полностью выполняется затвором, но теперь сток и исток также влияют на формирование канала. По мере уменьшения длины канала обедненные области истока и стока сближаются, и пороговое напряжение ( V T ) становится функцией длины канала. Это называется V Т спадание. V T также становится функцией напряжения стока в исток V DS . По мере увеличения V DS области истощения увеличиваются в размере, и значительный объем заряда истощается V DS.. Напряжение затвора, необходимое для формирования канала, затем снижается, и, таким образом, V T уменьшается с увеличением V DS . Этот эффект называется снижением барьера, вызванным сливом (DIBL).
- Более низкое выходное сопротивление
- Для аналоговой работы хорошее усиление требует высокого выходного сопротивления полевого МОП-транзистора, то есть ток полевого МОП-транзистора должен незначительно изменяться в зависимости от приложенного напряжения сток-исток. По мере того, как устройства становятся меньше, влияние стока более успешно конкурирует с влиянием затвора из-за растущей близости этих двух электродов, увеличивая чувствительность тока MOSFET к напряжению стока. Чтобы противодействовать результирующему снижению выходного сопротивления, схемы усложняются либо за счет необходимости большего количества устройств, например каскодных и каскадных усилителей , либо за счет схемы обратной связи с использованием операционных усилителей , например схемы, подобной той, что изображена на соседнем рисунке.
- Более низкая крутизна
- Крутизна МОП - транзистора решает его усиление и пропорциональна отверстия или подвижности электронов ( в зависимости от типа устройства), по крайней мере , для низких напряжений сливных. По мере уменьшения размера полевого МОП-транзистора поля в канале увеличиваются, а уровни легирующих примесей увеличиваются. Оба изменения уменьшают подвижность несущей и, следовательно, крутизну. Поскольку длина канала уменьшается без пропорционального уменьшения напряжения стока, увеличивая электрическое поле в канале, результатом является скоростное насыщение носителей, ограничивая ток и крутизну.
- Емкость межсоединения
- Традиционно время переключения было примерно пропорционально емкости затвора затворов. Однако по мере того, как транзисторы становятся меньше и больше транзисторов размещается на микросхеме, емкость межсоединений (емкость соединений металлического слоя между различными частями микросхемы) становится большой процентной долей емкости. [209] [210] Сигналы должны проходить через межсоединение, что приводит к увеличению задержки и снижению производительности.
- Производство тепла
- Постоянно увеличивающаяся плотность полевых МОП-транзисторов на интегральной схеме создает проблемы значительного локального тепловыделения, которое может ухудшить работу схемы. Цепи работают медленнее при высоких температурах, имеют меньшую надежность и меньший срок службы. Радиаторы и другие охлаждающие устройства и методы теперь требуются для многих интегральных схем, включая микропроцессоры. Силовые полевые МОП-транзисторы подвержены риску теплового разгона . Поскольку их сопротивление в открытом состоянии увеличивается с температурой, если нагрузка является приблизительно постоянной нагрузкой, тогда соответственно возрастают потери мощности, выделяя дополнительное тепло. Когда радиатор не может поддерживать температуру на достаточно низком уровне, температура перехода может быстро и неконтролируемо расти, что приведет к разрушению устройства.
- Варианты процесса
- По мере того, как полевые МОП-транзисторы становятся меньше, количество атомов в кремнии, которые определяют многие из свойств транзистора, становится меньше, в результате чего контроль количества и размещения примесей становится более неустойчивым. Во время производства микросхемы случайные изменения процесса влияют на все размеры транзистора: длину, ширину, глубину перехода, толщину оксида и т. Д. И становятся более значительными в процентах от общего размера транзистора по мере сжатия транзистора. Характеристики транзистора становятся менее определенными, более статистическими. Случайный характер производства означает, что мы не знаем, какой именно из примеров полевых МОП-транзисторов на самом деле окажется в конкретном экземпляре схемы. Эта неопределенность вынуждает выбирать менее оптимальную конструкцию, поскольку она должна работать для большого количества возможных компонентных полевых МОП-транзисторов. Посмотреть варианты процесса, проектирование с учетом технологичности , надежности и статистического управления процессами . [211]
- Проблемы моделирования
- Современные ИС моделируются на компьютере с целью получения рабочих схем из самой первой произведенной партии. Поскольку устройства миниатюрны, сложность обработки затрудняет точное прогнозирование того, как будут выглядеть конечные устройства, а моделирование физических процессов также становится более сложной задачей. Кроме того, микроскопические вариации в структуре просто из-за вероятностной природы атомных процессов требуют статистических (а не только детерминированных) предсказаний. Сочетание этих факторов затрудняет адекватное моделирование и изготовление «правильного с первого раза».
Связанное с этим правило масштабирования - закон Эдхольма . В 2004 году Фил Edholm отметил , что пропускная способность в телекоммуникационных сетях ( в том числе Интернет ) удваивается каждые 18 месяцев. [212] За несколько десятилетий пропускная способность сетей связи выросла с бит в секунду до терабит в секунду . Быстрый рост в телекоммуникационном пропускной способности в значительной степени из - за того же масштаба МОП - транзистор , что позволяет закон Мура, так как телекоммуникационные сети строятся из МОП - транзисторов. [181]
Хронология [ править ]
PMOS и NMOS [ править ]
| Дата | Длина канала | Толщина оксида [213] | Логика MOSFET | Исследователь (ы) | Организация | Ссылка |
|---|---|---|---|---|---|---|
| Июнь 1960 г. | 20000 нм | 100 нм | PMOS | Мохамед М. Аталла , Давон Канг | Bell Telephone Laboratories | [214] [215] |
| NMOS | ||||||
| 10,000 нм | 100 нм | PMOS | Мохамед М. Аталла , Давон Канг | Bell Telephone Laboratories | [216] | |
| NMOS | ||||||
| Май 1965 г. | 8000 нм | 150 нм | NMOS | Чих-Танг Сах , Отто Лейстико, AS Grove | Полупроводник Fairchild | [217] |
| 5000 нм | 170 нм | PMOS | ||||
| Декабрь 1972 г. | 1000 морских миль | ? | PMOS | Роберт Х. Деннард , Фриц Х. Гэнсслен, Хва-Ниен Ю | Исследовательский центр IBM TJ Watson | [218] [219] [220] |
| 1973 | 7500 нм | ? | NMOS | Сохичи Сузуки | NEC | [221] [222] |
| 6000 нм | ? | PMOS | ? | Toshiba | [223] [224] | |
| Октябрь 1974 г. | 1000 морских миль | 35 нм | NMOS | Роберт Х. Деннард , Фриц Х. Гэнсслен, Хва-Ниен Ю | Исследовательский центр IBM TJ Watson | [225] |
| 500 нм | ||||||
| Сентябрь 1975 г. | 1500 нм | 20 нм | NMOS | Риоичи Хори, Хироо Масуда, Осаму Минато | Hitachi | [219] [226] |
| Март 1976 г. | 3000 нм | ? | NMOS | ? | Intel | [227] |
| Апрель 1979 г. | 1000 морских миль | 25 нм | NMOS | Уильям Р. Хантер, Л. М. Эфрат, Элис Крамер | Исследовательский центр IBM TJ Watson | [228] |
| Декабрь 1984 г. | 100 нм | 5 нм | NMOS | Тосио Кобаяси, Сэйдзи Хоригучи, К. Киучи | Nippon Telegraph and Telephone | [229] |
| Декабрь 1985 г. | 150 нм | 2,5 нм | NMOS | Тосио Кобаяси, Сэйдзи Хоригучи, М. Мияке, М. Ода | Nippon Telegraph and Telephone | [230] |
| 75 нм | ? | NMOS | Стивен Ю. Чоу, Генри И. Смит, Димитри А. Антониадис | Массачусетский технологический институт | [231] | |
| Январь 1986 | 60 нм | ? | NMOS | Стивен Ю. Чоу, Генри И. Смит, Димитри А. Антониадис | Массачусетский технологический институт | [232] |
| Июнь 1987 г. | 200 нм | 3,5 нм | PMOS | Тосио Кобаяси, М. Мияке, К. Дегучи | Nippon Telegraph and Telephone | [233] |
| Декабрь 1993 г. | 40 нм | ? | NMOS | Мизуки Оно, Масанобу Сайто, Такаши Ёситоми | Toshiba | [234] |
| Сентябрь 1996 | 16 нм | ? | PMOS | Хисао Каваура, Тосицугу Сакамото, Тосио Баба | NEC | [235] |
| Июнь 1998 г. | 50 нм | 1,3 нм | NMOS | Халед З. Ахмед, Эффионг Э. Ибок, Мирён Сон | Усовершенствованные микроустройства (AMD) | [236] [237] |
| Декабрь 2002 г. | 6 нм | ? | PMOS | Брюс Дорис, Омер Докумачи, Мэйкей Ионг | IBM | [238] [239] [240] |
| Декабрь 2003 г. | 3 нм | ? | PMOS | Хитоши Вакабаяши, Сигехару Ямагами | NEC | [241] [239] |
| NMOS |
CMOS (одностворчатый) [ править ]
| Дата | Длина канала | Толщина оксида [213] | Исследователь (ы) | Организация | Ссылка |
|---|---|---|---|---|---|
| Февраль 1963 г. | ? | ? | Чих-Тан Сах , Фрэнк Ванласс | Полупроводник Fairchild | [242] [243] |
| 1968 г. | 20000 нм | 100 нм | ? | RCA лаборатории | [244] |
| 1970 г. | 10,000 нм | 100 нм | ? | RCA лаборатории | [244] |
| Декабрь 1976 г. | 2000 нм | ? | А. Эйткен, Р. Г. Поульсен, ATP MacArthur, JJ White | Mitel Semiconductor | [245] |
| Февраль 1978 г. | 3000 нм | ? | Тошиаки Масухара, Осаму Минато, Тошио Сасаки, Ёсио Сакаи | Центральная исследовательская лаборатория Hitachi | [246] [247] [248] |
| Февраль 1983 г. | 1200 нм | 25 нм | RJC Chwang, M. Choi, D. Creek, S. Stern, PH Pelley | Intel | [249] [250] |
| 900 нм | 15 морских миль | Цунео Мано, Дж. Ямада, Дзюнъити Иноуэ, С. Накадзима | Nippon Telegraph and Telephone (NTT) | [249] [251] | |
| Декабрь 1983 г. | 1000 морских миль | 22,5 нм | Г. Дж. Ху, Юань Таур, Роберт Х. Деннард , Чунг-Ю Тин | Исследовательский центр IBM TJ Watson | [252] |
| Февраль 1987 г. | 800 нм | 17 нм | Т. Суми, Цунео Танигучи, Микио Кисимото, Хиросигэ Хирано | Мацусита | [249] [253] |
| 700 нм | 12 нм | Цунео Мано, Дж. Ямада, Дзюнъити Иноуэ, С. Накадзима | Nippon Telegraph and Telephone (NTT) | [249] [254] | |
| Сентябрь 1987 г. | 500 нм | 12,5 нм | Хусейн И. Ханафи, Роберт Х. Деннард , Юан Таур, Надим Ф. Хаддад | Исследовательский центр IBM TJ Watson | [255] |
| Декабрь 1987 г. | 250 нм | ? | Наоки Касаи, Нобухиро Эндо, Хироши Китадзима | NEC | [256] |
| Февраль 1988 г. | 400 нм | 10 нм | М. Иноуэ, Х. Котани, Т. Ямада, Хироюки Ямаути | Мацусита | [249] [257] |
| Декабрь 1990 г. | 100 нм | ? | Гавам Г. Шахиди , Биджан Давари , Юань Таур, Джеймс Д. Варнок | Исследовательский центр IBM TJ Watson | [258] |
| 1993 г. | 350 нм | ? | ? | Sony | [259] |
| 1996 г. | 150 нм | ? | ? | Mitsubishi Electric | |
| 1998 г. | 180 нм | ? | ? | TSMC | [260] |
| Декабрь 2003 г. | 5 нм | ? | Хитоши Вакабаяси, Сигехару Ямагами, Нобуюки Икэдзава | NEC | [241] [261] |
MOSFET с несколькими затворами (MuGFET) [ править ]
| Дата | Длина канала | Тип MuGFET | Исследователь (ы) | Организация | Ссылка |
|---|---|---|---|---|---|
| Август 1984 г. | ? | ДГМОС | Тосихиро Секигава, Ютака Хаяси | Электротехническая лаборатория (ЭТЛ) | [262] |
| 1987 г. | 2000 нм | ДГМОС | Тосихиро Секигава | Электротехническая лаборатория (ЭТЛ) | [263] |
| Декабрь 1988 г. | 250 нм | ДГМОС | Биджан Давари , Вен-Син Чанг, Мэтью Р. Уордеман, CS Oh | Исследовательский центр IBM TJ Watson | [264] [265] |
| 180 нм | |||||
| ? | GAAFET | Фудзио Масуока , Хироши Такато, Казумаса Сунучи, Н. Окабе | Toshiba | [266] [267] [268] | |
| Декабрь 1989 г. | 200 нм | FinFET | Диг Хисамото, Тору Кага, Ёсифуми Кавамото, Эйдзи Такеда | Центральная исследовательская лаборатория Hitachi | [269] [270] [271] |
| Декабрь 1998 г. | 17 нм | FinFET | Диг Хисамото, Ченмин Ху , Цу-Дже Кинг Лю , Джеффри Бокор | Калифорнийский университет (Беркли) | [272] [273] |
| 2001 г. | 15 морских миль | FinFET | Ченмин Ху , Ян-Гю Чой, Ник Линдерт, Цу-Джэ Кинг Лю | Калифорнийский университет (Беркли) | [272] [274] |
| Декабрь 2002 г. | 10 нм | FinFET | Шибли Ахмед, Скотт Белл, Сайрус Табери, Джеффри Бокор | Калифорнийский университет (Беркли) | [272] [275] |
| Июнь 2006 г. | 3 нм | GAAFET | Хёнджин Ли, Ян-кю Чой, Ли-Ын Ю, Сон-Ван Рю | KAIST | [276] [277] |
Другие типы полевых МОП-транзисторов [ править ]
| Дата | Длина канала (нм) | Толщина оксида (нм) [213] | Тип MOSFET | Исследователь (ы) | Организация | Ссылка |
|---|---|---|---|---|---|---|
| Октябрь 1962 г. | ? | ? | TFT | Пол К. Веймер | RCA лаборатории | [278] [279] |
| 1965 г. | ? | ? | GaAs | Х. Беке, Р. Холл, Дж. Уайт | RCA лаборатории | [280] |
| Октябрь 1966 г. | 100 000 | 100 | TFT | Т.П. Броды, Е.П. Куниг | Westinghouse Electric | [281] [282] |
| Август 1967 г. | ? | ? | ФГМОС | Давон Кан , Саймон Мин Сзе | Bell Telephone Laboratories | [283] |
| Октябрь 1967 | ? | ? | MNOS | HA Ричард Вегенер, Эй Джей Линкольн, ХК Пао | Sperry Corporation | [284] |
| Июль 1968 г. | ? | ? | БиМОС | Хун-Чанг Линь , Рамачандра Р. Айер | Westinghouse Electric | [285] [286] |
| Октябрь 1968 г. | ? | ? | BiCMOS | Хун-Чанг Линь , Рамачандра Р. Айер, Коннектикут Хо | Westinghouse Electric | [287] [286] |
| 1969 г. | ? | ? | VMOS | ? | Hitachi | [288] [289] |
| Сентябрь 1969 | ? | ? | DMOS | Ю. Таруи, Ю. Хаяси, Тосихиро Секигава | Электротехническая лаборатория (ЭТЛ) | [290] [291] |
| Октябрь 1970 г. | ? | ? | ISFET | Пит Бергвельд | Университет Твенте | [292] [293] |
| Октябрь 1970 г. | 1000 | ? | DMOS | Ю. Таруи, Ю. Хаяси, Тосихиро Секигава | Электротехническая лаборатория (ЭТЛ) | [294] |
| 1977 г. | ? | ? | VDMOS | Джон Луи Молл | Лаборатория HP | [288] |
| ? | ? | LDMOS | ? | Hitachi | [295] | |
| Июль 1979 г. | ? | ? | БТИЗ | Бантвал Джаянт Балига , Маргарет Лазери | General Electric | [296] |
| Декабрь 1984 г. | 2000 г. | ? | BiCMOS | Х. Хигучи, Горо Кицукава, Такахидэ Икеда, Я. Нишио | Hitachi | [297] |
| Май 1985 г. | 300 | ? | ? | К. Дегучи, Кадзухико Комацу, М. Мияке, Х. Намацу | Nippon Telegraph and Telephone | [298] |
| Февраль 1985 г. | 1000 | ? | BiCMOS | Х. Момосе, Хидеки Сибата, С. Сайто, Дзюн-ичи Миямото | Toshiba | [299] |
| Ноябрь 1986 | 90 | 8,3 | ? | Хан-Шэн Ли, LC Puzio | Дженерал Моторс | [300] |
| Декабрь 1986 г. | 60 | ? | ? | Гавам Г. Шахиди , Димитри А. Антониадис, Генри И. Смит | Массачусетский технологический институт | [301] [232] |
| Май 1987 г. | ? | 10 | ? | Биджан Давари , Чунг-Ю Тинг, Кие Й. Ан, С. Басаваия | Исследовательский центр IBM TJ Watson | [302] |
| Декабрь 1987 г. | 800 | ? | BiCMOS | Роберт Х. Хавеманн, Р. Э. Эклунд, Хип В. Тран | Инструменты Техаса | [303] |
| Июнь 1997 г. | 30 | ? | EJ-МОП-транзистор | Хисао Каваура, Тосицугу Сакамото, Тосио Баба | NEC | [304] |
| 1998 г. | 32 | ? | ? | ? | NEC | [239] |
| 1999 г. | 8 | |||||
| Апрель 2000 г. | 8 | ? | EJ-МОП-транзистор | Хисао Каваура, Тосицугу Сакамото, Тосио Баба | NEC | [305] |
См. Также [ править ]
- BSIM
- ggNMOS
- Транзистор с высокой подвижностью электронов
- Эффект истощения поликремния
- Квантовый эффект Холла
- Модель транзистора
- Собственный диод
Ссылки [ править ]
- ^ a b c "Кто изобрел транзистор?" . Музей истории компьютеров . 4 декабря 2013 . Проверено 20 июля 2019 .
- ↑ Лоус, Дэвид (2 апреля 2018 г.). «13 секстиллионов и подсчет: длинный и извилистый путь к самому часто производимому человеческому артефакту в истории» . Музей истории компьютеров . Проверено 5 мая 2020 года .
- ^ a b c Эшли, Кеннет Л. (2002). Аналоговая электроника с LabVIEW . Prentice Hall Professional . п. 10. ISBN 978-0130470652.
В недавнем учебнике по аналоговым интегральным схемам (Jorns and Martin, 1997) используется подход, согласно которому в таких схемах сейчас полностью доминируют полевые МОП-транзисторы, но включены некоторые приложения BJT. (...) MOSFET постепенно стал самым важным транзистором, с повышенным вниманием к интегральным схемам и улучшенным скоростям.
- ^ a b c d "Основы Power MOSFET" (PDF) . Alpha & Omega Semiconductor . Проверено 29 июля 2019 года .
Силовые МОП-транзисторы (полевые транзисторы на основе оксидов металлов и полупроводников) являются наиболее часто используемыми силовыми устройствами из-за их низкой мощности управления затвором, высокой скорости переключения и превосходной возможности параллельного подключения.
- ^ Бакши, UA; Годсе, AP (2007). «§8.2 MOSFET в режиме истощения» . Электронные схемы . Технические публикации. п. 812. ISBN 978-81-8431-284-3.
- ^ Лилиенфельд, Юлиус Эдгар (1926-10-08) "Метод и устройство для управления электрическими токами" Патент США 1745175A
- ^ a b c Сделка, Брюс Э. (1998). «Основные моменты технологии термического окисления кремния» . Кремниевое материаловедение и технология . Электрохимическое общество . п. 183. ISBN. 978-1566771931.
- ^ a b c d "1960: Металлооксидный полупроводниковый (МОП) транзистор продемонстрирован" . Кремниевый двигатель: временная шкала полупроводников в компьютерах . Музей истории компьютеров . Проверено 31 августа 2019 года .
- ^ а б в г Московиц, Сэнфорд Л. (2016). Передовые инновации в материалах: управление глобальными технологиями в 21 веке . Джон Вили и сыновья. С. 165–67. ISBN 978-0470508923.
- ^ a b c d «Основы современного цифрового мира: Триумф МОП-транзистора» . Музей истории компьютеров . 13 июля 2010 . Проверено 21 июля 2019 .
- ^ Кристоф Лекюер; Дэвид С. Брук; Джей Ласт (2010). Создатели микрочипа: документальная история Fairchild Semiconductor . п. 62–63. ISBN 978-0262014243.CS1 maint: uses authors parameter (link)
- ^ Claeys, Cor L. (2003). Интеграция процессов ULSI III: Материалы международного симпозиума . Электрохимическое общество . п. 27–30. ISBN 978-1566773768.
- ^ a b c d e "Давон Канг" . Национальный зал славы изобретателей . Проверено 27 июня 2019 .
- ^ a b c d "Мартин (Джон) М. Аталла" . Национальный зал славы изобретателей . 2009 . Проверено 21 июня 2013 года .
- ^ a b c Lojek, Бо (2007). История полупроводниковой техники . Springer Science & Business Media. С. 321–23. ISBN 978-3540342588.
- ^ Хафф, Ховард (2005). Материалы с высокой диэлектрической постоянной: приложения VLSI MOSFET . Springer Science & Business Media. п. 34. ISBN 978-3540210818.
- ^ a b Sah, Chih-Tang (октябрь 1988 г.). «Эволюция МОП-транзистора - от концепции до СБИС» (PDF) . Труды IEEE . 76 (10): 1280–1326 [1290]. Bibcode : 1988IEEEP..76.1280S . DOI : 10.1109 / 5.16328 . ISSN 0018-9219 .
Те из нас, кто занимался исследованиями кремниевых материалов и устройств в течение 1956–1960 годов, считали эту успешную попытку группы Bell Labs во главе с Аталлой по стабилизации поверхности кремния самым важным и значительным технологическим достижением, проложившим путь, который привел к технологии кремниевых интегральных схем. разработки на втором этапе и объемы производства на третьем этапе.
- ^ Бассетт, Росс Нокс (2007). К эпохе цифровых технологий: исследовательские лаборатории, начинающие компании и рост MOS-технологий . Издательство Университета Джона Хопкинса. п. 110. ISBN 978-0801886393.
- ^ Lojek, Бо (2007). История полупроводниковой техники . Springer Science & Business Media. п. 322. ISBN. 978-3540342588.
- ^ Питер Робин Моррис (1990). История мировой полупроводниковой промышленности . п. 43. ISBN 9780863412271.
- ^ a b Бассетт, Росс Нокс (2007). К эпохе цифровых технологий: исследовательские лаборатории, начинающие компании и рост MOS-технологий . Издательство Университета Джона Хопкинса. п. 22. ISBN 978-0801886393.
- ^ Патент США 3,206,670 (1960)
- ^ Патент США 3102230 (1960)
- ^ «1948 - Концепция переходного транзистора» . Кремниевый двигатель: временная шкала полупроводников в компьютерах . Музей истории компьютеров. 2007. Архивировано из оригинала на 2012-04-19 . Проверено 2 ноября 2007 .
- ^ Патент США 2,953,486
- ^ Аталла, М .; Канг Д. (июнь 1960 г.). "Кремний – диоксид кремния поверхностные устройства, индуцированные полем". Конференция IRE-AIEE по исследованию твердотельных устройств . Издательство Университета Карнеги-Меллона .
- ^ "Устная история: Голди, Хиттингер и Таненбаум" . Институт инженеров по электротехнике и радиоэлектронике . 25 сентября 2008 . Проверено 22 августа 2019 .
- ^ Московиц, Сэнфорд Л. (2016). Передовые инновации в материалах: управление глобальными технологиями в 21 веке . Джон Вили и сыновья. п. 165 и 181. ISBN 978-0470508923.
Несмотря на свой успех, транзистор с плоским переходом имел свои проблемы, с которыми нужно было бороться. Что наиболее важно, это было довольно громоздкое устройство, которое было сложно производить в массовом производстве, что ограничивало его ряд специализированных приложений. Ученые и инженеры полагали, что только полевой транзистор (FET), тип которого Шокли впервые задумал в конце 1940-х годов, но так и не смог заставить работать должным образом, давал надежду на компактный, действительно массовый транзистор, который можно было бы миниатюризировать для широкий спектр использования. (...) Важным шагом в этом направлении было изобретение «МОП-процесса». (...) Но Мур особенно верил в то, что будущее массового производства недорогих полупроводниковых запоминающих устройств большой емкости за интегральными МОП-микросхемами, то есть интегральными схемами, состоящими из МОП-транзисторов.Он думал, что здесь Intel действительно сможет внести свой вклад в поистине прорывное новшество.
- ^ а б Бассетт, Росс Нокс (2002). К эпохе цифровых технологий: исследовательские лаборатории, начинающие компании и рост MOS-технологий . Издательство Университета Джона Хопкинса . С. 53–54. ISBN 978-0-8018-6809-2.
- ^ a b Бутрика, Эндрю Дж. (2015). «Глава 3: Роль НАСА в производстве интегральных схем» (PDF) . В Дике, Стивен Дж. (Ред.). Исторические исследования влияния космических полетов на общество . НАСА . С. 149-250 (239-42). ISBN 978-1-62683-027-1.
- ^ Дэвид Л. Мортон; Джозеф Габриэль (2007). Электроника: история жизни технологии . п. 84.CS1 maint: uses authors parameter (link)
- ^ a b «1963: изобретена дополнительная конфигурация схемы MOS» . Музей истории компьютеров . Дата обращения 6 июля 2019 .
- ^ [1] , "Полупроводниковая преобразовательная схема", выпущена 1964-10-30.
- ^ Харрисон, Линден Т. (2005). Источники тока и напряжения: Ссылки A Конструкция Справочник для инженеров электроники . Эльзевир. п. 185. ISBN 978-0-08-045555-6.
- ^ a b «1968: технология кремниевого затвора, разработанная для микросхем» . Музей истории компьютеров . Проверено 22 июля 2019 .
- ^ Бассетт, Росс Нокс (2007). К эпохе цифровых технологий: исследовательские лаборатории, начинающие компании и рост MOS-технологий . Издательство Университета Джона Хопкинса . п. 3. ISBN 978-0801886393.
- ^ Claeys, Cor L. (2003). Интеграция процессов ULSI III: Материалы международного симпозиума . Электрохимическое общество . п. 46. ISBN 978-1566773768.
- ^ Arns, RG (октябрь 1998). «Другой транзистор: ранняя история полевого транзистора металл-оксид-полупроводник». Журнал инженерной науки и образования . 7 (5): 233–40. DOI : 10.1049 / esej: 19980509 .
- Перейти ↑ Chan, Yi-Jen (1992). Исследования гетероструктурных полевых транзисторов InAIA / InGaAs и GaInP / GaAs для высокоскоростных приложений . Мичиганский университет . п. 1.
Si MOSFET произвел революцию в электронной промышленности и в результате влияет на нашу повседневную жизнь почти всеми мыслимыми способами.
- ^ Kubozono, Yoshihiro; Он, Сюэся; Хамао, Шино; Уэсуги, Эри; Шимо, Юма; Миками, Такахиро; Гото, Хиденори; Камбэ, Такаши (2015). «Применение органических полупроводников к транзисторам» . Наноустройства для фотоники и электроники: достижения и приложения . CRC Press . п. 355. ISBN 978-9814613750.
- ^ Мальмштадт, Говард V .; Энке, Кристи Дж .; Крауч, Стэнли Р. (1994). Правильное подключение: микрокомпьютеры и электронное оборудование . Американское химическое общество . п. 389. ISBN. 978-0841228610.
Относительная простота и низкое энергопотребление полевых МОП-транзисторов способствовали сегодняшней революции в области микрокомпьютеров.
- ^ а б Маккласки, Мэтью Д .; Галлер, Юджин Э. (2012). Легирующие примеси и дефекты в полупроводниках . CRC Press . п. 3. ISBN 978-1439831533.
- ↑ Дэниелс, Ли А. (28 мая 1992 г.). "Доктор Давон Канг, 61 год, изобретатель в области твердотельной электроники" . Нью-Йорк Таймс . Проверено 1 апреля 2017 года .
- ^ Golio, Mike; Голио, Джанет (2018). ВЧ и СВЧ пассивные и активные технологии . CRC Press. С. 18–12. ISBN 978-1420006728.
- ^ a b c Колиндж, Жан-Пьер; Грир, Джеймс С. (2016). Нанопроволочные транзисторы: физика устройств и материалов в одном измерении . Издательство Кембриджского университета . п. 2. ISBN 978-1107052406.
- ^ Lamba, V .; Engles, D .; Малик, СС; Верма, М. (2009). "Квантовый транспорт в кремниевом МОП-транзисторе с двойным затвором". 2009 2-й Международный семинар по электронным устройствам и полупроводниковым технологиям : 1–4. DOI : 10,1109 / EDST.2009.5166116 . ISBN 978-1-4244-3831-0. S2CID 10377971 .
- ^ a b Sridharan, K .; Пуди, Викрамкумар (2015). Конструирование арифметических схем в нанотехнологиях квантовых точечных клеточных автоматов . Springer. п. 1. ISBN 978-3319166889.
- ^ a b Мотоёси, М. (2009). «Сквозной кремний (TSV)» (PDF) . Труды IEEE . 97 (1): 43–48. DOI : 10.1109 / JPROC.2008.2007462 . ISSN 0018-9219 . S2CID 29105721 .
- ^ Лекьюайер, Christophe (2006). Создание Кремниевой долины: инновации и рост высоких технологий, 1930-1970 . Фонд химического наследия . п. 273. ISBN. 9780262122818.
- ^ a b c Sze, Саймон Мин . «Полевые транзисторы металл – оксид – полупроводник» . Британская энциклопедия . Проверено 21 июля 2019 .
- ^ a b «Транзисторы поддерживают закон Мура» . EETimes . 12 декабря 2018 . Проверено 18 июля 2019 .
- ^ a b Бапат, YN (1992). Электронные схемы и системы: аналоговые и цифровые, 1e . Тата Макгроу-Хилл Образование . п. 119. ISBN 978-0-07-460040-5.
- ^ a b c d «Применение полевых МОП-транзисторов в современных схемах переключения мощности» . Электронный дизайн . 23 мая 2016 . Проверено 10 августа 2019 .
- ^ B. SOMANATHAN НАИРИТ (2002). Цифровая электроника и логический дизайн . PHI Learning Pvt. ООО п. 289. ISBN. 9788120319561.
Цифровые сигналы представляют собой импульсы фиксированной ширины, которые занимают только один из двух уровней амплитуды.
- ^ Иосиф Migga Kizza (2005). Компьютерная сетевая безопасность . Springer Science & Business Media. ISBN 978-0387204734.
- ^ a b c «Черепаха транзисторов побеждает в гонке - революция CHM» . Музей истории компьютеров . Проверено 22 июля 2019 .
- ^ 2000 Решенные проблемы в цифровой электронике . Тата Макгроу-Хилл Образование . 2005. с. 151. ISBN. 978-0-07-058831-8.
- ^ Фрэнк, ди-джей; Деннард, Р.Х .; Новак, Э .; Соломон, ПМ; Таур Ю. (2001). «Пределы масштабирования устройств Si MOSFET и их зависимости от приложений». Труды IEEE . 89 (3): 259–88. DOI : 10.1109 / 5.915374 . ISSN 0018-9219 .
- ^ Klimecky, Пит Иван (2002). Контроль плотности плазмы для снижения вариации реактивного ионного травления в промышленной микроэлектронике . Мичиганский университет . п. 2. ISBN 9780493885735.
Возможно, самый важный прорыв в области устройств для вычислительной индустрии произошел в 1960 году, когда Канг и Аталла предложили и изготовили первый полевой транзистор металл-оксид-полупроводник, или MOSFET, с использованием термически окисленной кремниевой структуры.
- Перейти ↑ Deal, Bruce E. (1988). «Термическое окисление кремния и других полупроводниковых материалов» (PDF) . Справочник по полупроводниковым материалам и технологическим процессам: для очень крупномасштабной интеграции (СБИС) и сверхбольшой интеграции (ULSI) . Публикации Нойеса. п. 46. ISBN 978-0815511502.
- ^ Томпсон, SE; Чау, РС; Ghani, T .; Мистри, К .; Тяги, С .; Бор, М.Т. (2005). «В поисках« Forever »транзисторы продолжали масштабировать один новый материал за раз». IEEE Transactions по производству полупроводников . 18 (1): 26–36. DOI : 10.1109 / TSM.2004.841816 . ISSN 0894-6507 . S2CID 25283342 .
В области электроники планарный полевой транзистор Si металл – оксид – полупроводник (MOSFET), возможно, является наиболее важным изобретением.
- ^ Вонг, Кит По (2009). Электротехника - Том II . Публикации EOLSS . п. 7. ISBN 978-1905839780.
- ^ Реймер, Michael G. (2009). Кремниевая паутина: физика для эпохи Интернета . CRC Press . п. 365. ISBN 978-1439803127.
- Перейти ↑ Feldman, Leonard C. (2001). «Введение» . Фундаментальные аспекты окисления кремния . Springer Science & Business Media . С. 1–11. ISBN 978-3540416821.
- ^ Dabrowski, Ярек; Мюссиг, Ханс-Иоахим (2000). «1.2. Кремниевый век» . Поверхности кремния и образование интерфейсов: фундаментальная наука в индустриальном мире . World Scientific . С. 3–13 . ISBN 978-9810232863.
- ^ a b c d «Выступление директора Янку на Международной конференции по интеллектуальной собственности 2019 г.» . Ведомство США по патентам и товарным знакам . 10 июня, 2019. Архивировано из оригинала 17 декабря 2019 . Проверено 20 июля 2019 .
- ^ Fossum, Джерри Дж .; Триведи, Вишал П. (2013). Основы сверхтонких полевых МОП-транзисторов и полевых транзисторов FinFET . Издательство Кембриджского университета. п. vii. ISBN 978-1107434493.
- ^ Чен, Вай Кай (2004). Справочник по электротехнике . Эльзевир . п. 109. ISBN 978-0080477480.
- ^ Франко, Якопо; Качер, Бен; Groeseneken, Гвидо (2013). Надежность высокомобильных полевых МОП-транзисторов с каналом SiGe для будущих приложений КМОП . Springer Science & Business Media. С. 1–2. ISBN 978-9400776630.
- ^ Кресслер, Джон Д .; Mantooth, Х. Алан (2017). Электроника для экстремальных условий окружающей среды . CRC Press . п. 959. ISBN. 978-1-351-83280-9.
Хотя биполярный переходной транзистор был первым транзисторным устройством, которое закрепилось в мире интегральных схем, нет никаких сомнений в том, что появление полевых МОП-транзисторов, аббревиатуры полевого транзистора металл-оксид-полупроводник, действительно произвело революцию в мире так называемый информационный век. Плотность, с которой могут быть изготовлены эти устройства, позволила целым компьютерам существовать на нескольких небольших микросхемах, а не заполнять комнату.
- ^ a b «13 секстиллионов и подсчет: длинный и извилистый путь к самому часто производимому человеческому артефакту в истории» . Музей истории компьютеров . 2 апреля 2018 . Проверено 28 июля 2019 .
- ^ Б Бэйкер Р.Яков (2011). CMOS: схемотехника, компоновка и моделирование . Джон Вили и сыновья. п. 7. ISBN 978-1118038239.
- ^ Малоберти, Франко; Дэвис, Энтони С. (2016). «История электронных устройств» (PDF) . Краткая история схем и систем: от экологичных, мобильных, повсеместных сетей до вычислений больших данных . IEEE Circuits and Systems Society . С. 59-70 (65-6). ISBN 978-8793609860.
- ^ Швирц, Франк; Вонг, Хей; Лиу, Джуин Дж. (2010). Нанометр CMOS . Пэн Стэнфорд Паблишинг. п. 5. ISBN 978-9814241083.
- ^ Йе, Пейде; Эрнст, Томас; Харе, Мукеш В. (30 июля 2019 г.). «Нанолистовой транзистор - следующий (и, возможно, последний) шаг в законе Мура» . IEEE Spectrum . DOI : 10.1109 / MSPEC.2019.8784120 . S2CID 199439071 . Дата обращения 6 ноября 2019 .
- ↑ Линдли, Дэвид (15 мая 2015 г.). «В центре внимания: ориентиры - случайное обнаружение приводит к стандарту калибровки». Физика . 8 . DOI : 10.1103 / Physics.8.46 .
- ^ а б в г Уильямс, JB (2017). Революция в электронике: изобретение будущего . Springer. С. 245, 249–50. ISBN 978-3319490885.
- ^ Вудалл, Джерри М. (2010). Основы полупроводниковых МОП-транзисторов III-V . Springer Science & Business Media. п. 2. ISBN 978-1441915474.
- ^ a b «Дополнительная информация о Нобелевской премии по физике 2000 г.» (PDF) . Нобелевская премия . Июнь 2018 . Проверено 17 августа 2019 .
- ^ «Вехи: Список вехи IEEE» . Институт инженеров по электротехнике и радиоэлектронике . Проверено 25 июля 2019 .
- ^ "Intel 45nm Hi-k Silicon Technology" . Архивировано из оригинала на 6 октября 2009 года.
- ^ "Книга данных компонентов памяти" (PDF) . Книга данных компонентов памяти . Intel. п. 2–1. Архивировано из оригинального (PDF) 4 марта 2016 года . Проверено 30 августа 2015 года .
- ^ «Использование полевого МОП-транзистора в качестве переключателя» . 090507 brunningsoftware.co.uk
- ^ Шичман, Х. и Ходжес, Д.А. (1968). «Моделирование и моделирование коммутационных схем полевых транзисторов с изолированным затвором». Журнал IEEE по твердотельным схемам . СК-3 (3): 285–89. Bibcode : 1968IJSSC ... 3..285S . DOI : 10.1109 / JSSC.1968.1049902 .
- ^ Например, см. Cheng, Yuhua; Ху, Ченмин (1999). Моделирование MOSFET и руководство пользователя BSIM3 . Springer. ISBN 978-0-7923-8575-2.. Самая последняя версия модели BSIM описана в V., Sriramkumar; Пайдавози, Навид; Лу, Дарсен; Линь Чжун-Сунь; Дунга, Мохан; Яо, Шицзин; Моршед, Танвир; Никнеджад, Али и Ху, Ченмин (2012). "Компактная модель многозатворного полевого МОП-транзистора BSIM-CMG 106.1.0beta" (PDF) . Департамент EE и CS, Калифорнийский университет в Беркли. Архивировано из оригинального (PDF) 27 июля 2014 года . Проверено 1 апреля 2012 .
- ^ Грей, PR; Херст, П.Дж.; Льюис, С.Х. и Мейер, Р.Г. (2001). Анализ и проектирование аналоговых интегральных схем (Четвертое изд.). Нью-Йорк: Вили. С. 66–67. ISBN 978-0471321682.
- ^ ван дер Меер, PR; ван Ставерен, А .; ван Рурмунд, AHM (2004). Маломощная глубокая субмикронная логика CMOS: подпороговое снижение тока . Дордрехт: Спрингер. п. 78. ISBN 978-1-4020-2848-9.
- ^ Дегнан, Брайан. "Википедия терпит неудачу" .
- ^ Мид, Карвер (1989). Аналоговые СБИС и нейронные системы . Ридинг, Массачусетс: Эддисон-Уэсли. п. 370 . ISBN 9780201059922.
- ^ Смит, Лесли S .; Гамильтон, Алистер (1998). Нейроморфные системы: инженерия кремния из нейробиологии . World Scientific. С. 52–56. ISBN 978-981-02-3377-8.
- ^ Кумар Сатиш (2004). Нейронные сети: учебный подход . Тата МакГроу-Хилл. п. 688. ISBN 978-0-07-048292-0.
- ^ Глеснер, Манфред; Зипф, Питер; Реновель, Мишель (2002). Программируемая логика и приложения: 12-я международная конференция . Дордрехт: Спрингер. п. 425. ISBN 978-3-540-44108-3.
- ^ Vittoz, Eric A. (1996). «Основы проектирования аналоговых микромощностей» . В Toumazou, Крис; Баттерсби, Николас С .; Порта, Соня (ред.). Учебники по схемам и системам . Джон Уайли и сыновья. С. 365–72. ISBN 978-0-7803-1170-1.
- ^ Шукла, Сандип К .; Бахар, Р. Айрис (2004). Нано, квантовые и молекулярные вычисления . Springer. п. 10 и рис. 1.4, с. 11. ISBN 978-1-4020-8067-8.
- ^ Шривастава, Ашиш; Сильвестр, Деннис; Блаау, Дэвид (2005). Статистический анализ и оптимизация для СБИС: сроки и мощность . Springer. п. 135. ISBN 978-0-387-25738-9.
- ^ Galup-Монторо, C. & MC, Schneider (2007). Моделирование полевых МОП-транзисторов для анализа и проектирования схем . Лондон / Сингапур: World Scientific. п. 83. ISBN 978-981-256-810-6.
- ^ Малик, Норберт Р. (1995). Электронные схемы: анализ, моделирование и проектирование . Энглвуд Клиффс, Нью-Джерси: Prentice Hall. С. 315–16. ISBN 978-0-02-374910-0.
- ^ Грей, PR; Херст, П.Дж.; Льюис, SH; Мейер, Р.Г. (2001). §1.5.2 с. 45 . ISBN 978-0-471-32168-2.
- ^ Sedra, AS & Smith, KC (2004). Микроэлектронные схемы (Пятое изд.). Нью-Йорк: Оксфорд. п. 552. ISBN. 978-0-19-514251-8.
- ^ Sedra, AS & Smith, KC (2004). п. 250, уравнение. 4.14 . ISBN 978-0-19-514251-8.
- ^
Для однородно легированной подложки p-типа с объемным акцепторным легированием N A на единицу объема
- ^ "Боди-эффект" . Equars.com. Архивировано из оригинала на 2014-11-10 . Проверено 2 июня 2012 .
- ^ «Символы электронных схем» . circuitstoday.com . 9 ноября 2011 года Архивировано из оригинала 13 октября 2014 года.
- ^ IEEE Std 315-1975 - Графические символы для электрических и электронных схем (включая буквы условных обозначений)
- ^ Jaeger, Ричард С .; Блэлок, Трэвис Н. «Рис. 4.15. Обозначения схем транзисторов стандарта IEEE» (PDF) . Проектирование микроэлектронных схем .
- ^ Войнигеску, Сорин (2013). Высокочастотные интегральные схемы . Издательство Кембриджского университета. п. 164. ISBN 978-0521873024.
- ^ Зи, Саймон М. (2002). Полупроводниковые приборы: физика и технология (PDF) (2-е изд.). Вайли. п. 4. ISBN 0-471-33372-7.
- ^ a b c "1978: Double-well fast CMOS SRAM (Hitachi)" (PDF). Semiconductor History Museum of Japan. Archived from the original (PDF) on 5 July 2019. Retrieved 5 July 2019.
- ^ "Computer History Museum – The Silicon Engine | 1963 – Complementary MOS Circuit Configuration is Invented". Computerhistory.org. Retrieved 2012-06-02.
- ^ Higgins, Richard J. (1983). Electronics with digital and analog integrated circuits. Prentice-Hall. p. 101. ISBN 978-0132507042.
The dominant difference is power: CMOS gates can consume about 100,000 times less power than their TTL equivalents!
- ^ "Depletion Mode". Techweb. Techweb. 29 January 2010. Retrieved 27 November 2010.
- ^ "MIS". Semiconductor Glossary.
- ^ Hadziioannou, Georges; Malliaras, George G. (2007). Semiconducting polymers: chemistry, physics and engineering. Wiley-VCH. ISBN 978-3-527-31271-9.
- ^ a b Jones, William (1997). Organic Molecular Solids: Properties and Applications. CRC Press. ISBN 978-0-8493-9428-7.
- ^ Xu, Wentao; Guo, Chang; Rhee, Shi-Woo (2013). "High performance organic field-effect transistors using cyanoethyl pullulan (CEP) high-k polymer cross-linked with trimethylolpropane triglycidyl ether (TTE) at low temperatures". Journal of Materials Chemistry C. 1 (25): 3955. doi:10.1039/C3TC30134F.
- ^ D. Kahng and S. M. Sze, "A floating-gate and its application to memory devices", The Bell System Technical Journal, vol. 46, no. 4, 1967, pp. 1288–95
- ^ Baliga, B. Jayant (1996). Power Semiconductor Devices. Boston: PWS publishing Company. ISBN 978-0-534-94098-0.
- ^ "Power MOSFET Basics: Understanding MOSFET Characteristics Associated With The Figure of Merit". element14. Archived from the original on 5 April 2015. Retrieved 27 November 2010.
- ^ "Power MOSFET Basics: Understanding Gate Charge and Using It To Assess Switching Performance". element14. Archived from the original on 30 June 2014. Retrieved 27 November 2010.
- ^ Irwin, J. David (1997). The Industrial Electronics Handbook. CRC Press. p. 218. ISBN 978-0849383434.
- ^ Hu, Chenming (February 13, 2009). "MOS Capacitor" (PDF). UC Berkeley. Archived from the original (PDF) on 2016-06-15. Retrieved 6 October 2019.
- ^ Sze, Simon Min; Lee, Ming-Kwei (May 2012). "MOS Capacitor and MOSFET". Semiconductor Devices: Physics and Technology. John Wiley & Sons. ISBN 978-0470537947. Retrieved 6 October 2019.
- ^ Sze, Simon M. (2002). Semiconductor Devices: Physics and Technology (PDF) (2nd ed.). Wiley. p. 214. ISBN 0-471-33372-7.
- ^ Kimizuka, Noboru; Yamazaki, Shunpei (2016). Physics and Technology of Crystalline Oxide Semiconductor CAAC-IGZO: Fundamentals. John Wiley & Sons. p. 217. ISBN 978-1119247401.
- ^ Weimer, Paul K. (1962). "The TFT A New Thin-Film Transistor". Proceedings of the IRE. 50 (6): 1462–69. doi:10.1109/JRPROC.1962.288190. ISSN 0096-8390. S2CID 51650159.
- ^ Kawamoto, H. (2012). "The Inventors of TFT Active-Matrix LCD Receive the 2011 IEEE Nishizawa Medal". Journal of Display Technology. 8 (1): 3–4. Bibcode:2012JDisT...8....3K. doi:10.1109/JDT.2011.2177740. ISSN 1551-319X.
- ^ Castellano, Joseph A. (2005). Liquid Gold: The Story of Liquid Crystal Displays and the Creation of an Industry. World Scientific. pp. 176–77. ISBN 978-9812389565.
- ^ Alvarez, Antonio R. (1990). "Introduction To BiCMOS". BiCMOS Technology and Applications. Springer Science & Business Media. pp. 1-20 (2). doi:10.1007/978-1-4757-2029-7_1. ISBN 978-0792393849.
- ^ "IGBT Definition". PC Magazine Encyclopedia. PC Magazine. Retrieved 17 August 2019.
- ^ a b c d e f Bergveld, Piet (October 1985). "The impact of MOSFET-based sensors" (PDF). Sensors and Actuators. 8 (2): 109–27. Bibcode:1985SeAc....8..109B. doi:10.1016/0250-6874(85)87009-8. ISSN 0250-6874.
- ^ Chris Toumazou; Pantelis Georgiou (December 2011). "40 years of ISFET technology:From neuronal sensing to DNA sequencing". Electronics Letters. Retrieved 13 May 2016.
- ^ a b c Schöning, Michael J.; Poghossian, Arshak (10 September 2002). "Recent advances in biologically sensitive field-effect transistors (BioFETs)" (PDF). Analyst. 127 (9): 1137–51. Bibcode:2002Ana...127.1137S. doi:10.1039/B204444G. ISSN 1364-5528. PMID 12375833.
- ^ Zeitzoff, P. M.; Hutchby, J. A.; Huff, H. R. (2002). "Figure 12: Simplified cross section of FinFET double-gate MOSFET.". In Park, Yoon-Soo; Shur, Michael; Tang, William (eds.). Frontiers in electronics: future chips : proceedings of the 2002 Workshop on Frontiers in Electronics (WOFE-02), St Croix, Virgin Islands, US, 6–11 January 2002. World Scientific. p. 82. ISBN 978-981-238-222-1.
- ^ Lee, J.-H.; Lee, J.-W.; Jung, H.-A.-R.; Choi, B.-K. (2009). "Comparison of SOI FinFETs and bulk FinFETs: Figure 2". Silicon-on-Insulator Technology and Devices. The Electrochemical Society. p. 102. ISBN 978-1-56677-712-4.
- ^ Colinge, J.P. (2008). FinFETs and Other Multi-Gate Transistors. Springer Science & Business Media. p. 11. ISBN 978-0387717517.
- ^ Sekigawa, Toshihiro; Hayashi, Yutaka (1 August 1984). "Calculated threshold-voltage characteristics of an XMOS transistor having an additional bottom gate". Solid-State Electronics. 27 (8): 827–28. Bibcode:1984SSEle..27..827S. doi:10.1016/0038-1101(84)90036-4. ISSN 0038-1101.
- ^ Masuoka, Fujio; Takato, H.; Sunouchi, K.; Okabe, N.; Nitayama, A.; Hieda, K.; Horiguchi, F. (December 1988). "High performance CMOS surrounding-gate transistor (SGT) for ultra high density LSIs". Technical Digest., International Electron Devices Meeting: 222–25. doi:10.1109/IEDM.1988.32796. S2CID 114148274.
- ^ Brozek, Tomasz (2017). Micro- and Nanoelectronics: Emerging Device Challenges and Solutions. CRC Press. p. 117. ISBN 978-1351831345.
- ^ "IEEE Andrew S. Grove Award Recipients". IEEE Andrew S. Grove Award. Institute of Electrical and Electronics Engineers. Retrieved 4 July 2019.
- ^ "The Breakthrough Advantage for FPGAs with Tri-Gate Technology" (PDF). Intel. 2014. Retrieved 4 July 2019.
- ^ Tsu‐Jae King, Liu (June 11, 2012). "FinFET: History, Fundamentals and Future". University of California, Berkeley. Symposium on VLSI Technology Short Course. Retrieved 9 July 2019.
- ^ Datta, Kanak; Khosru, Quazi D. M. (2018). "III–V tri-gate quantum well MOSFET: Quantum ballistic simulation study for 10nm technology and beyond". Solid-State Electronics. 118: 66–77. arXiv:1802.09136. Bibcode:2016SSEle.118...66D. doi:10.1016/j.sse.2015.11.034. ISSN 0038-1101. S2CID 101934219.
- ^ Kulkarni, Jaydeep P.; Roy, Kaushik (2010). "Technology/Circuit Co-Design for III-V FETs". In Oktyabrsky, Serge; Ye, Peide (eds.). Fundamentals of III-V Semiconductor MOSFETs. Springer Science & Business Media. pp. 423–42. doi:10.1007/978-1-4419-1547-4_14. ISBN 978-1-4419-1547-4.
- ^ Lin, Jianqiang (2015). "InGaAs Quantum-Well MOSFETs for logic applications". Massachusetts Institute of Technology. hdl:1721.1/99777. Cite journal requires
|journal=(help) - ^ "WHAT'S NEWS: A review of the latest happenings in electronics", Radio-Electronics, Gernsback, 62 (5), May 1991
- ^ a b c d Colinge, Jean-Pierre; Colinge, C. A. (2005). Physics of Semiconductor Devices. Springer Science & Business Media. p. 165. ISBN 978-0387285238.
Without the MOSFET there would be no computer industry, no digital telecommunication systems, no video games, no pocket calculators and no digital wristwatches.
- ^ Kuo, Yue (1 January 2013). "Thin Film Transistor Technology—Past, Present, and Future" (PDF). The Electrochemical Society Interface. 22 (1): 55–61. Bibcode:2013ECSIn..22a..55K. doi:10.1149/2.F06131if. ISSN 1064-8208.
- ^ Lojek, Bo (2007). History of Semiconductor Engineering. Springer Science & Business Media. pp. 120, 321–23. ISBN 978-3540342588.
- ^ Bassett, Ross Knox (2007). To the Digital Age: Research Labs, Start-up Companies, and the Rise of MOS Technology. Johns Hopkins University Press. p. 46. ISBN 978-0801886393.
- ^ "Computer History Museum – The Silicon Engine | 1955 – Photolithography Techniques Are Used to Make Silicon Devices". Computerhistory.org. Retrieved 2012-06-02.
- ^ "1964 – First Commercial MOS IC Introduced". Computer History Museum.
- ^ Kilby, J. S. (2007). "Miniaturized electronic circuits [US Patent No. 3,138, 743]". IEEE Solid-State Circuits Society Newsletter. 12 (2): 44–54. doi:10.1109/N-SSC.2007.4785580. ISSN 1098-4232.
- ^ a b Shirriff, Ken (30 August 2016). "The Surprising Story of the First Microprocessors". IEEE Spectrum. Institute of Electrical and Electronics Engineers. 53 (9): 48–54. doi:10.1109/MSPEC.2016.7551353. S2CID 32003640. Retrieved 13 October 2019.
- ^ a b Hittinger, William C. (1973). "Metal–Oxide–Semiconductor Technology". Scientific American. 229 (2): 48–59. Bibcode:1973SciAm.229b..48H. doi:10.1038/scientificamerican0873-48. ISSN 0036-8733. JSTOR 24923169.
- ^ a b Grant, Duncan Andrew; Gowar, John (1989). Power MOSFETS: theory and applications. Wiley. p. 1. ISBN 978-0471828679.
The metal–oxide–semiconductor field-effect transistor (MOSFET) is the most commonly used active device in the very-large-scale integration of digital integrated circuits (VLSI). During the 1970s these components revolutionized electronic signal processing, control systems and computers.
- ^ Schwarz, A. F. (2014). Handbook of VLSI Chip Design and Expert Systems. Academic Press. p. 16. ISBN 978-1483258058.
- ^ "1971: Microprocessor Integrates CPU Function onto a Single Chip". The Silicon Engine. Computer History Museum. Retrieved 22 July 2019.
- ^ Cushman, Robert H. (20 September 1975). "2-1/2-generation μP's-$10 parts that perform like low-end mini's" (PDF). EDN. Archived from the original (PDF) on 24 April 2016. Retrieved 8 August 2013.
- ^ "Computer History Museum – Exhibits – Microprocessors". Computerhistory.org. Retrieved 2012-06-02.
- ^ O'Neill, A. (2008). "Asad Abidi Recognized for Work in RF-CMOS". IEEE Solid-State Circuits Society Newsletter. 13 (1): 57–58. doi:10.1109/N-SSC.2008.4785694. ISSN 1098-4232.
- ^ "Transistors – an overview". ScienceDirect. Retrieved 8 August 2019.
- ^ Solid State Design – Vol. 6. Horizon House. 1965.
- ^ a b "DRAM". IBM100. IBM. 9 August 2017. Retrieved 20 September 2019.
- ^ "Robert Dennard". Encyclopedia Britannica. Retrieved 8 July 2019.
- ^ "1970: MOS Dynamic RAM Competes with Magnetic Core Memory on Price". Computer History Museum. Retrieved 29 July 2019.
- ^ "People". The Silicon Engine. Computer History Museum. Retrieved 17 August 2019.
- ^ "1971: Reusable semiconductor ROM introduced". Computer History Museum. Retrieved 19 June 2019.
- ^ Bez, R.; Pirovano, A. (2019). Advances in Non-Volatile Memory and Storage Technology. Woodhead Publishing. ISBN 978-0081025857.
- ^ Cherry, Robert William (June 1973). "A calculator option for the Tektronix 4010 computer graphics terminal". Compilation of Abstracts of Dissertations, Theses and Research Papers Submitted by Candidates for Degrees. Naval Postgraduate School. hdl:10945/16514.
- ^ "Victor 3900". Vintage Calculators Web Museum. Retrieved 15 May 2020.
- ^ a b c "Hand-held Calculators". Vintage Calculators Web Museum. Retrieved 22 July 2019.
- ^ Nigel Tout. "Sharp QT-8D "micro Compet"". Vintage Calculators Web Museum. Retrieved September 29, 2010.
- ^ "Design News". Design News. Cahners Publishing Company. 27 (1–8): 275. 1972.
Today, under contracts with some 20 major companies, we're working on nearly 30 product programs – applications of MOS/LSI technology for automobiles, trucks, appliances, business machines, musical instruments, computer peripherals, cash registers, calculators, data transmission and telecommunication equipment.
- ^ a b c Omura, Yasuhisa; Mallik, Abhijit; Matsuo, Naoto (2017). MOS Devices for Low-Voltage and Low-Energy Applications. John Wiley & Sons. p. 53. ISBN 978-1119107354.
- ^ Chen, Tom (1996). "Integrated Circuits". In Whitaker, Jerry C. (ed.). The Electronics Handbook. CRC Press. p. 644. ISBN 978-0-8493-8345-8.
- ^ Whiteley, Carol; McLaughlin, John Robert (2002). Technology, Entrepreneurs, and Silicon Valley. Institute for the History of Technology. ISBN 978-0964921719.
These active electronic components, or power semiconductor products, from Siliconix are used to switch and convert power in a wide range of systems, from portable information appliances to the communications infrastructure that enables the Internet. The company's power MOSFETs – tiny solid-state switches, or metal oxide semiconductor field-effect transistors – and power integrated circuits are widely used in cell phones and notebook computers to manage battery power efficiently
- ^ Green, M. M. (November 2010). "An overview on wireline communication systems for high-speed broadband communication". Proceedings of Papers 5th European Conference on Circuits and Systems for Communications (ECCSC'10): 1–8. ISBN 978-1-61284-400-8.
- ^ Allstot, David J. (2016). "Switched Capacitor Filters" (PDF). In Maloberti, Franco; Davies, Anthony C. (eds.). A Short History of Circuits and Systems: From Green, Mobile, Pervasive Networking to Big Data Computing. IEEE Circuits and Systems Society. pp. 105–10. ISBN 978-8793609860.
- ^ a b c Baliga, B. Jayant (2005). Silicon RF Power MOSFETS. World Scientific. ISBN 978-9812561213.
- ^ a b c Asif, Saad (2018). 5G Mobile Communications: Concepts and Technologies. CRC Press. pp. 128–34. ISBN 978-0429881343.
- ^ a b Jindal, R. P. (2009). "From millibits to terabits per second and beyond – Over 60 years of innovation". 2009 2nd International Workshop on Electron Devices and Semiconductor Technology: 1–6. doi:10.1109/EDST.2009.5166093. ISBN 978-1-4244-3831-0. S2CID 25112828.
- ^ Albert, Keith J.; Lewis, Nathan S.; Schauer, Caroline L.; Sotzing, Gregory A.; Stitzel, Shannon E.; Vaid, Thomas P.; Walt, David R. (2000-07-01). "Cross-Reactive Chemical Sensor Arrays". Chemical Reviews. 100 (7): 2595–2626. doi:10.1021/cr980102w. ISSN 0009-2665.
- ^ Rai-Choudhury, P. (2000). MEMS and MOEMS Technology and Applications. SPIE Press. pp. ix, 3–4. ISBN 978-0819437167.
- ^ Nathanson HC, Wickstrom RA (1965). "A Resonant-Gate Silicon Surface Transistor with High-Q Band-Pass Properties". Appl. Phys. Lett. 7 (4): 84–86. Bibcode:1965ApPhL...7...84N. doi:10.1063/1.1754323.
- ^ Boyle, William S; Smith, George E. (1970). "Charge Coupled Semiconductor Devices". Bell Syst. Tech. J. 49 (4): 587–93. doi:10.1002/j.1538-7305.1970.tb01790.x.
- ^ Matsumoto, Kazuya; et al. (1985). "A new MOS phototransistor operating in a non-destructive readout mode". Japanese Journal of Applied Physics. 24 (5A): L323. Bibcode:1985JaJAP..24L.323M. doi:10.1143/JJAP.24.L323.
- ^ Eric R. Fossum (1993), "Active Pixel Sensors: Are CCD's Dinosaurs?" Proc. SPIE Vol. 1900, pp. 2–14, Charge-Coupled Devices and Solid State Optical Sensors III, Morley M. Blouke; Ed.
- ^ Lyon, Richard F. (2014). "The Optical Mouse: Early Biomimetic Embedded Vision". Advances in Embedded Computer Vision. Springer. pp. 3-22 (3). ISBN 978-3319093871.
- ^ Lyon, Richard F. (August 1981). "The Optical Mouse, and an Architectural Methodology for Smart Digital Sensors" (PDF). In H. T. Kung; Robert F. Sproull; Guy L. Steele (eds.). VLSI Systems and Computations. Computer Science Press. pp. 1–19. doi:10.1007/978-3-642-68402-9_1. ISBN 978-3-642-68404-3.
- ^ Brain, Marshall; Carmack, Carmen (24 April 2000). "How Computer Mice Work". HowStuffWorks. Retrieved 9 October 2019.
- ^ "Power Supply Technology – Buck DC/DC Converters". Mouser Electronics. Retrieved 11 August 2019.
- ^ Grant, Duncan Andrew; Gowar, John (1989). Power MOSFETS: theory and applications. Wiley. p. 239. ISBN 9780471828679.
- ^ Carbone, James (September–October 2018). "Buyers can expect 30-week lead times and higher tags to continue for MOSFETs" (PDF). Electronics Sourcing: 18–19.
- ^ "Automotive Power MOSFETs" (PDF). Fuji Electric. Retrieved 10 August 2019.
- ^ Gosden, D.F. (March 1990). "Modern Electric Vehicle Technology using an AC Motor Drive". Journal of Electrical and Electronics Engineering. Institution of Engineers Australia. 10 (1): 21–27. ISSN 0725-2986.
- ^ "NIHF Inductee Bantval Jayant Baliga Invented IGBT Technology". National Inventors Hall of Fame. Retrieved 17 August 2019.
- ^ "ReVera's FinFET Control". revera.com. Archived from the original on 19 September 2010.
- ^ Colinge, Jean-Pierre; Colinge, Cynthia A. (2002). Physics of Semiconductor Devices. Dordrecht: Springer. p. 233, Figure 7.46. ISBN 978-1-4020-7018-1.
- ^ Weber, Eicke R.; Dabrowski, Jarek, eds. (2004). Predictive Simulation of Semiconductor Processing: Status and Challenges. Dordrecht: Springer. p. 5, Figure 1.2. ISBN 978-3-540-20481-7.
- ^ "International Technology Roadmap for Semiconductors". Archived from the original on 2015-12-28.
- ^ Shilov, Anton. "Samsung Completes Development of 5nm EUV Process Technology". www.anandtech.com. Retrieved 2019-05-31.
- ^ Shilov, Anton. "TSMC: First 7nm EUV Chips Taped Out, 5nm Risk Production in Q2 2019".
- ^ "1965 – "Moore's Law" Predicts the Future of Integrated Circuits". Computer History Museum.
- ^ Roy, Kaushik; Yeo, Kiat Seng (2004). Low Voltage, Low Power VLSI Subsystems. McGraw-Hill Professional. Fig. 2.1, p. 44, Fig. 1.1, p. 4. ISBN 978-0-07-143786-8.
- ^ Vasileska, Dragica; Goodnick, Stephen (2006). Computational Electronics. Morgan & Claypool. p. 103. ISBN 978-1-59829-056-1.
- ^ "Frontier Semiconductor Paper" (PDF). Archived from the original (PDF) on February 27, 2012. Retrieved 2012-06-02.
- ^ Chen, Wai-Kai (2006). The VLSI Handbook. CRC Press. Fig. 2.28, p. 2–22. ISBN 978-0-8493-4199-1.
- ^ Lindsay, R.; Pawlak; Kittl; Henson; Torregiani; Giangrandi; Surdeanu; Vandervorst; Mayur; Ross; McCoy; Gelpey; Elliott; Pages; Satta; Lauwers; Stolk; Maex (2011). "A Comparison of Spike, Flash, SPER and Laser Annealing for 45nm CMOS". MRS Proceedings. 765. doi:10.1557/PROC-765-D7.4.
- ^ "VLSI wiring capacitance" (PDF). IBM Journal of Research and Development.[dead link]
- ^ Soudris, D.; Pirsch, P.; Barke, E., eds. (2000). Integrated Circuit Design: Power and Timing Modeling, Optimization, and Simulation (10th Int. Workshop). Springer. p. 38. ISBN 978-3-540-41068-3.
- ^ Orshansky, Michael; Nassif, Sani; Boning, Duane (2007). Design for Manufacturability And Statistical Design: A Constructive Approach. New York 309284: Springer. ISBN 978-0387309286.CS1 maint: location (link)
- ^ Cherry, Steven (2004). "Edholm's law of bandwidth". IEEE Spectrum. 41 (7): 58–60. doi:10.1109/MSPEC.2004.1309810. S2CID 27580722.
- ^ a b c "Angstrom". Collins English Dictionary. Retrieved 2019-03-02.
- ^ Sze, Simon M. (2002). Semiconductor Devices: Physics and Technology (PDF) (2nd ed.). Wiley. p. 4. ISBN 0-471-33372-7.
- ^ Atalla, Mohamed M.; Kahng, Dawon (June 1960). "Silicon–silicon dioxide field induced surface devices". IRE-AIEE Solid State Device Research Conference. Carnegie Mellon University Press.
- ^ Voinigescu, Sorin (2013). High-Frequency Integrated Circuits. Cambridge University Press. p. 164. ISBN 9780521873024.
- ^ Sah, Chih-Tang; Leistiko, Otto; Grove, A. S. (May 1965). "Electron and hole mobilities in inversion layers on thermally oxidized silicon surfaces". IEEE Transactions on Electron Devices. 12 (5): 248–254. Bibcode:1965ITED...12..248L. doi:10.1109/T-ED.1965.15489.
- ^ Dennard, Robert H.; Gaensslen, Fritz H.; Yu, Hwa-Nien; Kuhn, L. (December 1972). "Design of micron MOS switching devices". 1972 International Electron Devices Meeting: 168–170. doi:10.1109/IEDM.1972.249198.
- ^ a b Hori, Ryoichi; Masuda, Hiroo; Minato, Osamu; Nishimatsu, Shigeru; Sato, Kikuji; Kubo, Masaharu (September 1975). "Short Channel MOS-IC Based on Accurate Two Dimensional Device Design". Japanese Journal of Applied Physics. 15 (S1): 193. doi:10.7567/JJAPS.15S1.193. ISSN 1347-4065.
- ^ Critchlow, D. L. (2007). "Recollections on MOSFET Scaling". IEEE Solid-State Circuits Society Newsletter. 12 (1): 19–22. doi:10.1109/N-SSC.2007.4785536.
- ^ "1970s: Development and evolution of microprocessors" (PDF). Semiconductor History Museum of Japan. Retrieved 27 June 2019.
- ^ "NEC 751 (uCOM-4)". The Antique Chip Collector's Page. Archived from the original on 2011-05-25. Retrieved 2010-06-11.
- ^ "1973: 12-bit engine-control microprocessor (Toshiba)" (PDF). Semiconductor History Museum of Japan. Retrieved 27 June 2019.
- ^ Belzer, Jack; Holzman, Albert G.; Kent, Allen (1978). Encyclopedia of Computer Science and Technology: Volume 10 – Linear and Matrix Algebra to Microorganisms: Computer-Assisted Identification. CRC Press. p. 402. ISBN 9780824722609.
- ^ Dennard, Robert H.; Gaensslen, F. H.; Yu, Hwa-Nien; Rideout, V. L.; Bassous, E.; LeBlanc, A. R. (October 1974). "Design of ion-implanted MOSFET's with very small physical dimensions" (PDF). IEEE Journal of Solid-State Circuits. 9 (5): 256–268. Bibcode:1974IJSSC...9..256D. CiteSeerX 10.1.1.334.2417. doi:10.1109/JSSC.1974.1050511. S2CID 283984.
- ^ Kubo, Masaharu; Hori, Ryoichi; Minato, Osamu; Sato, Kikuji (February 1976). "A threshold voltage controlling circuit for short channel MOS integrated circuits". 1976 IEEE International Solid-State Circuits Conference. Digest of Technical Papers. XIX: 54–55. doi:10.1109/ISSCC.1976.1155515. S2CID 21048622.
- ^ "Intel Microprocessor Quick Reference Guide". Intel. Retrieved 27 June 2019.
- ^ Hunter, William R.; Ephrath, L. M.; Cramer, Alice; Grobman, W. D.; Osburn, C. M.; Crowder, B. L.; Luhn, H. E. (April 1979). "1 /spl mu/m MOSFET VLSI technology. V. A single-level polysilicon technology using electron-beam lithography". IEEE Journal of Solid-State Circuits. 14 (2): 275–281. doi:10.1109/JSSC.1979.1051174. S2CID 26389509.
- ^ Kobayashi, Toshio; Horiguchi, Seiji; Kiuchi, K. (December 1984). "Deep-submicron MOSFET characteristics with 5 nm gate oxide". 1984 International Electron Devices Meeting: 414–417. doi:10.1109/IEDM.1984.190738. S2CID 46729489.
- ^ Kobayashi, Toshio; Horiguchi, Seiji; Miyake, M.; Oda, M.; Kiuchi, K. (December 1985). "Extremely high transconductance (above 500 mS/mm) MOSFET with 2.5 nm gate oxide". 1985 International Electron Devices Meeting: 761–763. doi:10.1109/IEDM.1985.191088. S2CID 22309664.
- ^ Chou, Stephen Y.; Antoniadis, Dimitri A.; Smith, Henry I. (December 1985). "Observation of electron velocity overshoot in sub-100-nm-channel MOSFET's in Silicon". IEEE Electron Device Letters. 6 (12): 665–667. Bibcode:1985IEDL....6..665C. doi:10.1109/EDL.1985.26267. S2CID 28493431.
- ^ a b Chou, Stephen Y.; Smith, Henry I.; Antoniadis, Dimitri A. (January 1986). "Sub‐100‐nm channel‐length transistors fabricated using x‐ray lithography". Journal of Vacuum Science & Technology B: Microelectronics Processing and Phenomena. 4 (1): 253–255. Bibcode:1986JVSTB...4..253C. doi:10.1116/1.583451. ISSN 0734-211X.
- ^ Kobayashi, Toshio; Miyake, M.; Deguchi, K.; Kimizuka, M.; Horiguchi, Seiji; Kiuchi, K. (1987). "Subhalf-micrometer p-channel MOSFET's with 3.5-nm gate Oxide fabricated using X-ray lithography". IEEE Electron Device Letters. 8 (6): 266–268. Bibcode:1987IEDL....8..266M. doi:10.1109/EDL.1987.26625. S2CID 38828156.
- ^ Ono, Mizuki; Saito, Masanobu; Yoshitomi, Takashi; Fiegna, Claudio; Ohguro, Tatsuya; Iwai, Hiroshi (December 1993). "Sub-50 nm gate length n-MOSFETs with 10 nm phosphorus source and drain junctions". Proceedings of IEEE International Electron Devices Meeting: 119–122. doi:10.1109/IEDM.1993.347385. ISBN 0-7803-1450-6. S2CID 114633315.
- ^ Kawaura, Hisao; Sakamoto, Toshitsugu; Baba, Toshio; Ochiai, Yukinori; Fujita, Jun'ichi; Matsui, Shinji; Sone, Jun'ichi (1997). "Proposal of Pseudo Source and Drain MOSFETs for Evaluating 10-nm Gate MOSFETs". Japanese Journal of Applied Physics. 36 (3S): 1569. Bibcode:1997JaJAP..36.1569K. doi:10.1143/JJAP.36.1569. ISSN 1347-4065.
- ^ Ahmed, Khaled Z.; Ibok, Effiong E.; Song, Miryeong; Yeap, Geoffrey; Xiang, Qi; Bang, David S.; Lin, Ming-Ren (1998). "Performance and reliability of sub-100 nm MOSFETs with ultra thin direct tunneling gate oxides". 1998 Symposium on VLSI Technology Digest of Technical Papers (Cat. No.98CH36216): 160–161. doi:10.1109/VLSIT.1998.689240. ISBN 0-7803-4770-6. S2CID 109823217.
- ^ Ahmed, Khaled Z.; Ibok, Effiong E.; Song, Miryeong; Yeap, Geoffrey; Xiang, Qi; Bang, David S.; Lin, Ming-Ren (1998). "Sub-100 nm nMOSFETs with direct tunneling thermal, nitrous and nitric oxides". 56th Annual Device Research Conference Digest (Cat. No.98TH8373): 10–11. doi:10.1109/DRC.1998.731099. ISBN 0-7803-4995-4. S2CID 1849364.
- ^ Doris, Bruce B.; Dokumaci, Omer H.; Ieong, Meikei K.; Mocuta, Anda; Zhang, Ying; Kanarsky, Thomas S.; Roy, R. A. (December 2002). "Extreme scaling with ultra-thin Si channel MOSFETs". Digest. International Electron Devices Meeting: 267–270. doi:10.1109/IEDM.2002.1175829. ISBN 0-7803-7462-2. S2CID 10151651.
- ^ a b c Schwierz, Frank; Wong, Hei; Liou, Juin J. (2010). Nanometer CMOS. Pan Stanford Publishing. p. 17. ISBN 9789814241083.
- ^ "IBM claims world's smallest silicon transistor – TheINQUIRER". Theinquirer.net. 2002-12-09. Retrieved 7 December 2017.
- ^ a b Wakabayashi, Hitoshi; Yamagami, Shigeharu; Ikezawa, Nobuyuki; Ogura, Atsushi; Narihiro, Mitsuru; Arai, K.; Ochiai, Y.; Takeuchi, K.; Yamamoto, T.; Mogami, T. (December 2003). "Sub-10-nm planar-bulk-CMOS devices using lateral junction control". IEEE International Electron Devices Meeting 2003: 20.7.1–20.7.3. doi:10.1109/IEDM.2003.1269446. ISBN 0-7803-7872-5. S2CID 2100267.
- ^ "1963: Complementary MOS Circuit Configuration is Invented". Computer History Museum. Retrieved 6 July 2019.
- ^ Sah, Chih-Tang; Wanlass, Frank (February 1963). "Nanowatt logic using field-effect metal–oxide semiconductor triodes". 1963 IEEE International Solid-State Circuits Conference. Digest of Technical Papers. VI: 32–33. doi:10.1109/ISSCC.1963.1157450.
- ^ a b Lojek, Bo (2007). History of Semiconductor Engineering. Springer Science & Business Media. p. 330. ISBN 9783540342588.
- ^ Aitken, A.; Poulsen, R. G.; MacArthur, A. T. P.; White, J. J. (December 1976). "A fully plasma etched-ion implanted CMOS process". 1976 International Electron Devices Meeting: 209–213. doi:10.1109/IEDM.1976.189021. S2CID 24526762.
- ^ "1978: Double-well fast CMOS SRAM (Hitachi)" (PDF). Semiconductor History Museum of Japan. Retrieved 5 July 2019.
- ^ Masuhara, Toshiaki; Minato, Osamu; Sasaki, Toshio; Sakai, Yoshio; Kubo, Masaharu; Yasui, Tokumasa (February 1978). "A high-speed, low-power Hi-CMOS 4K static RAM". 1978 IEEE International Solid-State Circuits Conference. Digest of Technical Papers. XXI: 110–111. doi:10.1109/ISSCC.1978.1155749. S2CID 30753823.
- ^ Masuhara, Toshiaki; Minato, Osamu; Sakai, Yoshi; Sasaki, Toshio; Kubo, Masaharu; Yasui, Tokumasa (September 1978). "Short Channel Hi-CMOS Device and Circuits". ESSCIRC 78: 4th European Solid State Circuits Conference – Digest of Technical Papers: 131–132.
- ^ a b c d e Gealow, Jeffrey Carl (10 August 1990). "Impact of Processing Technology on DRAM Sense Amplifier Design" (PDF). CORE. Massachusetts Institute of Technology. pp. 149–166. Retrieved 25 June 2019.
- ^ Chwang, R. J. C.; Choi, M.; Creek, D.; Stern, S.; Pelley, P. H.; Schutz, Joseph D.; Bohr, M. T.; Warkentin, P. A.; Yu, K. (February 1983). "A 70ns high density CMOS DRAM". 1983 IEEE International Solid-State Circuits Conference. Digest of Technical Papers. XXVI: 56–57. doi:10.1109/ISSCC.1983.1156456. S2CID 29882862.
- ^ Mano, Tsuneo; Yamada, J.; Inoue, Junichi; Nakajima, S. (February 1983). "Submicron VLSI memory circuits". 1983 IEEE International Solid-State Circuits Conference. Digest of Technical Papers. XXVI: 234–235. doi:10.1109/ISSCC.1983.1156549. S2CID 42018248.
- ^ Hu, G. J.; Taur, Yuan; Dennard, Robert H.; Terman, L. M.; Ting, Chung-Yu (December 1983). "A self-aligned 1-μm CMOS technology for VLSI". 1983 International Electron Devices Meeting: 739–741. doi:10.1109/IEDM.1983.190615. S2CID 20070619.
- ^ Sumi, T.; Taniguchi, Tsuneo; Kishimoto, Mikio; Hirano, Hiroshige; Kuriyama, H.; Nishimoto, T.; Oishi, H.; Tetakawa, S. (1987). "A 60ns 4Mb DRAM in a 300mil DIP". 1987 IEEE International Solid-State Circuits Conference. Digest of Technical Papers. XXX: 282–283. doi:10.1109/ISSCC.1987.1157106. S2CID 60783996.
- ^ Mano, Tsuneo; Yamada, J.; Inoue, Junichi; Nakajima, S.; Matsumura, Toshiro; Minegishi, K.; Miura, K.; Matsuda, T.; Hashimoto, C.; Namatsu, H. (1987). "Circuit technologies for 16Mb DRAMs". 1987 IEEE International Solid-State Circuits Conference. Digest of Technical Papers. XXX: 22–23. doi:10.1109/ISSCC.1987.1157158. S2CID 60984466.
- ^ Hanafi, Hussein I.; Dennard, Robert H.; Taur, Yuan; Haddad, Nadim F.; Sun, J. Y. C.; Rodriguez, M. D. (September 1987). "0.5 μm CMOS Device Design and Characterization". ESSDERC '87: 17th European Solid State Device Research Conference: 91–94.
- ^ Kasai, Naoki; Endo, Nobuhiro; Kitajima, Hiroshi (December 1987). "0.25 μm CMOS technology using P+polysilicon gate PMOSFET". 1987 International Electron Devices Meeting: 367–370. doi:10.1109/IEDM.1987.191433. S2CID 9203005.
- ^ Inoue, M.; Kotani, H.; Yamada, T.; Yamauchi, Hiroyuki; Fujiwara, A.; Matsushima, J.; Akamatsu, Hironori; Fukumoto, M.; Kubota, M.; Nakao, I.; Aoi (1988). "A 16mb Dram with an Open Bit-Line Architecture". 1988 IEEE International Solid-State Circuits Conference, 1988 ISSCC. Digest of Technical Papers: 246–. doi:10.1109/ISSCC.1988.663712. S2CID 62034618.
- ^ Shahidi, Ghavam G.; Davari, Bijan; Taur, Yuan; Warnock, James D.; Wordeman, Matthew R.; McFarland, P. A.; Mader, S. R.; Rodriguez, M. D. (December 1990). "Fabrication of CMOS on ultrathin SOI obtained by epitaxial lateral overgrowth and chemical-mechanical polishing". International Technical Digest on Electron Devices: 587–590. doi:10.1109/IEDM.1990.237130. S2CID 114249312.
- ^ "Memory". STOL (Semiconductor Technology Online). Retrieved 25 June 2019.
- ^ "0.18-micron Technology". TSMC. Retrieved 30 June 2019.
- ^ "NEC test-produces world's smallest transistor". Thefreelibrary.com. Retrieved 7 December 2017.
- ^ Sekigawa, Toshihiro; Hayashi, Yutaka (August 1984). "Calculated threshold-voltage characteristics of an XMOS transistor having an additional bottom gate". Solid-State Electronics. 27 (8): 827–828. Bibcode:1984SSEle..27..827S. doi:10.1016/0038-1101(84)90036-4. ISSN 0038-1101.
- ^ Koike, Hanpei; Nakagawa, Tadashi; Sekigawa, Toshiro; Suzuki, E.; Tsutsumi, Toshiyuki (23 February 2003). "Primary Consideration on Compact Modeling of DG MOSFETs with Four-terminal Operation Mode" (PDF). TechConnect Briefs. 2 (2003): 330–333. S2CID 189033174.
- ^ Davari, Bijan; Chang, Wen-Hsing; Wordeman, Matthew R.; Oh, C. S.; Taur, Yuan; Petrillo, Karen E.; Rodriguez, M. D. (December 1988). "A high performance 0.25 mu m CMOS technology". Technical Digest., International Electron Devices Meeting: 56–59. doi:10.1109/IEDM.1988.32749. S2CID 114078857.
- ^ Davari, Bijan; Wong, C. Y.; Sun, Jack Yuan-Chen; Taur, Yuan (December 1988). "Doping of n/sup +/ and p/sup +/ polysilicon in a dual-gate CMOS process". Technical Digest., International Electron Devices Meeting: 238–241. doi:10.1109/IEDM.1988.32800. S2CID 113918637.
- ^ Masuoka, Fujio; Takato, Hiroshi; Sunouchi, Kazumasa; Okabe, N.; Nitayama, Akihiro; Hieda, K.; Horiguchi, Fumio (December 1988). "High performance CMOS surrounding-gate transistor (SGT) for ultra high density LSIs". Technical Digest., International Electron Devices Meeting: 222–225. doi:10.1109/IEDM.1988.32796. S2CID 114148274.
- ^ Brozek, Tomasz (2017). Micro- and Nanoelectronics: Emerging Device Challenges and Solutions. CRC Press. p. 117. ISBN 9781351831345.
- ^ Ishikawa, Fumitaro; Buyanova, Irina (2017). Novel Compound Semiconductor Nanowires: Materials, Devices, and Applications. CRC Press. p. 457. ISBN 9781315340722.
- ^ Colinge, J.P. (2008). FinFETs and Other Multi-Gate Transistors. Springer Science & Business Media. p. 11. ISBN 9780387717517.
- ^ Hisamoto, Digh; Kaga, Toru; Kawamoto, Yoshifumi; Takeda, Eiji (December 1989). "A fully depleted lean-channel transistor (DELTA): a novel vertical ultra thin SOI MOSFET". International Technical Digest on Electron Devices Meeting: 833–836. doi:10.1109/IEDM.1989.74182. S2CID 114072236.
- ^ "IEEE Andrew S. Grove Award Recipients". IEEE Andrew S. Grove Award. Institute of Electrical and Electronics Engineers. Retrieved 4 July 2019.
- ^ a b c Tsu‐Jae King, Liu (June 11, 2012). "FinFET: History, Fundamentals and Future". University of California, Berkeley. Symposium on VLSI Technology Short Course. Archived from the original on 28 May 2016. Retrieved 9 July 2019.
- ^ Hisamoto, Digh; Hu, Chenming; Liu, Tsu-Jae King; Bokor, Jeffrey; Lee, Wen-Chin; Kedzierski, Jakub; Anderson, Erik; Takeuchi, Hideki; Asano, Kazuya (December 1998). "A folded-channel MOSFET for deep-sub-tenth micron era". International Electron Devices Meeting 1998. Technical Digest (Cat. No.98CH36217): 1032–1034. doi:10.1109/IEDM.1998.746531. ISBN 0-7803-4774-9. S2CID 37774589.
- ^ Hu, Chenming; Choi, Yang‐Kyu; Lindert, N.; Xuan, P.; Tang, S.; Ha, D.; Anderson, E.; Bokor, J.; Tsu-Jae King, Liu (December 2001). "Sub-20 nm CMOS FinFET technologies". International Electron Devices Meeting. Technical Digest (Cat. No.01CH37224): 19.1.1–19.1.4. doi:10.1109/IEDM.2001.979526. ISBN 0-7803-7050-3. S2CID 8908553.
- ^ Ahmed, Shibly; Bell, Scott; Tabery, Cyrus; Bokor, Jeffrey; Kyser, David; Hu, Chenming; Liu, Tsu-Jae King; Yu, Bin; Chang, Leland (December 2002). "FinFET scaling to 10 nm gate length" (PDF). Digest. International Electron Devices Meeting: 251–254. CiteSeerX 10.1.1.136.3757. doi:10.1109/IEDM.2002.1175825. ISBN 0-7803-7462-2. S2CID 7106946.
- ^ Lee, Hyunjin; Choi, Yang-Kyu; Yu, Lee-Eun; Ryu, Seong-Wan; Han, Jin-Woo; Jeon, K.; Jang, D.Y.; Kim, Kuk-Hwan; Lee, Ju-Hyun; et al. (June 2006), "Sub-5nm All-Around Gate FinFET for Ultimate Scaling", Symposium on VLSI Technology, 2006: 58–59, doi:10.1109/VLSIT.2006.1705215, hdl:10203/698, ISBN 978-1-4244-0005-8, S2CID 26482358
- ^ "Still Room at the Bottom (nanometer transistor developed by Yang-kyu Choi from the Korea Advanced Institute of Science and Technology )", Nanoparticle News, 1 April 2006, archived from the original on 6 November 2012
- ^ Weimer, Paul K. (June 1962). "The TFT A New Thin-Film Transistor". Proceedings of the IRE. 50 (6): 1462–1469. doi:10.1109/JRPROC.1962.288190. ISSN 0096-8390. S2CID 51650159.
- ^ Kuo, Yue (1 January 2013). "Thin Film Transistor Technology—Past, Present, and Future" (PDF). The Electrochemical Society Interface. 22 (1): 55–61. Bibcode:2013ECSIn..22a..55K. doi:10.1149/2.F06131if. ISSN 1064-8208.
- ^ Ye, Peide D.; Xuan, Yi; Wu, Yanqing; Xu, Min (2010). "Atomic-Layer Deposited High-k/III-V Metal-Oxide-Semiconductor Devices and Correlated Empirical Model". In Oktyabrsky, Serge; Ye, Peide (eds.). Fundamentals of III-V Semiconductor MOSFETs. Springer Science & Business Media. pp. 173–194. doi:10.1007/978-1-4419-1547-4_7. ISBN 978-1-4419-1547-4.
- ^ Brody, T. P.; Kunig, H. E. (October 1966). "A HIGH‐GAIN InAs THIN‐FILM TRANSISTOR". Applied Physics Letters. 9 (7): 259–260. Bibcode:1966ApPhL...9..259B. doi:10.1063/1.1754740. ISSN 0003-6951.
- ^ Woodall, Jerry M. (2010). Fundamentals of III-V Semiconductor MOSFETs. Springer Science & Business Media. pp. 2–3. ISBN 9781441915474.
- ^ Kahng, Dawon; Sze, Simon Min (July–August 1967). "A floating gate and its application to memory devices". The Bell System Technical Journal. 46 (6): 1288–1295. Bibcode:1967ITED...14Q.629K. doi:10.1002/j.1538-7305.1967.tb01738.x.
- ^ Wegener, H. A. R.; Lincoln, A. J.; Pao, H. C.; O'Connell, M. R.; Oleksiak, R. E.; Lawrence, H. (October 1967). "The variable threshold transistor, a new electrically-alterable, non-destructive read-only storage device". 1967 International Electron Devices Meeting. 13: 70. doi:10.1109/IEDM.1967.187833.
- ^ Lin, Hung Chang; Iyer, Ramachandra R. (July 1968). "A Monolithic Mos-Bipolar Audio Amplifier". IEEE Transactions on Broadcast and Television Receivers. 14 (2): 80–86. doi:10.1109/TBTR1.1968.4320132.
- ^ a b Alvarez, Antonio R. (1990). "Introduction To BiCMOS". BiCMOS Technology and Applications. Springer Science & Business Media. pp. 1–20 (2). doi:10.1007/978-1-4757-2029-7_1. ISBN 9780792393849.
- ^ Lin, Hung Chang; Iyer, Ramachandra R.; Ho, C. T. (October 1968). "Complementary MOS-bipolar structure". 1968 International Electron Devices Meeting: 22–24. doi:10.1109/IEDM.1968.187949.
- ^ a b "Advances in Discrete Semiconductors March On". Power Electronics Technology. Informa: 52–6. September 2005. Archived (PDF) from the original on 22 March 2006. Retrieved 31 July 2019.
- ^ Oxner, E. S. (1988). Fet Technology and Application. CRC Press. p. 18. ISBN 9780824780500.
- ^ Tarui, Y.; Hayashi, Y.; Sekigawa, Toshihiro (September 1969). "Diffusion Self-Aligned MOST; A New Approach for High Speed Device". Proceedings of the 1st Conference on Solid State Devices. doi:10.7567/SSDM.1969.4-1. S2CID 184290914.
- ^ McLintock, G. A.; Thomas, R. E. (December 1972). "Modelling of the double-diffused MOST's with self-aligned gates". 1972 International Electron Devices Meeting: 24–26. doi:10.1109/IEDM.1972.249241.
- ^ Bergveld, P. (January 1970). "Development of an Ion-Sensitive Solid-State Device for Neurophysiological Measurements". IEEE Transactions on Biomedical Engineering. BME-17 (1): 70–71. doi:10.1109/TBME.1970.4502688. PMID 5441220.
- ^ Chris Toumazou; Pantelis Georgiou (December 2011). "40 years of ISFET technology: From neuronal sensing to DNA sequencing". Electronics Letters. doi:10.1049/el.2011.3231. Retrieved 13 May 2016.
- ^ Tarui, Y.; Hayashi, Y.; Sekigawa, Toshihiro (October 1970). "DSA enhancement – Depletion MOS IC". 1970 International Electron Devices Meeting: 110. doi:10.1109/IEDM.1970.188299.
- ^ Duncan, Ben (1996). High Performance Audio Power Amplifiers. Elsevier. pp. 177–8, 406. ISBN 9780080508047.
- ^ Baliga, B. Jayant (2015). The IGBT Device: Physics, Design and Applications of the Insulated Gate Bipolar Transistor. William Andrew. pp. xxviii, 5–12. ISBN 9781455731534.
- ^ Higuchi, H.; Kitsukawa, Goro; Ikeda, Takahide; Nishio, Y.; Sasaki, N.; Ogiue, Katsumi (December 1984). "Performance and structures of scaled-down bipolar devices merged with CMOSFETs". 1984 International Electron Devices Meeting: 694–697. doi:10.1109/IEDM.1984.190818. S2CID 41295752.
- ^ Deguchi, K.; Komatsu, Kazuhiko; Miyake, M.; Namatsu, H.; Sekimoto, M.; Hirata, K. (1985). "Step-and-Repeat X-ray/Photo Hybrid Lithography for 0.3 μm Mos Devices". 1985 Symposium on VLSI Technology. Digest of Technical Papers: 74–75.
- ^ Momose, H.; Shibata, Hideki; Saitoh, S.; Miyamoto, Jun-ichi; Kanzaki, K.; Kohyama, Susumu (1985). "1.0-/spl mu/m n-Well CMOS/Bipolar Technology". IEEE Journal of Solid-State Circuits. 20 (1): 137–143. Bibcode:1985IJSSC..20..137M. doi:10.1109/JSSC.1985.1052286. S2CID 37353920.
- ^ Lee, Han-Sheng; Puzio, L.C. (November 1986). "The electrical properties of subquarter-micrometer gate-length MOSFET's". IEEE Electron Device Letters. 7 (11): 612–614. Bibcode:1986IEDL....7..612H. doi:10.1109/EDL.1986.26492. S2CID 35142126.
- ^ Shahidi, Ghavam G.; Antoniadis, Dimitri A.; Smith, Henry I. (December 1986). "Electron velocity overshoot at 300 K and 77 K in silicon MOSFETs with submicron channel lengths". 1986 International Electron Devices Meeting: 824–825. doi:10.1109/IEDM.1986.191325. S2CID 27558025.
- ^ Davari, Bijan; Ting, Chung-Yu; Ahn, Kie Y.; Basavaiah, S.; Hu, Chao-Kun; Taur, Yuan; Wordeman, Matthew R.; Aboelfotoh, O. (May 1987). "Submicron Tungsten Gate MOSFET with 10 nm Gate Oxide". 1987 Symposium on VLSI Technology. Digest of Technical Papers: 61–62.
- ^ Havemann, Robert H.; Eklund, R. E.; Tran, Hiep V.; Haken, R. A.; Scott, D. B.; Fung, P. K.; Ham, T. E.; Favreau, D. P.; Virkus, R. L. (December 1987). "An 0.8 #181;m 256K BiCMOS SRAM technology". 1987 International Electron Devices Meeting: 841–843. doi:10.1109/IEDM.1987.191564. S2CID 40375699.
- ^ Kawaura, Hisao; Sakamoto, Toshitsugu; Baba, Toshio; Ochiai, Yukinori; Fujita, Jun-ichi; Matsui, Shinji; Sone, J. (1997). "Transistor operations in 30-nm-gate-length EJ-MOSFETs". 1997 55th Annual Device Research Conference Digest: 14–15. doi:10.1109/DRC.1997.612456. ISBN 0-7803-3911-8. S2CID 38105606.
- ^ Kawaura, Hisao; Sakamoto, Toshitsugu; Baba, Toshio (12 June 2000). "Observation of source-to-drain direct tunneling current in 8 nm gate electrically variable shallow junction metal–oxide–semiconductor field-effect transistors". Applied Physics Letters. 76 (25): 3810–3812. Bibcode:2000ApPhL..76.3810K. doi:10.1063/1.126789. ISSN 0003-6951.
External links[edit]
This article's use of external links may not follow Wikipedia's policies or guidelines. (September 2016) (Learn how and when to remove this template message) |
| Wikimedia Commons has media related to MOSFET. |
- How Semiconductors and Transistors Work (MOSFETs) WeCanFigureThisOut.org
- "Understanding power MOSFET data sheet parameters – Nexperia PDF Application Note AN11158" (PDF).
- "An introduction to depletion-mode MOSFETs". Archived from the original on 28 September 2008.
- "Power MOSFETs".
- "Criteria for Successful Selection of IGBT and MOSFET Modules". Archived from the original on 2012-11-12. Retrieved 2018-12-16.
- "MOSFET Process Step by Step". Archived from the original on 2009-08-22. Retrieved 2016-02-06. A Flash slide showing the fabricating process of a MOSFET in detail
- "MOSFET Calculator". Archived from the original on 2008-05-27. Retrieved 2008-06-03.
- "Advanced MOSFET issues". ecee.colorado.edu. 27 November 2010.
- "MOSFET applet".
- Nicolai, Ulrich; Reimann, Tobias; Petzoldt, Jürgen; Lutz, Josef (1998). Application Manual IGBT and MOSFET Power Modules (1st ed.). ISLE Verlag. ISBN 978-3-932633-24-9. Archived from the original on 2 March 2012.
- Wintrich, Arendt; Nicolai, Ulrich; Tursky, Werner; Reimann, Tobias (2011). PDF-Version (PDF) (2nd ed.). Nuremberg: Semikron. ISBN 978-3-938843-66-6. Archived from the original (PDF) on 3 September 2013.
- "MIT Open Courseware 6.002 – Spring 2007".
- "MIT Open Courseware 6.012 – Fall 2009".
- "Georgia Tech BJT and FET Slides".
- "CircuitDesign: MOS Diffusion Parasitics".
- Mark Lundstrom, Mark Lundstrom (2008). "Course on Physics of Nanoscale Transistors". Archived from the original on 2012-02-24. Retrieved 2010-05-09. Cite journal requires
|journal=(help) - Dr. Lundstrom (2005). "Notes on Ballistic MOSFETs". Archived from the original on 2012-02-24. Retrieved 2010-05-18. Cite journal requires
|journal=(help)



















}](https://wikimedia.org/api/rest_v1/media/math/render/svg/a213928719f4f0d6f821a69f29aa50a1d1e48782)



![{\displaystyle I_{\text{D}}={\frac {\mu _{n}C_{\text{ox}}}{2}}{\frac {W}{L}}\left[V_{\text{GS}}-V_{\text{th}}\right]^{2}\left[1+\lambda (V_{\text{DS}}-V_{\text{DSsat}})\right].}](https://wikimedia.org/api/rest_v1/media/math/render/svg/f6593b8932bc4a92e53bfce27d1c29b1254b0ed3)









